 613双极晶体管的单管结构及工作原理
613双极晶体管的单管结构及工作原理
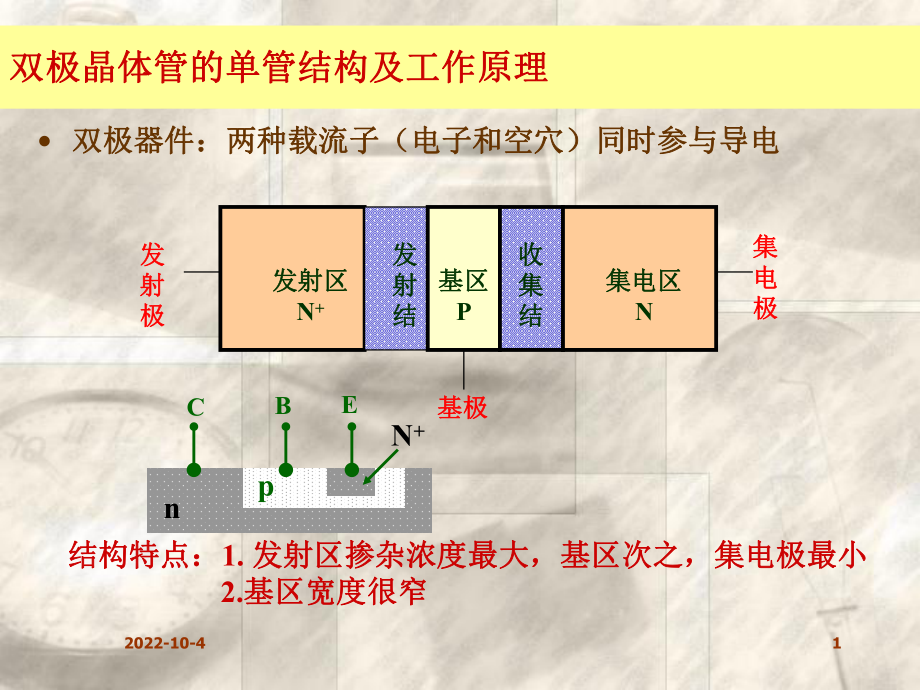


《613双极晶体管的单管结构及工作原理》由会员分享,可在线阅读,更多相关《613双极晶体管的单管结构及工作原理(39页珍藏版)》请在装配图网上搜索。
1、2022-10-41双极晶体管的单管结构及工作原理双极晶体管的单管结构及工作原理 双极器件:两种载流子(电子和空穴)同时参与导电双极器件:两种载流子(电子和空穴)同时参与导电发射区发射区N+集电区集电区 N基区基区P发发射射结结收收集集结结发发射射极极集集电电极极基极基极BECnpN+结构特点:结构特点:1.发射区掺杂浓度最大,基区次之,集电极最小发射区掺杂浓度最大,基区次之,集电极最小 2.基区宽度很窄基区宽度很窄2022-10-42NNPECB当发射结正偏(当发射结正偏(VBE0),集电结反偏(,集电结反偏(VBC0),集电结也正偏(,集电结也正偏(VBC0)时时(但注意,但注意,VCE仍
2、仍大于大于0),为,为饱和工作区饱和工作区。NNPECB1.发射结正偏,向基区注入电子,集电结也正偏,也向基区注入电发射结正偏,向基区注入电子,集电结也正偏,也向基区注入电子(远小于发射区注入的电子浓度),基区电荷明显增加(存在子(远小于发射区注入的电子浓度),基区电荷明显增加(存在少子存储效应),从发射极到集电极仍存在电子扩散电流,但明少子存储效应),从发射极到集电极仍存在电子扩散电流,但明显下降。显下降。2.不再存在象正向工作区一样的电流放大作用,即不再存在象正向工作区一样的电流放大作用,即 不再成立。不再成立。3.对应饱和条件的对应饱和条件的VCE值,称为饱和电压值,称为饱和电压VCES
3、,其值约为,其值约为0.3V,深,深饱和时饱和时VCES达达0.10.2V。bcII2022-10-45当当VBC0,VBE0时时,为反向工作区。工作,为反向工作区。工作原理类似于正向工作区,但是由于集电区原理类似于正向工作区,但是由于集电区的掺杂浓度低,因此其发射效率低,的掺杂浓度低,因此其发射效率低,很小(约很小(约0.02)。)。当发射结反偏(当发射结反偏(VBE0),集电结也反偏(集电结也反偏(VBC0)时,为截止区。时,为截止区。RNNPECB反向工作区反向工作区2022-10-462022-10-472.2 2.2 理想本征集成双极晶体管的理想本征集成双极晶体管的EM模型模型P-S
4、iN-SiIV)1(0TVVeIIs)(000PnPnPnSLPDLnDAqIA:结面积结面积,D:扩散系数扩散系数,L:扩散长度扩散长度,pn0,np0:平衡少子寿命平衡少子寿命热电压热电压.T=300K,约为约为26mv正方向正方向VI(mA)ISO)1(TVVeIIso 一结两层二极管一结两层二极管(单结晶体管单结晶体管)2022-10-48)1(TVDVeIIso+-VD正向偏置正向偏置-+反向偏置反向偏置二极管的等效电路模型二极管的等效电路模型2022-10-49 两结三层三极管两结三层三极管(双结晶体管双结晶体管)(11TVVeIIESDE)(12TVVeIICSDCNPNBECI
5、EICIBIDEIDCV1V2理想本征集成双极晶体管的理想本征集成双极晶体管的EM模型模型假设假设p区很宽,忽略两个区很宽,忽略两个PN结的相互作用,则:结的相互作用,则:2022-10-410发射区发射区集电区集电区基区基区发发射射结结收收集集结结发发射射极极集集电电极极基极基极2022-10-411 两结三层三极管两结三层三极管(双结晶体管双结晶体管)1()1()1()1(212121TVVTVVTVVTVVeIeBIIeAIeIICSESCSESFVECVRVCEVIIIIBIIIIA020212010121理想本征集成双极晶体管的理想本征集成双极晶体管的EM模型模型NPNBECIEIC
6、IBI1I2V1V2NPN管反向运用时管反向运用时共基极短路电流增共基极短路电流增益益NPN管正向运用时管正向运用时共基极短路电流增共基极短路电流增益益2022-10-412BJT的三种组态的三种组态 2022-10-413 三结四层结构三结四层结构(多结晶体管多结晶体管)1()1()1()1()1()1()1(3232121321TVVTVVTVVTVVTVVTVVTVVeIedIIecIeIebIIeaIeIISSCSSSCSESCSESSFSRFRVVIIdVVIIcVVIIbVVIIa000000003223213232123121ppnnIEEBCSIBICISI1I2I3V1V2V
7、3理想本征集成双极晶体管的理想本征集成双极晶体管的EM模型模型2022-10-414 三结四层结构三结四层结构(多结晶体管多结晶体管)1()1()1(10101321321TVVTVVTVVeIeIeIIIISSCSESRRRR321110001100011IIIIIIISCBE理想本征集成双极晶体管的理想本征集成双极晶体管的EM模型模型根据基尔霍夫定律,有:根据基尔霍夫定律,有:ppnnIEECSIBICISI1I2I3V1V2V32022-10-415 三结四层结构三结四层结构(多结晶体管多结晶体管)1()1()1(1)1(0)1(1011321TVVTVVTVVeIeIeIIIIISSC
8、SESSRSRSFSFRRFFSCBE理想本征集成双极晶体管的理想本征集成双极晶体管的EM模型模型理想本征集成双极晶体管的理想本征集成双极晶体管的EM模型模型2022-10-4162.3 2.3 集成双极晶体管的有源寄生效应集成双极晶体管的有源寄生效应C(n)B(p)E(n+)npnpnpS(p)双极晶体管的四种工作状态双极晶体管的四种工作状态VBEVBC饱和区饱和区反向工作区反向工作区截止区截止区正向工作区正向工作区(正偏正偏)(反偏反偏)(正偏正偏)(反偏反偏)ppnnIEECSIBICISI1I2I3V1V2V32022-10-417VBEVBC饱和区饱和区反向工作区反向工作区截止区截止
9、区正向工作区正向工作区(正偏正偏)(反偏反偏)(正偏正偏)(反偏反偏)集成双极晶体管的有源寄生效应集成双极晶体管的有源寄生效应C(n)B(p)E(n+)npnpnpS(p)NPN管工作于正向工作区和截止区的情况管工作于正向工作区和截止区的情况VBC0npn管管VEB_pnp0VS=0VCB_pnp0VS=0VCB_pnp0npn管管VBE0集成双极晶体管的有源寄生效应集成双极晶体管的有源寄生效应C(n)B(p)E(n+)npnpnpS(p)NPN管工作于反向工作区的情况管工作于反向工作区的情况正向工作区正向工作区反向工作区反向工作区寄生晶体管对电路产生影响寄生晶体管对电路产生影响VBEVBC饱
10、和区饱和区反向工作区反向工作区截止区截止区正向工作区正向工作区(正偏正偏)(反偏反偏)(正偏正偏)(反偏反偏)2022-10-419集成双极晶体管的有源寄生效应集成双极晶体管的有源寄生效应 NPN管工作于反向工作区的情况管工作于反向工作区的情况几个假设几个假设:0)1(,0)(1)1(,0)1(,0/3/SSVVSSSCRVVFIeIVVeVPNeeVPNTSCTVRVTFTVFV结反偏工作时,结正偏工作时,10.01070.01020.01099.0131516SRSSSFCSRESFAIAIAI晶体管参数晶体管参数EM模型简化模型简化2022-10-420集成双极晶体管的有源寄生效应集成双
11、极晶体管的有源寄生效应 NPN管工作于反向工作区的管工作于反向工作区的EM方程方程(VBE(V1)0)SSCSESSRSRSFSFRRFFSCBEIeIIIIIITVBCV1)1(0)1(1011)1()1()1(1)1(0)1(1011321TVVTVVTVVeIeIeIIIIISSCSESSRSRSFSFRRFFSCBE2022-10-421集成双极晶体管的有源寄生效应集成双极晶体管的有源寄生效应 NPN管工作于反向工作区的管工作于反向工作区的EM方程方程RSFCSSFSRSFCSSFCRRCSRBRRCSREIeIIIeIIIeIIIeIITVBCVTVBCVTVBCVTVBCV)1()
12、1()1()1(减小了集电极电流减小了集电极电流作为无用电流流入衬底作为无用电流流入衬底SF减小SSCSESSRSRSFSFRRFFSCBEIeIIIIIITVBCV1)1(0)1(1011采用埋层和掺金工艺采用埋层和掺金工艺2022-10-422VEB_pnp=VBC_npn0VS=0VCB_pnp0npn管管饱和工作区饱和工作区VBE0集成双极晶体管的有源寄生效应集成双极晶体管的有源寄生效应C(n)B(p)E(n+)npnpnpS(p)NPN管工作于饱和工作区的情况管工作于饱和工作区的情况正向工作区正向工作区寄生晶体管对电路产生影响寄生晶体管对电路产生影响VBEVBC饱和区饱和区反向工作区
13、反向工作区截止区截止区正向工作区正向工作区(正偏正偏)(反偏反偏)(正偏正偏)(反偏反偏)2022-10-423集成双极晶体管的有源寄生效应集成双极晶体管的有源寄生效应 NPN管工作于饱和工作区的管工作于饱和工作区的EM方程方程RSFSRSFFFCRRFFBRRFEIIIIIIIIIII)1()1()1(2022-10-4242.4 2.4 集成双极晶体管的无源寄生效应集成双极晶体管的无源寄生效应P+P+N+PN+-BLN-epiCBEN+2022-10-425集成双极晶体管的无源寄生效应集成双极晶体管的无源寄生效应rES=rE,c+rE,b 发射极串联电阻发射极串联电阻rESrE,crE,b
14、发射区为发射区为N+扩散扩散,杂质浓度在杂质浓度在1020cm-3以上以上,所以发射区的体电阻很小所以发射区的体电阻很小,串联电阻主要由串联电阻主要由金属与硅的接触电阻决定金属与硅的接触电阻决定ECSRcE,rSE:发射极接触孔的面积发射极接触孔的面积RC:为硅与发射极金属的欧姆接触系数为硅与发射极金属的欧姆接触系数E接触电阻接触电阻体电阻体电阻2022-10-426rCS=rC1+rC2+rC3 集电极串联电阻集电极串联电阻rCS集成双极晶体管的无源寄生效应集成双极晶体管的无源寄生效应rC1LWTaWbL上底为有效集电结面积上底为有效集电结面积SC,eff=SE并作以下近似并作以下近似:1.
15、1.上底、下底各为等位面;上底、下底各为等位面;2.2.锥体内的电流只在垂直方向流动;锥体内的电流只在垂直方向流动;3.3.在上下面的电流是均匀的。在上下面的电流是均匀的。baWLTrbaC)ln(1EC2022-10-427rCS=rC1+rC2+rC3 集电极串联电阻集电极串联电阻rCS集成双极晶体管的无源寄生效应集成双极晶体管的无源寄生效应BLCEBLSCWLRr2rC2LE-CEC2022-10-428rCS=rC1+rC2+rC3 集电极串联电阻集电极串联电阻rCS集成双极晶体管的无源寄生效应集成双极晶体管的无源寄生效应LWTaWbLbaWLTrbaC)ln(3rC3EC2022-1
16、0-429rCS=rC1+rC2+rC3 集电极串联电阻集电极串联电阻rCS集成双极晶体管的无源寄生效应集成双极晶体管的无源寄生效应rC3rC2rC1ECP+P+N+-BLN-epiCN+PBEN+2022-10-430rB=rB1+rB2+rB3 基区电阻基区电阻rB集成双极晶体管的无源寄生效应集成双极晶体管的无源寄生效应EBrB3rB2rB12022-10-4312.5 MOSFET2.5 MOSFET的单管结构及工作原理的单管结构及工作原理 单极器件:只有一种载流子参与导电单极器件:只有一种载流子参与导电n+n+p型硅基板型硅基板栅极栅极绝缘层(绝缘层(SiO2)半半导导体体基基板板漏极
17、漏极源极源极2022-10-432VG=0VS=0VD=0栅极电压为零时,存储在栅极电压为零时,存储在源漏极中的电子互相隔离源漏极中的电子互相隔离2022-10-433VGS0时,沟道出现耗尽区,时,沟道出现耗尽区,至至VGS VTH时,沟道反型,时,沟道反型,形成了连接源漏的通路。形成了连接源漏的通路。+VGVD电流电流SVDS较小时,沟道中任何一处电压的栅沟道电压都大于较小时,沟道中任何一处电压的栅沟道电压都大于阈值电压,随着阈值电压,随着VDS的增大,电场强度增大,电子漂移速的增大,电场强度增大,电子漂移速度增大,因此电流随着度增大,因此电流随着VDS的增大而增大。的增大而增大。(线性区
18、,(线性区,非饱和区)非饱和区)随着随着VDS进一步增大至进一步增大至VDS=VGS-VTH(即即VGDVTH)时,靠时,靠近漏端边缘的沟道出现夹断,晶体管进入近漏端边缘的沟道出现夹断,晶体管进入饱和区饱和区。随随着着VDS的增大,夹断区向源区移动,电压的增加主要降落的增大,夹断区向源区移动,电压的增加主要降落在夹断点至漏端边缘的高阻区,沟道电子被横向强电场在夹断点至漏端边缘的高阻区,沟道电子被横向强电场拉至漏极,漏源电流基本上不随拉至漏极,漏源电流基本上不随VDS的增大而变化。的增大而变化。2022-10-434VDID非饱和区非饱和区饱和区饱和区VGN沟沟MOSFET的输出特性曲线的输出特
19、性曲线2022-10-435 场区寄生场区寄生MOSFET 寄生双极晶体管寄生双极晶体管 寄生寄生PNPN效应(闩锁(效应(闩锁(Latch up)效应)效应)2.6 MOS2.6 MOS集成电路中的有源寄生效应集成电路中的有源寄生效应2022-10-436场区寄生MOSFETn+p substraten+Ln+p substraten+L措施:措施:1.加厚场氧化层的厚度加厚场氧化层的厚度 2.增加场区注入工序增加场区注入工序2022-10-437寄生双极晶体管寄生双极晶体管n+p substraten+Ln+p substraten+L防止措施:防止措施:1.增大寄生晶体管增大寄生晶体管“
20、基区宽度基区宽度”2.P型衬底接地或负电位型衬底接地或负电位2022-10-438寄生寄生PNPN效应(闩锁(效应(闩锁(Latch up)效应)效应)P-wellP+P+N+N+VoutVdd(5V)N+P+Vss(0V)RSRWP阱阱RSRWVddVssN衬底衬底消除措施:消除措施:1.减小减小RS,RW(增加接触孔数量,加粗电源、地线(增加接触孔数量,加粗电源、地线,双阱工艺)双阱工艺)2.降低寄生三极管电流放大倍数降低寄生三极管电流放大倍数N2022-10-439作业1.分析集成双极晶体管的有源寄生效应,说明器分析集成双极晶体管的有源寄生效应,说明器件工作于何种状态下寄生效应不可忽略,为什件工作于何种状态下寄生效应不可忽略,为什么?么?2.P48 2.7
- 温馨提示:
1: 本站所有资源如无特殊说明,都需要本地电脑安装OFFICE2007和PDF阅读器。图纸软件为CAD,CAXA,PROE,UG,SolidWorks等.压缩文件请下载最新的WinRAR软件解压。
2: 本站的文档不包含任何第三方提供的附件图纸等,如果需要附件,请联系上传者。文件的所有权益归上传用户所有。
3.本站RAR压缩包中若带图纸,网页内容里面会有图纸预览,若没有图纸预览就没有图纸。
4. 未经权益所有人同意不得将文件中的内容挪作商业或盈利用途。
5. 装配图网仅提供信息存储空间,仅对用户上传内容的表现方式做保护处理,对用户上传分享的文档内容本身不做任何修改或编辑,并不能对任何下载内容负责。
6. 下载文件中如有侵权或不适当内容,请与我们联系,我们立即纠正。
7. 本站不保证下载资源的准确性、安全性和完整性, 同时也不承担用户因使用这些下载资源对自己和他人造成任何形式的伤害或损失。
