 钝化版刻蚀氮化硅
钝化版刻蚀氮化硅
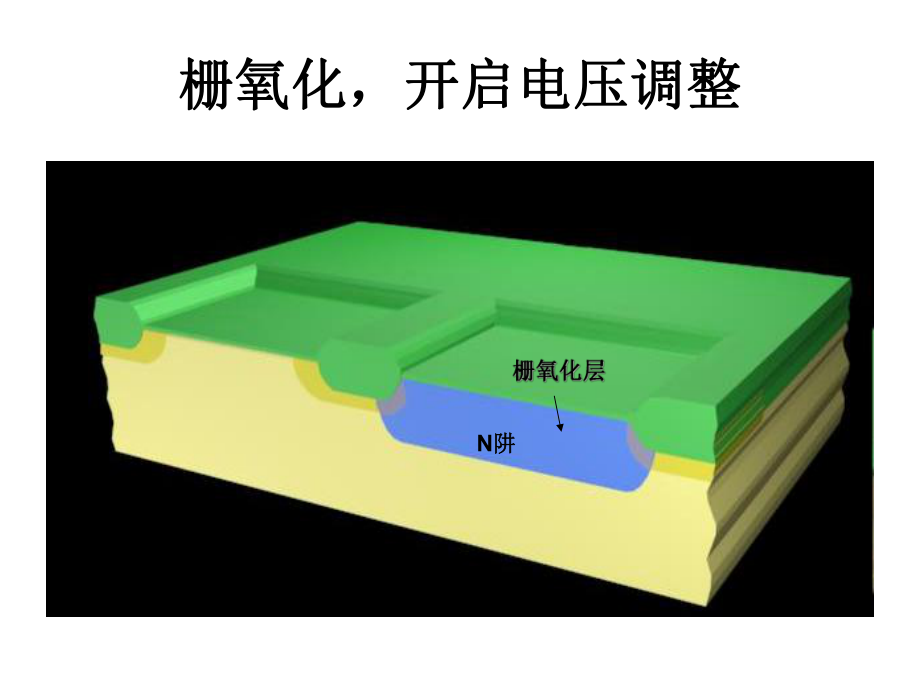


《钝化版刻蚀氮化硅》由会员分享,可在线阅读,更多相关《钝化版刻蚀氮化硅(30页珍藏版)》请在装配图网上搜索。
1、栅氧化,开启电压调整栅氧化,开启电压调整N阱阱多晶硅淀积多晶硅淀积多晶硅多晶硅栅氧化层栅氧化层N阱阱光刻光刻4,刻,刻NMOS管硅栅,管硅栅,磷磷离子注入形成离子注入形成NMOS管管N阱阱光刻光刻5,刻,刻PMOS管硅栅,管硅栅,硼离子注入及推进,形成硼离子注入及推进,形成PMOS管管N阱阱磷硅玻璃淀积磷硅玻璃淀积N阱阱光刻光刻6,刻孔、磷硅玻璃淀积回流,刻孔、磷硅玻璃淀积回流(图中有误,没刻出孔(图中有误,没刻出孔)N阱阱蒸铝、光刻蒸铝、光刻7,刻铝、,刻铝、光刻光刻8,刻钝化孔,刻钝化孔(图中展示的是刻铝后的图形)(图中展示的是刻铝后的图形)N阱阱VoVinVSSVDDP-SUB磷注入磷注
2、入硼注入硼注入磷硅玻璃磷硅玻璃离子注入的应用离子注入的应用N阱硅栅阱硅栅CMOS工艺流程工艺流程形成形成N阱阱 初始氧化,形成缓冲层,淀积氮化硅层初始氧化,形成缓冲层,淀积氮化硅层光刻光刻1,定义出,定义出N阱阱 反应离子刻蚀氮化硅层反应离子刻蚀氮化硅层 N阱离子注入,先注磷阱离子注入,先注磷31P+,后注砷,后注砷75As+3)双阱双阱CMOS集成电路的工艺设计集成电路的工艺设计 P sub.100磷磷31P+砷砷75As+形成形成P阱阱 在在N阱区生长厚氧化层,其它区域被氮化硅层阱区生长厚氧化层,其它区域被氮化硅层保护而不会被氧化保护而不会被氧化 去掉光刻胶及氮化硅层去掉光刻胶及氮化硅层
3、P阱离子注入,注硼阱离子注入,注硼N阱阱P sub.100推阱推阱退火驱入,双阱深度约退火驱入,双阱深度约1.8m去掉去掉N阱区的氧化层阱区的氧化层N阱阱P阱阱形成场隔离区形成场隔离区 生长一层薄氧化层生长一层薄氧化层 淀积一层氮化硅淀积一层氮化硅光刻光刻2场隔离区,非隔离区被光刻胶保护起来场隔离区,非隔离区被光刻胶保护起来 反应离子刻蚀氮化硅反应离子刻蚀氮化硅 场区硼离子注入以防止场开启场区硼离子注入以防止场开启 热生长厚的场氧化层热生长厚的场氧化层 去掉氮化硅层去掉氮化硅层阈值电压调整注入光刻光刻3,VTP调整注入光刻光刻4,VTN调整注入光刻胶光刻胶31P+11B+形成多晶硅栅(栅定义)
4、形成多晶硅栅(栅定义)生长栅氧化层生长栅氧化层 淀积多晶硅淀积多晶硅 光刻光刻5,刻蚀多晶硅栅刻蚀多晶硅栅N阱阱P阱阱形成硅化物形成硅化物 淀积氧化层淀积氧化层 反应离子刻蚀氧化层,形成反应离子刻蚀氧化层,形成侧壁氧化层(侧壁氧化层(spacer,sidewall)淀积难熔金属淀积难熔金属Ti或或Co等等 低温退火,形成低温退火,形成C-47相的相的TiSi2或或CoSi 去掉氧化层上的没有发生化学反应的去掉氧化层上的没有发生化学反应的Ti或或Co 高温退火,形成低阻稳定的高温退火,形成低阻稳定的TiSi2或或CoSi2形成形成N管源漏区管源漏区 光刻光刻6,利用光刻胶将,利用光刻胶将PMOS
5、区保护起来区保护起来 离子注入磷或砷,形成离子注入磷或砷,形成N管源漏区管源漏区形成形成P管源漏区管源漏区 光刻光刻7,利用光刻胶将,利用光刻胶将NMOS区保护起来区保护起来 离子注入硼,形成离子注入硼,形成P管源漏区管源漏区形成接触孔形成接触孔 化学气相淀积化学气相淀积BPTEOS硼磷硅玻璃层硼磷硅玻璃层退火和致密退火和致密光刻光刻8,接触孔版,接触孔版反应离子刻蚀磷硅玻璃,形成接触孔反应离子刻蚀磷硅玻璃,形成接触孔形成第一层金属形成第一层金属淀积金属钨淀积金属钨(W),形成钨塞,形成钨塞形成第一层金属形成第一层金属淀积金属层,如淀积金属层,如Al-Si、Al-Si-Cu合金等合金等光刻光刻
6、9,第一层金属版,定义出连线图形,第一层金属版,定义出连线图形反应离子刻蚀金属层,形成互连图形反应离子刻蚀金属层,形成互连图形形成穿通接触孔形成穿通接触孔 化学气相淀积化学气相淀积PETEOS,等离子增强正硅酸四乙酯热分解等离子增强正硅酸四乙酯热分解Plasma Enhanced TEOS:tetraethylorthosilicate Si-(OC2H5)4-通过化学机械抛光进行平坦化通过化学机械抛光进行平坦化 光刻穿通接触孔版光刻穿通接触孔版 反应离子刻蚀绝缘层,形成穿通接触孔反应离子刻蚀绝缘层,形成穿通接触孔形成第二层金属形成第二层金属 淀积金属层,如淀积金属层,如Al-Si、Al-Si
7、-Cu合金等合金等 光刻光刻10,第二层金属版,定义出连线图形,第二层金属版,定义出连线图形 反应离子刻蚀,形成第二层金属互连图形反应离子刻蚀,形成第二层金属互连图形正硅酸乙脂(TEOS)分解650750合金合金 形成钝化层形成钝化层 在低温条件下在低温条件下(小于小于300)淀积氮化硅淀积氮化硅 光刻光刻11,钝化版,钝化版 刻蚀氮化硅,形成钝化图形刻蚀氮化硅,形成钝化图形测试、封装,完成集成电路的制造工艺测试、封装,完成集成电路的制造工艺 CMOS集成电路采用集成电路采用(100)晶向的硅材料晶向的硅材料4)图解双阱硅栅图解双阱硅栅CMOS制作流程制作流程 首先进行表面清洗,去除wafer
8、表面的保护层和 杂质,三氧化二铝必须以高速粒子撞击,并 用化学溶液进行清洗。甘油 甘油甘油 然后在表面氧化二氧化硅膜以减小后一步氮化硅对晶圆的表面应力。涂覆光阻(完整过程包括,甩胶预烘曝光显影后烘腐蚀去除光刻胶)。其中二氧化硅以氧化形成,氮化硅LPCVD沉积形成(以氨、硅烷、乙硅烷反应生成)。光刻技术去除不想要的部分,此步骤为定出P型阱区域。(所谓光刻胶就是对光或电子束敏感且耐腐蚀能力强的材料,常用的光阻液有S1813,AZ5214等)。光刻胶的去除可以用臭氧烧除也可用专用剥离液。氮化硅用180的磷酸去除或含CF4气体的等离子刻蚀(RIE)。在P阱区域植入硼(+3)离子,因硅为+4价,所以形成
9、空洞,呈正电荷状态。(离子植入时与法线成7度角,以防止发生沟道效应,即离子不与原子碰撞而直接打入)。每次离子植入后必须进行退火处理,以恢复晶格的完整性。(但高温也影响到已完成工序所形成的格局)。LOCOS(local oxidation of silicon)选择性氧化:湿法氧化二氧化硅层,因以氮化硅为掩模会出现鸟嘴现象,影响尺寸的控制。二氧化硅层在向上生成的同时也向下移动,为膜厚的0.44倍,所以在去除二氧化硅层后,出现表面台阶现象。湿法氧化快于干法氧化,因OH基在硅中的扩散速度高于O2。硅膜越厚所需时间越长。去除氮化硅和表面二氧化硅层。露出N型阱区 域。(上述中曝光技术光罩与基片的距离分为接触式、接近式和投影式曝光三种,常用投影式又分为等比和微缩式。曝光会有清晰度和分辩率,所以考虑到所用光线及波长、基片表面平坦度、套刻精度、膨胀系数等)。
- 温馨提示:
1: 本站所有资源如无特殊说明,都需要本地电脑安装OFFICE2007和PDF阅读器。图纸软件为CAD,CAXA,PROE,UG,SolidWorks等.压缩文件请下载最新的WinRAR软件解压。
2: 本站的文档不包含任何第三方提供的附件图纸等,如果需要附件,请联系上传者。文件的所有权益归上传用户所有。
3.本站RAR压缩包中若带图纸,网页内容里面会有图纸预览,若没有图纸预览就没有图纸。
4. 未经权益所有人同意不得将文件中的内容挪作商业或盈利用途。
5. 装配图网仅提供信息存储空间,仅对用户上传内容的表现方式做保护处理,对用户上传分享的文档内容本身不做任何修改或编辑,并不能对任何下载内容负责。
6. 下载文件中如有侵权或不适当内容,请与我们联系,我们立即纠正。
7. 本站不保证下载资源的准确性、安全性和完整性, 同时也不承担用户因使用这些下载资源对自己和他人造成任何形式的伤害或损失。
