 《功率特性》PPT课件
《功率特性》PPT课件
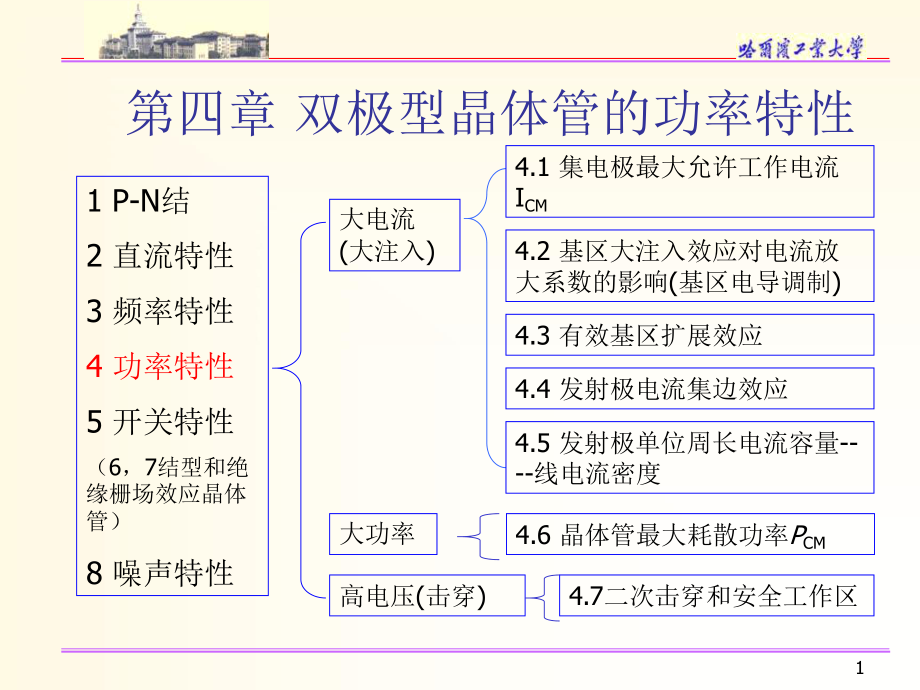


《《功率特性》PPT课件》由会员分享,可在线阅读,更多相关《《功率特性》PPT课件(116页珍藏版)》请在装配图网上搜索。
1、1第四章 双极型晶体管的功率特性1 P-N结2 直流特性3 频率特性4 功率特性5 开关特性(6,7结型和绝缘栅场效应晶体管)8 噪声特性大电流(大注入)高电压(击穿)大功率4.1 集电极最大允许工作电流ICM4.2 基区大注入效应对电流放大系数的影响(基区电导调制)4.3 有效基区扩展效应4.4 发射极电流集边效应4.5 发射极单位周长电流容量-线电流密度4.6 晶体管最大耗散功率PCM4.7二次击穿和安全工作区21 P-N结2 npn管直流特性3 频率特性4 功率特性5 开关特性6,7结型和绝缘栅场效应晶体管8 噪声特性3n晶体管的输出功率受:集电极最大电流ICM 最大耗散功率PCM 二次
2、击穿特性(临界功率)最高耐压BVcbo、BVceo的限制。第四章 双极型晶体管的功率特性安全工作区本章将围绕安全工作区的要求,讨论大功率(大注入)下的直流特性44.1 集电极最大允许工作电流ICM晶体管电流放大系数与集电极电流的关系见图4-1。在大电流下,b0随Ic增加而迅速减小,限制了晶体管最大工作电流。晶体管的电流放大系数主要决定于g和b*,分析大电流下哪些特殊效应使g和b*发生哪些变化。为了衡量晶体管电流放大系数在大电流下的下降程度,特定义:共发射极直流短路电流放大系数b0下降到最大值b0M的一半(即boboM0.5)时所对应的集电极电流为集电极最大工作电流,记为ICM54.2 基区大注
3、入效应对电流放大系数的影响b随IC的增加而下降:发射效率g、基区输运b*、(势垒、表面)复合基区大注入效应有效基区扩展效应均匀基区,缓变基区(强场、弱场)64.2 基区大注入效应对电流放大系数的影响1.基区大注入下的电流基区大注入下的电流(以(以n-p-n管为例)管为例)大注入时,大注入自建电场作用下通过大注入时,大注入自建电场作用下通过n+-p结的电子电流密度为:结的电子电流密度为:对于均匀基区晶体管对于均匀基区晶体管(1-48)pxxpppppndxxdnxpxnqDJ)()()(1)0()()()0()()()(00bbpppppbpppppppnNxppxpnxnxnnxn nbbbb
4、pLWWndxxdn 因为因为 )0()(7(4-1)(4-2)与第二章小注入情况相比:由于大注入自建电场的漂移作用,同样的注入边界浓度下Dnb-2Dnb,JnE增大一倍;同样的JnE,边界浓度及梯度只需一半。与1.3中的结论一样。0)0()0(1)0(pnbxbbbbbnenNnWnqDJ bbnbnebbWnDqJNn)0()2(12)0(,上上式式变变为为项项时时,方方括括号号中中第第当当 8 对于对于缓变基区晶体管缓变基区晶体管,基区内已经存在着由于杂质分布不均匀而产生的缓变基区自建电场。在大注入情况下,注入的大量非平衡少子将改变这个电场。这个过程比较复杂,书中给出简单近似分析。得出结
5、论:在发射极电流密度很大的情况下,基区电子浓度线性分布,且与杂质分布情况无关(均匀基区和缓变基区一样)。由于大注入下扩散、漂移各半,电子浓度梯度只为小注入时的一半时即可维持与小注入下相当的电流值。仅仅是数学形式上得到的推论。9a图以电场因子h为参量,同图2-13;b图以d即Jne为qDnbNb(0)/Wb的倍数为参量,表示注入水平(在h8时)。bbnbneWnqDJ)0(2 10结论:大注入对缓变基区晶体管基区电子及其电流密度的影响与对均匀基区晶体管的相似。这是因为在大注入条件下的缓变基区中,大注入自建电场对基区多子浓度梯度的要求与基区杂质电离以后形成的多子浓度梯度方向是一致的,这时杂质电离生
6、成的多子不再象小注入时那样向集电结方向扩散并建立缓变基区自建电场,而是按照基区大注入自建电场的要求去重新分布。因此,不同电场因子的缓变基区在大注入下有相同的电子浓度分布。可以说,在大注入情况下,大注入自建电场取代(掩盖)了由于杂质分布不均匀所形成的电场(缓变基区自建电场)。11在(大注入、缓变基区)自建电场E作用下dxdnqDpEqJdxdpqDpEqJnnnppp对多子空穴,动态平衡时,扩散流等于漂移流,0pJdxxdpxpqkTEdxxdpDExppp)()(1 )()(dxdnnNqkTEnNNdxdnnNdxdNNnNNqkTnNdxdnNqkTExnxNxpbbBbbBBbbBBBb
7、BBbBbBbB1)11()(1)()()(12dxdnnNqkTEnNNdxdnnNdxdNNnNNqkTnNdxdnNqkTEbbBbbBBbbBBBbBBbBbB1)11()(1 第一项是缓变基区自建电场分量,随注入水平提高(nb增大)而减小。对于均匀基区,此项自然为零。第二项是大注入自建电场分量,随注入水平提高(nb增大,梯度增大)而增大(并在nbNB时趋于常数)。故,特大注入时,只有大注入自建电场起作用,而且其作用的极限是使基区少子分布梯度相当于小注入时的一半。134.2 基区大注入效应对电流放大系数的影响2.基区电导调制效应大注入:注入少子浓度接近以至超过平衡多子浓度 基区大注入时
8、,注入基区的电子浓度接近甚至超过基区空穴平衡浓度。另外,为了维持电中性,基区积累起与少子相同浓度和分布的空穴(非平衡多子)参见图2-15c、d。141516)0()()()0()()()(00bbpppppbpppppppnNxppxpnxnxnnxn bppbppBbbppbppBbNxpNxnNnNxpNxnNn11)(10)(10)0(2)()()0(时;时17注入载流子以及为维持电中性而增加的多子使得基区电阻率显著下降,并且电阻(导)率随注入水平变化,称为基区电导调制效应4.2 基区大注入效应对电流放大系数的影响2.基区电导调制效应可见,非平衡少子浓度的变化引起基区电阻率的变化(调制)
9、实际上,引起电阻率变化的因素包括高浓度的非平衡少子,但作为基区电导调制效应影响电流放大系数(发射效率)的是基区多子空穴12)-(4 1 bpbbNq 为为小注入下,基区电阻率小注入下,基区电阻率13)-(4 )(1 nNNnNqnNpNpbbbbnbbbbb ,基区电阻率,基区电阻率大注入下,大注入下,184.2 基区大注入效应对电流放大系数的影响发射效率项势垒复合项基区输运(体复合)项表面复合项69)-(2 22122200nbebSnbbkTqVinbbbmpebbeDAWSALWenLpWxLWeb b b194.2 基区大注入效应对电流放大系数的影响表示发射结势垒复合的第二项在大注入下
10、可以忽略,故只需讨论其余三项在大注入下如何变化。第一项:小注入时的发射效率项。大注入下基区电阻率的变化使发射效率项变为(4-14)第三项:体复合项,它表示基区体复合电流Ivb与发射极注入的电子电流Ine之比。若基区电子寿命为tnb,则(4-15))1(bpebbepebbeNnLWLW nbbbenqWAIt t 2)0(Vb 204.2 基区大注入效应对电流放大系数的影响(4-16)(4-1)第四项:基区表面复合项,表示基区表面复合电流与发射极电子电流之比。将式(266)与式(41)相比,即可得到大注入下基区表面复合项。(2-66)(4-17)0)0()0(1)0(pxbbbbbnbnenN
11、nWnqDJ)0(21)0(1222bbbbnbbneVbNnNnLWII)1()(02kTqVbSbsrsebeqnAxnSqAI)0(2)0(bbbbnbebSnersnNnNDAWSAII 21这里用基区边界的注入电子浓度近似代表整个基区内的注入电子浓度。都很大(4-19)(4-18))0(2)0()0(21)0(12)0(1 122bbbbnbebSbbbbnbbbbpebbenNnNDAWSANnNnLWNnLW b bnbebSnbbbnbebnepebbeDAWSALWNqDAWILW24)21(122 b b(4-20)2111111bnbebnepebbebbpebbepeb
12、beNqDAWILWNnNLWLW g g69)-(2 22122200nbebSnbbkTqVinbbbmpebbeDAWSALWenLpWxLWeb b b由于基区电导调制效应,相当于基区掺杂浓度增大,穿过发射结的空穴电流分量增大,使g降。第二项、第三项表明,由于大注入下基区电子扩散系数增大一倍,可视为电子穿越基区的时间缩短一半,复合几率下降,所以使体内复合和表面复合均较小注入时减少一半。缺势垒复合项22图4-3 1/b随Ie的变化 在小电流下,大注入自建电场的作用使基区输运系数增加(极限2倍)在大电流下,基区电导调制效应引起发射效率下降(起主要作用)23缓变基区中,大注入自建电场的作用破
13、坏了缓变基区自建电场,在特大注入时,基区少子完全受大注入自建电场的作用,和均匀基区情况一样,扩散系数增大一倍。基区渡越时间都趋于Wb2/4DnbbbnbneWNqDJ)0(244.1 集电极最大允许工作电流ICM晶体管电流放大系数与集电极电流的关系。在大电流下,b0随Ic增加而迅速减小,限制了晶体管最大工作电流。晶体管的电流放大系数主要决定于g和b*。共发射极直流短路电流放大系数b0下降到最大值b0M的一半(即bobOM0.5)时所对应的集电极电流为集电极最大工作电流,记为ICM小结254.2 基区大注入效应对电流放大系数的影响在发射极电流密度很大的情况下,基区电子浓度线性分布,且与杂质分布情
14、况无关(均匀基区和缓变基区一样)。由于大注入下扩散、漂移各半,电子浓度梯度只为小注入时的一半时即可维持与小注入下相当的电流值。2.基区电导调制效应基区电导调制效应注入载流子以及为维持电中性而增加的多子使得基区电阻率显著下降,并且电阻(导)率随注入水平变化,称为基区电导调制效应由于基区电导调制效应,相当于基区掺杂浓度增大,穿过发射结的空穴电流分量增大,使g降。由于大注入下基区电子扩散系数增大一倍,可视为电子穿越基区的时间缩短一半,复合几率下降,所以使体内复合和表面复合均较小注入时减少一半。小结264.3 有效基区扩展效应l有效基区扩展效应是引起大电流下晶体管电流放大系数下降的另一重要原因。l因系
15、大电流下集电结空间电荷分布情况发生变化而造成的b下降(以及fT下降),因此又称为 集电结空间电荷区电荷限制效应。l所对应的最大电流称为 空间电荷限制效应限制的最大集电极电流。l由于合金管与平面管集电结两侧掺杂情况不同,空间电荷区内的电荷分布及改变规律不同,受电流变化的影响也不同。274.3 有效基区扩展效应图4-5 均匀基区晶体管的有效基区扩展l均匀基区晶体管(合金管)l单边突变结近似l空间电荷区主要向基区侧扩展l小电流下,按耗尽层近似,有l大电流下,大量空穴流过空间电荷区,不再满足耗尽层近似 正电荷区电荷密度 负电荷区电荷密度l结上电压VC不变,则电场强度曲线包围面积不变,于是,正电荷区收缩
16、,负电荷区略展宽pAnDxqNxqN()()pNqqNpNqqNAADDP+P+n0 xpxnXn”WbWbWcib284.3 有效基区扩展效应图4-6 基区宽度随电流的变化xJcWbWcibJcr0-xm0Xm(Jc)P+nP+将电流密度转换成载流子浓度,代入一维泊松方程可得空间电荷区宽度xm与集电极电流(密度)Jc关系,进而得到感应基区和有效基区宽度与电流密度的关系均匀基区晶体管有效基区扩展的规律。294.3 有效基区扩展效应slcslpecqvJpqpvJJ(4-23)(4-24)(4-25)左边:(4-22))0()()0(n0022xxpNqdxdD )()()()(000000cD
17、pnnpxxxslcxDxVVdEdxxExdExdxqvJNqdxdxdExpnmmmmm 3021210)1()(2 crcDcDmJJqNVVx 4.3 有效基区扩展效应(4-26)右边:(4-27)得到:(4-29)令:(4-28)xm0)2()(20mslcDxqvJNq 20)1(2mDslcDcDxNqvJqNVV DslcrNqvJ 314.3 有效基区扩展效应(4-29a)图4-6 基区宽度随电流的变化210210)1()1(DmcrcmmNpxJJxxn当pND时,即特大注入情况,xm0,有效基区宽度扩展到cb结冶金结处。n当p=ND时,Jc=Jcr,xm=xm0.2132
18、4.3 有效基区扩展效应实际上,由:(1-92)当 时,pNNpNNAADD;nnxx)1(1)1(1)1(1)1(1 210210210210 DmbcrcmbbDmcrcmcibNpxWJJxWWNpxJJxW210)()(2DADDAmDAAnNNqNVVNxNNNx 334.3 有效基区扩展效应则()()21 pNNpNNxxADDAnn当认为pNA则21)1(DnnNpxx(4-29a)210210)1()1(DmcrcmmNpxJJxx344.3 有效基区扩展效应 对于平面管(以n+-p-n-n+为例),其基区杂质浓度高于集电区,集电结空间电荷区主要向集电区一侧扩展。当大量载流子电
19、子穿过集电结空间电荷区时,引起另一种类型的有效基区扩展效应。由于电子的流入,引起负空间电荷区(基区侧)电荷密度增加,正空间电荷区(集电区侧)电荷密度减小。为保持电中性,负空间电荷区宽度变窄,而正空间电荷区展宽。当电流密度很大时,载流子电子的浓度达到以至超过原正空间电荷密度,使原正空间电荷区变成中性区以至负电荷区,正负电荷区边界改变,发生有效基区扩展。354.3 有效基区扩展效应图4-7 缓变基区晶体管cb结空间电荷区电场分布图4-5 均匀基区晶体管的有效基区扩展P+n0 xpxnXn”WbWbWcibE364.3 有效基区扩展效应 由于电流密度与载流子浓度、载流子漂移速度成正比,半导体中载流子
20、迁移率(漂移速度)又随电场强度而变化,所以,不同电场强度下,同样的电流密度可有不同的载流子浓度,对空间电荷的补偿作用及规律也不同。缓变基区晶体管的有效基区扩展效应分强场和弱场两种情况:在强场中,载流子以极限漂移速度运动,电流的增大依靠载流子浓度的增大;在弱场中,电流的增大依靠载流子漂移速度的增大(电场有限地增大),载流子浓度可以不变。374.3 有效基区扩展效应强场情况弱场情况nNNAAnNNDD384.3 有效基区扩展效应强场情况slcslnccqvJnnqvJJ(4-33)(4-32)(4-34)()()()()0)1(0)(00ExJJqNxEExqvJNqxEcrcDslcD )(0n
21、NqdxdED 39()()()()0)1(0)(00ExJJqNxEExqvJNqxEcrcDslcD 4.3 有效基区扩展效应强场情况(4-34)a.小注入,耗尽层近似;b.随Jc增大,斜率下降,斜线变平缓;c.当Jc=Jcr=qNDvsl时,E(x)=E(0),正负电荷在n区两侧;d.当JcJcr时,n区出现负电荷,曲线斜率为负,在Jc=Jcr时,E(0)=0;e.JcJcr 时,发生基区扩展效应。404.3 有效基区扩展效应强场情况(4-35)(4-36)(4-36a)因JcJcr开始有效基区扩展,故Jcr被称为平面管强场下有效基区扩展的临界电流密度。xJJqNxEcrcrD)1()(
22、0 21)(21 2020cDTccrcDcDcrcrWqNVJWqNVVJJ 220cTcDslcrqWVNqvJ0Wc内积分,VD-Vc为集电结上电压。414.3 有效基区扩展效应强场情况(4-37)(4-38)(4-39))(220cibcTcDslcWWqVNqvJ )(1)(1 2121crccrcrccibDslcDslcrccibJJJJWWNqvJNqvJWW )(1 21DslcDslcrcbbNqvJNqvJWWW 424.3 有效基区扩展效应强场情况l缓变基区晶体管集电结空间电荷区主要向集电区侧扩展l大量载流子流过电荷区,改变其中电荷密度l强场时,载流子达到极限漂移速度,
23、电流增大,载流子浓度增大lJc=Jcr=qNDvsl时,载流子电荷恰好中和集电区电荷,正负电荷分布在集电区两侧lJc=Jcr时,E(0)=0;Jcr被称为平面管强场下有效基区扩展的临界电流密度l感应基区扩展的极限是n-n+交界面小结434.3 有效基区扩展效应弱场情况444.3 有效基区扩展效应弱场情况l如果Jc=Jcr=qvslND(NA)时,cb结势垒区场强小于104V/cm,则处于弱场情况l载流子在势垒区中尚未达到极限漂移速度,载流子的漂移速度与电场强度成正比l电流(Jc=qvncn)的增加依靠载流子速度的提高来实现l载流子速度的提高依靠电场强度的提高l此时n=Nc,集电结势垒区内净电荷
24、为零,电场保持均匀l随着Jc增大,势垒区保持均匀电场向衬底收缩,同时均匀的电场强度增大,发生缓变基区晶体管弱场下的有效基区扩展效应?454.3 有效基区扩展效应弱场情况l当n=Nc时,dE/dx=0.随着Jc增大,若n增加,使nNc,则有净电荷,使|E(x)|随x增大。而 若|E(x)|增大,则n减小,这将使|E(x)|减小 所以,当n=Nc时,弱场下,电场区将保持n=Nc,而dE/dx=0EqJqvJncc0464.3 有效基区扩展效应弱场情况l有多余部分n积累在电场区边界做为负电荷层以维持电场,弱场中只允许n=Nc的电子流过。l外加电压不变,电场分布曲线包围面积不变,E(x)曲线包围区域随
25、Jc增大而变窄、增高,直至达到强场,n才可以大于Nc,v=vsl。47cccccTcccTcnncrcTcccrccWVWVNWVqnqvJWVEJJJ00 0 0时,4.3 有效基区扩展效应弱场情况)(1 )(1 )(00 ccDccncbbccDccnccibcibccTcccibcrWVVJNqWWWWVVJNqWWWWVJWJJ时,感应基区宽度为当484.3 有效基区扩展效应小结l有效基区扩展效应是大电流(密度)下造成晶体管电流放大系数下降的重要原因之一。根据晶体管结构和工作条件,有效基区扩展效应分三种类型,有各自的扩展规律、机制和临界电流密度。l1.均匀基区:有 即有扩展,时 2.缓
26、变强场:时,开始扩展。3.缓变弱场:时,开始扩展。l由于 的变化,改变了空间电荷区电场和电荷分布,出现有效基区扩展,本质上都是集电结空间电荷区总电荷在一定的集电结偏压作用下恒定的限制所造成的,故也称集电结空间电荷区电荷限制效应。DslcrcNqvJJ)211(0 mcibxW)(1 2cmccrcrcWxJJJccTCcnccrcWVNqvJJ cJcncrcrJJcrcrJJ 494.4 发射极电流集边效应504.4 发射极电流集边效应l实际晶体管中,基极电流平行于结平面流动l基极电流在狭长的基极电阻上产生平行于结平面方向的横向压降l大电流下,横向压降也很大,明显改变eb结各处实际电压,导致
27、各处实际注入电流的悬殊差异l电流大部分集中在发射区边界,使发射区面积不能充分利用l电流的局部集中使得在小电流下局部也有较大的电流密度,从而引起局部的“大注入”效应和有效基区扩展效应514.4 发射极电流集边效应l 发射极电流分布l 发射区有效宽度l 发射极有效长度l 基极电阻的变化l发射极电流集边效应l发射区有效(半)宽度l发射极有效长度l发射极峰值电流密度l发射极平均电流密度 概念 定义 计算524.4 发射极电流集边效应(1-37)l由于p-n 结电流与结电压的指数关系,发射结偏压越高,发射极边缘处的电流较中间部位的电流越大,这种现象称为发射极电流集边效应。l这种效应是由于基区体电阻的存在
28、引起横向压降所造成的,又称之为基极电阻自偏压效应。kTqVeII0 ekTqVkTqkTVqeIeeeIeIIebeb110(0 534.4 发射极电流集边效应图4-13 发射极上的电流分布544.4 发射极电流集边效应 发射极电流集边效应(或基极电阻自偏压效应)增大了发射结边缘处的电流密度,使之更容易产生大注入效应或有效基区扩展效应,同时使发射结面积不能充分利用,因而有必要对发射区宽度的上限作一个规定。l为充分利用发射区面积,限制集边效应,特规定:发射极中心到边缘处的横向压降为kT/q时所对应的发射极条宽为发射极有效宽度,记为2Seff。Seff称为有效半宽度。554.4 发射极电流集边效应
29、56dyyJyIWLdyyIdrydVBbBbebBb )()()()(4.4 发射极电流集边效应(4-44)(4-45)()()()()bEbCEBWyJWyJyJdydJ1rb的自偏压dyLyJdIyIdyLyJyIecBBeEB )()()()(574.4 发射极电流集边效应()()()()kTyqVEkTyqVEEeJeJyJE00(4-46)0E区VYV(Y)VE(y)V(y)沿Y方向的电势分布VE(y)沿Y方向eb结上电压分布()()()()()()()()kTyqVEkTyVVqEkTyqVEEkTqVEEeJeJeJyJeJJEEE0000000 584.4 发射极电流集边效应
30、()()()()()()()()()()()kTyqVJWeJWkTyqVJWeJWdyyVdEbbkTyqVEbbEEbbkTyqVEbbE10101 1110022(4-47)边界条件:()()0 ;000yydyydVyV解得:(4-48)yqkTWJchqkTqkTyVbEbE21)()0()1()(594.4 发射极电流集边效应()()qkTyVSyyVyeffSyeffy ;0 0S0eff时,时,的定义:根据()()210132.1EbbeffJqkTWS (4-49)可代替JE(0)计算Seff,意义更明显,运用更方便。)0(718.1)0()0()(1)0(718.20Eqk
31、TkTqVEeffEEEPJdVeJVSVJJJ 发射极平均电流密度:发射极平均电流密度:发射极峰值电流密度:发射极峰值电流密度:604.4 发射极电流集边效应 有关定义均以发射极宽度等于有效宽度为前提。当发射极宽度大于有效宽度时,可认为中心附近区域(Seff之外区域)对器件工作不起作用,或没有电流(实际很小)。上述讨论以y=0为坐标原点,但Seff是从发射极边缘向中心计算的。614.4 发射极电流集边效应l定义:沿极条长度方向,电极端部至根部之间压降为kT/q时所对应的发射极长度称为发射极有效长度l作用:类似于基极电阻自偏压效应,但沿Z方向,作用在结的发射区侧l计算:与基极电阻相同求法求出发
32、射极条等效电阻后,按定义求出。图4-17 沿发射极条长方向的电流分布624.4 发射极电流集边效应l大电流下,计算基极电阻时,发射极电流均匀分布的假设不再成立。由于集边效应,使得与Ie复合的基极电流也不再线性减小l大注入效应所引起的基区电导调制效应使基区电阻大为减小l有效基区扩展效应也使基区电阻减小 总之,大电流下,基极电阻会大为减小。但一般难于计算,可通过实验测得。634.4 发射极电流集边效应小结l发射极电流分布l发射区有效宽度l发射极有效长度l基极电阻的变化l发射极电流集边效应l发射区有效(半)宽度l发射极有效长度l发射极峰值电流密度l发射极平均电流密度 概念 定义 计算l为充分利用发射
33、区面积,限制集边效应,特规定:发射极中心到边缘处的横向压降为kT/q时所对应的发射极条宽为发射极有效宽度,记为2Seff。Seff称为有效半宽度。l大电流下,计算基极电阻时,发射极电流均匀分布的假设不再成立。由于集边效应,使得与Ie复合的基极电流也不再线性减小l大注入效应所引起的基区电导调制效应使基区电阻大为减小l有效基区扩展效应也使基区电阻减小 总之,大电流下,基极电阻会大为减小。但一般难于计算,可通过实验测得。()()210132.1EbbeffJqkTWS644.5 发射极单位周长电流容量线电流密度l由于电流集边效应,使得在大电流情况下晶体管的电流容量不是取决于发射区面积,而是取决于发射
34、区的周长。为此,特定义单位发射极周长上的电流为线电流密度:effCMeffeffCMECMCMLSJSAILIJ654.5 发射极单位周长电流容量线电流密度l上式中JCMCM为保证不发生基区扩展效应或基区大注入效应的最大(面)电流密度。由于二者数值不等,在设计晶体管时应按较小的电流密度做为计算依据。一般说来,合金型晶体管基区杂质浓度远远低于集电区杂质浓度,容易发生基区电导调制效应。而外延平面(台面)管,因基区杂质浓度远远高于集电区杂质浓度,易于发生向集电区延伸的有效基区扩展效应。664.5 发射极单位周长电流容量线电流密度l按基区电导调制效应计算,定义:注入到基区eb结侧边界少子浓度达到基区杂
35、质浓度时所对应的发射极电流密度为受基区电导调制效应限制的最大发射极电流密度。对于均匀基区管:对于缓变基区管:bBnbEMWNqDJ5.1 bBnbEMWNqDJ5.1 0)0()0(1)0(pxbbbbbnbnenNnWnqDJ (4-1)674.5 发射极单位周长电流容量线电流密度l按有效基区扩展效应计算,定义:基区开始扩展时的临界电流密度为最大集电极电流密度。对于均匀基区管:对于缓变基区管:强场弱场图4-6 基区宽度随电流的变化BslcrCMNqvJJ CslcrCMcTcCslcrCMNqvJJqWVNqvJJ 202cTcCncrCMWVNqJJ0 684.5 发射极单位周长电流容量线
36、电流密度l在晶体管设计时,应按上述各式求出发生基区电导调制效应及有效基区扩展效应的最大电流密度,选其中较小者作为设计的上限,以保证在正常工作时晶体管中不会发生严重的基区电导调制效应及基区扩展效应。694.5 发射极单位周长电流容量线电流密度 在功率晶体管中,常常会遇到在功率晶体管中,常常会遇到“改善大电流特性改善大电流特性”的问题。所谓的问题。所谓改善大电流特性,就是指设法将改善大电流特性,就是指设法将b b0 0或或f fT T开始下降的电流提高一些,或开始下降的电流提高一些,或者说是如何提高集电极最大工作电流者说是如何提高集电极最大工作电流I ICMCM的问题。的问题。对于图形确定的晶体管
37、,改善大电流特性主要是提高发射极单位对于图形确定的晶体管,改善大电流特性主要是提高发射极单位周长电流容量周长电流容量(即提高线电流密度即提高线电流密度),可以考虑的途径是:,可以考虑的途径是:外延层电阻率选得低一些,外延层厚度尽可能小些;外延层电阻率选得低一些,外延层厚度尽可能小些;直流放大系数直流放大系数b b0 0或或f fT T尽量做得大些尽量做得大些;在允许的范围内适当提高集电结的偏压及降低内基区方块电阻。在允许的范围内适当提高集电结的偏压及降低内基区方块电阻。其中、两项可调整的范围大些,但第项又受击穿电压指标其中、两项可调整的范围大些,但第项又受击穿电压指标的限制,第项受成品率等的限
38、制,的限制,第项受成品率等的限制,b b0 0、f fT T也不能做得太高;考虑到也不能做得太高;考虑到发射结扩散及发射结击穿电压,内基区方块电阻又不能做得太小,所发射结扩散及发射结击穿电压,内基区方块电阻又不能做得太小,所以提高线电流密度的限度也是有限的。如实在满足不了要求,只能靠以提高线电流密度的限度也是有限的。如实在满足不了要求,只能靠加长发射极总周长来改善大电流特性。加长发射极总周长来改善大电流特性。704.5 发射极单位周长电流容量线电流密度小结l由于电流集边效应,在大电流情况下晶体管的电流容量取决于发射区的周长。l定义单位发射极周长上的电流为线电流密度 l为保证不发生基区扩展效应或
39、基区大注入效应,在设计时应按较小的电流密度做为计算依据。l按基区电导调制效应计算,定义:注入到基区eb结侧边界少子浓度达到基区杂质浓度时所对应的发射极电流密度为受基区电导调制效应限制的最大发射极电流密度。l按有效基区扩展效应计算,定义:基区开始扩展时的临界电流密度为最大集电极电流密度。l改善大电流特性,就是指设法将b0或fT开始下降的电流提高一些,或者说是如何提高集电极最大工作电流ICM的问题。714.6 晶体管最大耗散功率PCM 最大耗散功率是从热学角度限制晶体管最大输出功率的参数。这是设计、制造大功率晶体管必须考虑的重要参数之一。晶体管具有功率放大作用,并不是说它本身产生能量,晶体管只是把
40、电源的能量转换成输出信号的能量,使输出信号功率Po比输入信号功率Pi大Kp倍(Kp Po/Pi)。在转换过程中晶体管本身还要消耗一定的功率Pc。CooDoPPPPPh 转换效率:724.6 晶体管最大耗散功率PCMl晶体管耗散的功率PC转换成为热量。一部分散发到环境中;一部分使结温升高。l晶体管在进行功率放大时,eb结正偏,cb结反偏,cb结的结电阻远大于eb结的结电阻,故晶体管的功率消耗主要在集电结,发热也主要在集电结。l晶体管最大耗散功率PCM不仅限制了晶体管的工作点,也通过转换效率限制其输出功率(图4-18)。l晶体管最大耗散功率受热阻、最高允许结温和环境温度限制。734.6 晶体管最大
41、耗散功率PCM热阻 如果晶体管耗散功率所转换的热量大于单位时间所能散发出去的热量,多余的热量将使结温Tj升高。如果环境温度记为TA,则管芯每单位时间向外部散发的热量应为 QK(TJ一TA),K为平均热导。随着结温的升高,散热能力也增大,当晶体管产生的热量(以 消耗的电功率表示)与单位时间所能散发的热量相等时,达到热稳态,此时:()()AjTAjCTTRTTKQP1CAjTPTTR74kAtRALALRPTTRIVVRTcAjT 21 对片状材料:对片状材料:热路中热路中电路中电路中4.6 晶体管最大耗散功率PCM热导率晶体管管芯到管壳的热阻称为内热阻。晶体管热阻包括Sj片、AuSb片、Mo片及
42、铜管座等构成的内热阻,以及外接触热阻及散热片热阻等。总热阻应为各部分热阻串联之总和。晶体管中的实际情况远比上述分析复杂得多,这是因为,各部位并非均为严格的片状材料;热流方向不可能是一维的;电流在集电结非均匀分布,强迫冷却条件的变 化;这些因素都使得热阻的计算既复杂又粗略,故一般都通过实验来确定。热阻754.6 晶体管最大耗散功率PCM最大耗散功率晶体管的最大耗散功率PCM即当结温Tj达到最高允许结温TjM时所对应的耗散功率。TAjMCMTAjCRTTPRTTP当环境温度为T时:AjMjMCMCTTTTPTP )(764.6 晶体管最大耗散功率PCM最大耗散功率热阻CooDoPPPPPh 转换效
43、率:小结CAjTPTTRTAjMCMTAjCRTTPRTTPkAtRALALRPTTRIVVRTcAjT 21 对片状材料:对片状材料:热路中热路中电路中电路中最高结温:硅管150200,锗管85120。774.7 二次击穿和安全工作区l二次击穿现象l二次击穿特点及实验结果分析l二次击穿原因分析及改善措施l电流集中二次击穿l雪崩注入二次击穿l安全工作区784.7 二次击穿和安全工作区图4-21 二次击穿现象1.二次击穿现象l当晶体管集电结反偏增加到一定值时,发生雪崩击穿,电流急剧上升。当集电结反偏继续升高,电流Ic增大到某值后,cb结上压降突然降低而Ic却继续上升,即出现负阻效应(如图421)
44、,这种现象称为二次击穿。794.7 二次击穿和安全工作区图4-21 二次击穿现象lA点称为二次击穿触发点。该点所对应的电流及电压分别称为 二次击穿触发电流ISB与 二次击穿触发电压VSB。l晶体管在Ib0、Ib0、Ib0条件下均可发生二次击穿,分别称之为 基极正偏二次击穿、零偏二次击穿和 反偏二次击穿。1.二次击穿现象804.7 二次击穿和安全工作区图4-22 二次击穿临界线l将不同Ib下的触发点A连成曲线,得到二次击穿临界线(图4-22)。l从发生雪崩击穿并到达A点至发生二次击穿,这中间仅需ms-s数量级的时间间隔。这段时间称为二次击穿触发时间,记为td。l在td时间内,消耗在晶体管中的能量
45、 称为二次击穿触发能量。l显然,ESB(或二次击穿触发功率PSB)越大,发生二次击穿越困难,该晶体管抗二次击穿能力越强。因此,ESB也叫二次击穿耐量。dtSBIVdtE01.二次击穿现象814.7 二次击穿和安全工作区l分析整个二次击穿过程,大致可以分为如下四个阶段:(1)在击穿或转折电压下产生电流不稳定性;(2)从高电压区转至低电压区,即结上电压崩落,该击穿点的电阻急剧下降;(3)低压大电流范围:此时半导体处于高温下,击穿点附近的半导体是本征型的;(4)电流继续增大,击穿点熔化,造成永久性损坏。上述一系列过程仅仅发生在mss范围内。如果没有保护电路,晶体管很快被烧毁。1.二次击穿现象824.
46、7 二次击穿和安全工作区2.二次击穿的特点及实验结果分析l分析二次击穿现象,发现有如下显著持点:(1)从高压低电流区急剧地过渡到低压大电流区、呈现负阻特性。(2)发生二次击穿时,原先大体上均匀分布的电流会急剧地集中在发射区的某一部分l经过大量实验结果分析,发现二次击穿具有如下规律:(1)在Ib0、Ib0、Ib0时都可以发生二次击穿,且在不同基极偏置条件下,二次击穿触发功率(PSBISBVSB)间满足如下关系:PSBFPSB0PSBR 显然,Ib0时PSB最小,意味着其它条件相同时基极反偏时最易发生二次击穿。834.7 二次击穿和安全工作区 (2)二次击穿临界(触发)电流ISB与临界触发)电压V
47、SB不是相互独立的,而是满足关系式ISBVSB-m。其中m与晶体管种类及制作方法有关。一般说来,对于缓变结m1.5,而对于突变结m4(指集电结而言)(3)二次击穿触发功率与晶体管特征频率之间存在着一定的关系:式中,Kf为晶体管常数,mf为相关指数,其数值介于0.51之间。PSB不仅与fT有关,还与测量脉宽有关。在fT相同时,脉宽越窄,PSB越高。如图4-23所示。()fmTfSBfKP2.二次击穿的特点及实验结果分析844.7 二次击穿和安全工作区图4-23 PSB与fT测量脉宽的关系2.二次击穿的特点及实验结果分析854.7 二次击穿和安全工作区 (4)二次击穿触发能量与基极电阻及基区电阻率
48、有关。图424所示为某锗功率管的实验曲线。由图可见。基区电阻越大,PSB越低。图4-24 PSB与rb、b的关系(Ge晶体管)2.二次击穿的特点及实验结果分析864.7 二次击穿和安全工作区 (5)一般说来电流放大系数较大的晶体管其PSB较低。(6)在Ib0时,二次击穿触发能量还与外延层厚度有关。随着外延层厚度的增加 PSB也增大。同时发现,随着外延层厚度的减薄,环境温度TA对PSB的影响越来越小。如 图425所示。2.二次击穿的特点及实验结果分析874.7 二次击穿和安全工作区图4-25 PSB与外延层厚度及环境温度的关系2.二次击穿的特点及实验结果分析884.7 二次击穿和安全工作区 (7
49、)一般耗散功率PCM大的晶体管,集电结面积都较大,这使得杂质分布的不均匀性及缺陷数目均有所增加,致使PSB相对减小 (8)发生二次击穿时整个晶体管无明显的温升。2.二次击穿的特点及实验结果分析894.7 二次击穿和安全工作区l二次击穿的机理较为复杂,至今尚没有一个较为完整的理论对二次击穿做严格定量的分析解释,目前比较普遍的解释是电流集中二次击穿和雪崩注入二次击穿。3.二次击穿原因分析及改善措施(一)电流集中二次击穿这种击穿是由于晶体管内部出现电流局部集中,形成“过热点”,导致该处发生局部热击穿的结果。这一理论又称为热不稳定性理论。(二)(二)雪崩注入二次击穿雪崩注入二次击穿这是一种与外延层厚度
50、密切相关这是一种与外延层厚度密切相关的二次击穿。这种二次击穿是由的二次击穿。这种二次击穿是由集电结内的电场分布及雪崩倍增集电结内的电场分布及雪崩倍增区随区随I Ic c变化,倍增多子反向注入变化,倍增多子反向注入势垒区势垒区而引起的,故称为雪崩注而引起的,故称为雪崩注入二次击穿。入二次击穿。904.7 二次击穿和安全工作区一、电流集中二次击穿 (1.)机理分析 (2.)导致电流局部集中的原因 (3.)改善及预防措施3.二次击穿原因分析及改善措施914.7 二次击穿和安全工作区电流局部集中局部结温升高电流随结温指数增加局部达到本征温度形成过热点集电结耗尽层本征导电Vce下降,电流急剧上升熔点温度
51、,永久破坏二次击穿电流集中二次击穿一次热击穿3.二次击穿原因分析及改善措施924.7 二次击穿和安全工作区 Ib0时的二次击穿就属于此种。对Ib0时发生二次击穿后的管芯进行显微观察,发现基区内有微小的再结晶区。这是二次击穿时“过热点”温度超过了半导体的熔点产生局部熔化,冷却后再结晶所致。所以二次击穿后,晶体管往往发生c、e穿通。3.二次击穿原因分析及改善措施934.7 二次击穿和安全工作区(2.)导致电流局部集中的原因大电流下Ie的高度集边。原材料或工艺过程造成的缺陷和不均匀性。在缺陷处杂质扩散快,造成结不平坦、基区宽度Wb不均匀等。发射极条、基极条间由于光刻、制版等原因造成各部位尺寸不均匀而
52、引起的电位分配不均匀。总的IE在各小单元发射区上分配不均匀,边缘处散热能力强,中心处散热能力差,造成中心部位Tj较高,故二次击穿后熔融点多在中心部位。由于烧结不良形成空洞而造成的局部热阻过大,使该处结温升高,电流增大。晶体管的结面积越大,存在不均匀性的危险也越大,越易发生二次击穿。3.二次击穿原因分析及改善措施944.7 二次击穿和安全工作区主要目的是改善电流分配的不均匀性。可以考虑的措施有:(1)降低rb,以改善发射极电流集边效应的影响;(2)提高材料及工艺水平,尽可能消除不均勾性。在其它条件均相同时,采用单晶片做的功率晶体管较采用外延片做的器件的PSB大1-2倍,这是因为外延片缺陷较单晶片
53、多的缘故。(3)改善管芯与底座间的散热均匀性,消除由于接触不良而形成的“过热点”。(4)采用发射极镇流电阻。这是解决正偏二次击穿的一个有效方法。(3.)改善及预防措施3.二次击穿原因分析及改善措施954.7 二次击穿和安全工作区 发射极镇流电阻 对梳状结构电极,在每一单元发射极条上加串联电阻REi,(如图4-27)。如果由于热不稳定,在某一(3.)改善及预防措施点电流集中,该点所处单元电流的增加使得串联在该单元上的REi上的压降也随之增加,从而使真正作用在该单元发射结上的压降随之减小,进而使通过该单元的电流自动减小,避免了电流进一步增加而诱发的二次击穿。3.二次击穿原因分析及改善措施964.7
54、 二次击穿和安全工作区(3.)改善及预防措施发射极镇流电阻取值:当发射结结温变化为5K时,镇流电阻要能将发射极电流的变化限制在5%以内。3.二次击穿原因分析及改善措施 镇流电阻过大,本身消耗功率,增益(输出功率)下降;过小起不到镇流作用。974.7 二次击穿和安全工作区(3.)改善及预防措施3.二次击穿原因分析及改善措施采用镇流电阻的方式:984.7 二次击穿和安全工作区(3.)改善及预防措施3.二次击穿原因分析及改善措施994.7 二次击穿和安全工作区二、雪崩注入二次击穿 (1.)机理分析 (2.)击穿条件 (3.)雪崩注入二次击穿临界线 (4.)改善或消除措施这是一种与外延层厚度密切相关的
55、二次击穿。这种二次击穿是由集电结内的电场分布及雪崩倍增区随Ic变化,倍增多子反向注入势垒区而引起的,故称为雪崩注入二次击穿。(快速型二次击穿)VceBVceoJc=Jco=qvslNcVceBVceo;nNc空穴注入n-区3.二次击穿原因分析及改善措施1001014.7 二次击穿和安全工作区Vce增大,EEM一次雪崩击穿Jc,Jc=Jco=qvslNcn=Nc,电场均匀分布VceBVceo,nNc,最大场强转移到x=Wc处雪崩空穴流过n-区,中和电子Vce下降,电流急剧上升二次击穿雪崩注入二次击穿?电压作用产生电荷,电荷支持电场3.二次击穿原因分析及改善措施1024.7 二次击穿和安全工作区l
56、电流:Jc=Jco=qvslNc 或ISB=JcoAcl电压:VSB=EMWc二、雪崩注入二次击穿 (2.)击穿条件 (3.)雪崩注入二次击穿临界线 (4.)改善或消除措施 当x=0处达到EM时,发生雪崩使nNc,若没有VSB维持Wc内的EM,则不能维持雪崩(为强场下的有效基区扩展)。若VSB能使Wc内保持EM,则维持雪崩,并发生电场分布的转移。因此,这种击穿与外延层厚度Wc密切相关。为避免发生此种击穿,外延层厚度要选得足够厚。(按EM=105V/cm,VSBBVcbo计算Wc)3.二次击穿原因分析及改善措施1034.7 二次击穿和安全工作区二、雪崩注入二次击穿 (3.)雪崩注入二次击穿临界线
57、 (4.)改善或消除措施图4-32 电流集中二次击穿临界线3.二次击穿原因分析及改善措施图4-34 雪崩注入二次击穿临界线1044.7 二次击穿和安全工作区二、雪崩注入二次击穿 (3.)雪崩注入二次击穿临界线 (4.)改善或消除措施00bbISBISBII00bbISBISBVVIb0,基极电阻自偏压效应表现为发射极电流夹紧效应,减小了有效的Ac,由ISB=qvslNcAc 得ISB减小。且随Ib的增大而减小。Ibn2n1n2缓冲层减小n-n+处电场强度,又不使串联电阻增加太多n1控制BVcbo,n2控制Jc01114.7 二次击穿和安全工作区l安全工作区是指晶体管能够安全工作的范围。一般用S
58、OAR或SOA表示。4.安全工作区安全工作区区域I为功率耗散过荷区,在该区内工作时,晶体管主要是热破坏;区域是电流集中二次击穿区,在该区内工作的晶体管内部产生的“过热点”处熔化而造成c、e短路。区域为雪崩注入二次击穿区。区域为雪崩击穿区。区域V为电流过荷区。晶体管真正的安全工作区应该是五者限定的区域(因中阴影线部分)。显然,考虑二次击穿之后,晶体管的安全工作区变小了。1124.7 二次击穿和安全工作区 脉冲工作条件拓宽了晶体管的安全工作区,且随脉宽减小而扩大。脉冲信号的占空比越大,PSB越小,特别是占空比大于50时晶体管工作状态恶劣极易损坏。而占空比5时就不易损坏了。固定占空比时,脉冲宽度越窄
59、,PSB越大。而当脉宽 100s后,安全工作区已不再受二次击穿功率PSB的限制。当脉宽ls时,其测量结果与直流情况无异。4.安全工作区安全工作区1134.7 二次击穿和安全工作区图4-21 二次击穿现象1.二次击穿现象l当晶体管集电结反偏增加到一定值时,发生雪崩击穿,电流急剧上升。当集电结反偏继续升高,电流Ic增大到某值后,cb结上压降突然降低而Ic却继续上升,即出现负阻效应(如图421),这种现象称为二次击穿。小结l二次击穿触发点l二次击穿触发电流ISBl二次击穿触发电压VSB l基极正偏二次击穿l零偏二次击穿l反偏二次击穿l二次击穿临界线 l二次击穿触发时间l二次击穿触发能量l二次击穿耐量
60、四个阶段1144.7 二次击穿和安全工作区小结2.二次击穿的特点及实验结果分析3.二次击穿原因分析及改善措施(一)电流集中二次击穿这种击穿是由于晶体管内部出现电流局部集中,形成“过热点”,导致该处发生局部热击穿的结果。这一理论又称为热不稳定性理论。(二)雪崩注入二次击穿这是一种与外延层厚度密切相关的二次击穿。这种二次击穿是由集电结内的电场分布及雪崩倍增区随Ic变化,倍增多子反向注入势垒区而引起的,故称为雪崩注入二次击穿。1.二次击穿现象Ib0时,Ic较大,若不能雪崩击穿,则由于温度上升而发生电流集中二次击穿;Ib0时,Ic极小,则更容易发生雪崩注入二次击穿。1154.7 二次击穿和安全工作区2.二次击穿的特点及实验结果分析3.二次击穿原因分析及改善措施1.二次击穿现象4.安全工作区小结116本章小结1 P-N结2 直流特性3 频率特性4 功率特性5 开关特性(6,7结型和绝缘栅场效应晶体管)8 噪声特性大电流(大注入)高电压(击穿)大功率4.1 集电极最大允许工作电流ICM4.2 基区大注入效应对电流放大系数的影响4.3 有效基区扩展效应4.4 发射极电流集边效应4.5 发射极单位周长电流容量-线电流密度4.6 晶体管最大耗散功率PCM4.7二次击穿和安全工作区
- 温馨提示:
1: 本站所有资源如无特殊说明,都需要本地电脑安装OFFICE2007和PDF阅读器。图纸软件为CAD,CAXA,PROE,UG,SolidWorks等.压缩文件请下载最新的WinRAR软件解压。
2: 本站的文档不包含任何第三方提供的附件图纸等,如果需要附件,请联系上传者。文件的所有权益归上传用户所有。
3.本站RAR压缩包中若带图纸,网页内容里面会有图纸预览,若没有图纸预览就没有图纸。
4. 未经权益所有人同意不得将文件中的内容挪作商业或盈利用途。
5. 装配图网仅提供信息存储空间,仅对用户上传内容的表现方式做保护处理,对用户上传分享的文档内容本身不做任何修改或编辑,并不能对任何下载内容负责。
6. 下载文件中如有侵权或不适当内容,请与我们联系,我们立即纠正。
7. 本站不保证下载资源的准确性、安全性和完整性, 同时也不承担用户因使用这些下载资源对自己和他人造成任何形式的伤害或损失。
