 中束流离子注入机
中束流离子注入机
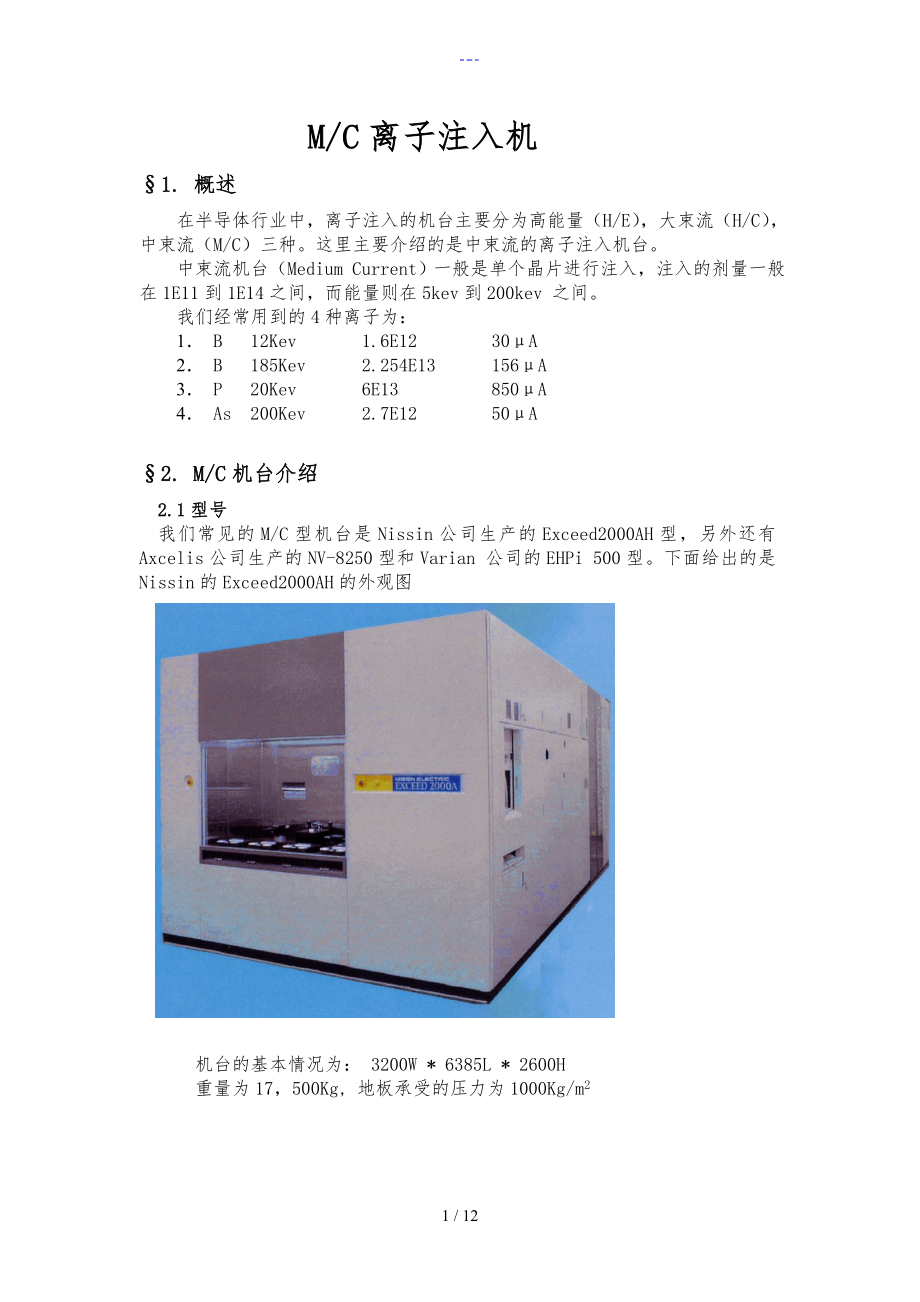


《中束流离子注入机》由会员分享,可在线阅读,更多相关《中束流离子注入机(12页珍藏版)》请在装配图网上搜索。
1、 M/C离子注入机1. 概述在半导体行业中,离子注入的机台主要分为高能量(H/E),大束流(H/C),中束流(M/C)三种。这里主要介绍的是中束流的离子注入机台。中束流机台(Medium Current)一般是单个晶片进行注入,注入的剂量一般在1E11到1E14之间,而能量则在5kev到200kev 之间。我们经常用到的4种离子为:1 B 12Kev 1.6E12 30A2 B 185Kev 2.254E13 156A3 P 20Kev 6E13 850A4 As 200Kev 2.7E12 50A2. M/C机台介绍2.1型号我们常见的M/C型机台是Nissin公司生产的Exceed2000
2、AH型,另外还有Axcelis公司生产的NV-8250型和Varian 公司的EHPi 500型。下面给出的是Nissin的Exceed2000AH的外观图机台的基本情况为: 3200W * 6385L * 2600H 重量为17,500Kg, 地板承受的压力为1000Kg/m2其中,控制面板如图所示。2.2工作原理 离子植入的基本原理就是把气体或固体源的原子离子化,然后对离子进行选择,把所需的离子进行加速,达到所需的能量,注入到硅片中的过程。下面就是整个机台的俯视图,主要分为End Station, Beam Line, Ion Source三个大的部分。2.3主要部件2.3.1 离子源(I
3、on Source)。因为我们要注入的杂质是有一定的能量的,所以必须对杂质进行加减速,而只有带电微粒才能在电场的作用下加减速,因此要使杂质离子化。离子源就是用电子撞击气体分子,得到我们所需要的离子的部件。离子源包括Arc chamber 和 Extraction electrode 系统。1 Arc chamber.Arc chamber 是利用灯丝加热,放出电子,然后电子撞击通入的气体分子,得到离子。通常在chamber上安装磁铁,使电子在磁场中螺旋运动,增加运行轨迹,使电子撞击的机率增大。下图是Arc chamber 的结构示意图:图中的Reflector上有负的电位,这样就不会吸收电子,
4、减少电子到达的机会,就能够因碰撞而产生更多的离子。2 Extraction electrode 离子产生以后,我们必须把它从Arc chamber 中吸取出来,因此在Arc chamber上加40kv的正电压,Extraction electrode 系统的另一端接地,这样正离子就从Arc chamber 的窗口中被吸出来,获得40kv的能量。离子撞在接地的electrode上,会产生电子,在电场的作用下撞击Arc chamber,会损坏Arc chamber和产生X-ray,为防止这种现象,我们在chamber 和接地的electrode之间加上一个-2kv的suppression elec
5、trode,来收集电子。 Extraction electrode 的结构如图所示:因此,Arc chamber, Suppression electrode 和 Grounded electrode各处的电势可以用下图进行表示。2.3.2 法拉第系统 (faraday cup system)上图是几种法拉第系统的外观图。在M/C的机台中,法拉第系统是比较多的,常用到的有FEM法拉第,Dose法拉第,Front法拉第和Back法拉第。法拉第系统中用一个Faraday Cup用来接收离子束,然后用导线接地,接收到一个离子,就会有一个电子来中和,我们测出流过的电子数,就可以知道离子数。在Farad
6、ay Cup上要加磁场,是离子束中的电子不能进入Faraday Cup, 而离子撞击Faraday cup产生的电子又出不去,这样就保证了测量的准确性。2.3.3磁场分析因为从Arc chamber 里吸取出来的离子并不都是我们想要的,所以我们就利用磁场来做分析.带电离子在磁场中会受到力的作用发生偏转,不同的荷质比,偏转的角度就回不一样. R = (2mE)/qB = (2mV/q)/B质量 m; 电荷 q; 能量 E; 吸取电压 V; 磁场强度 B.其中m/q 的不同,离子在磁场中的偏转半径不同. M/q 大的离子半径大, 在同样的磁场中偏转的角度不够,m/q 小的离子偏转半径小,偏转角度过
7、大,我们调节磁场的大小,就可以使只有我们所需要的离子才能通过磁场,这样就不会对硅片造成污染.与其他两种机台不同的是中束流机台在加速前后都有磁场分析,分别称为SAM和FEM,即离子源分析磁场(Source Analyzer Magnet)和能量分析(Final Energy Magnet)这样,即使因误差很小,在SAM没有被分离出来的杂质,经过加速后,误差被放大,在FEM处也会被分离出来,不会造成污染。2.3.4MASS SPECTRUM AND MASS RESOLUTIONCalculation of mass resolution: m/dm = BP/2(BH BL)Ip 31P+ Ip
8、31P+Ip/2 Ip/2 31P2+ 31P+BL BP BH在离子束通过磁场的时候,进行测量分析,我们通常使用质谱法。r = (2MV/q)1/2/B所以, B = (2MV/q)1/2/r如果我们得到BP = 4100BL = 4086BH = 4106则 m/dm = 4100/2(4106 4086) = 102.52.3.5 聚焦 (Focus)我们得到的离子束是带正电的,由于电荷间相互力的作用,会使得离子束到最后越来越发散,不能正常的注入,所以我们必须进行聚焦。1. 磁场聚焦在一般的机台中磁场只起到分析的作用,但在M/C机台中对磁场进行调整,以起到聚焦的作用。离子束经过磁场的时候
9、,受到磁场力的作用,会发生偏转,我们适当改变磁场的形状,就会是从磁场出来的离子束既达到选择,又达到聚焦的效果。如图,由于磁场两极不平行,离子束会受力向中间聚拢,达到聚焦的效果。2. 加速电场聚焦。除了经过磁场的时候会聚焦以外,离子束在加速电场里也会聚焦。上图是加速管的外观图,在加速管中,离子束受到电场力的作用,具体受力情况如下,DivergingFocusing如图,在离子束被加速的过程中,由于受到电场力的作用,离子在被加速的同时,还受到压缩力的作用,即加速电场也有聚焦的作用。2.3.6 加速/减速装置因为离子经过Extraction electrode 所获得的能量并不一定就是我们最后所需要
10、的能量,还应该经过加速或减速装置来增加或减少能量。离子带正电,由电势高的地方出发,到达电势低的地方,就会速度增加,能量上升,反之亦然。M/C注入的能量一般在5-200KeV左右。加速装置是由几组电极组成,电位从高到低,离子束经过,在电场力的作用下被加速,使离子获得我们所需要的能量。减速装置的情况刚好相反。由于我们所需要的能量一般都是很高的,所以只能用几组电极分几段来加速,这样使离子束不断变快。由此,我们可以得到离子束在整个过程中能量的变化情况。,用下面的示意图来表示。E (kev) 120 80 40Source Extraction Accel2.3.7 扫描系统在前面的系统中,我们都称为离
11、子束,但是我们希望打到硅片上的是一条线,可以减少硅片的机械运动,因此,需要用一个扫描系统 Negative pole+Positive pole如图采用电扫描,在上下两快极板上接电压,离子受到电场的作用发生偏转,我们可以改变极板上的电性,使得离子可以偏向不同的角度,以达到扫描的效果。2.3.8 准直器在离子经过扫描系统后,由于机台设计的原因,离子束并不是正对着晶片,我们要用一个装置改变离子束的方向,类似与光学里的棱镜一样,我们用一个磁场来实现。2.3.9 PFG 系统。Xe+Wafer e-e-Ion beamReflector -5V上图是PFG系统的简单示意图。我们从磁场分析后的离子主要是
12、带正电的离子,由于电荷的排斥力,离子束会越来越发散,不能满足要求,所以就要用到PFG。PFG(Plasma Flood Gun) 是利用灯丝发出电子,撞击充入的Xe, 形成Plamsa,用-5V的电压将电子吸出,加入到Beam里面,使得离子束不会发散。PFG的另一个作用是发出的电子随离子束达到晶片表面后,与离子所带的电荷发生中和,使得晶片表面呈现电中性。2.3.10 End StationM/C机台一般是单晶片注入,所以没有其他机台所需的Disk, 由Transfer Robots 将晶片从Wafer Cassette 里传到Target Chamber, 晶片在Target Chamber被
13、固定,偏转,完成最后的注入。2.3.11 Dose 控制我们在离子注入的时候,需要控制Dose 量,而现在只能通过Dose法拉第先测出离子束的大小,然后根据需要注入的量来算出注入的时间。而M/C注入机可以用Front 法拉第和Back法拉第来测出某一时刻离子打在晶片的什么地方。如图是前后两个法拉第的示意图。我们可以用数学的方法来计算, Xb XwXf Front Wafer Back Zf Zb由图,我们可以得出以下结论: tan = (Xb Xf)/ (Zb Zf)这样就可以得到此时离子注入在晶片的什么位置。3 总述离子注入是半导体工艺里很重要的一环,同时,由于机台内部很多地方是高压,而且有很毒的气体和强的磁场,另外还有X射线的辐射,所以要求我们在操作的时候,要严格按照操作规X,保护好自己的人身安全。晶片在经过离子注入以后,需要进行快速热退火处理。12 / 12
- 温馨提示:
1: 本站所有资源如无特殊说明,都需要本地电脑安装OFFICE2007和PDF阅读器。图纸软件为CAD,CAXA,PROE,UG,SolidWorks等.压缩文件请下载最新的WinRAR软件解压。
2: 本站的文档不包含任何第三方提供的附件图纸等,如果需要附件,请联系上传者。文件的所有权益归上传用户所有。
3.本站RAR压缩包中若带图纸,网页内容里面会有图纸预览,若没有图纸预览就没有图纸。
4. 未经权益所有人同意不得将文件中的内容挪作商业或盈利用途。
5. 装配图网仅提供信息存储空间,仅对用户上传内容的表现方式做保护处理,对用户上传分享的文档内容本身不做任何修改或编辑,并不能对任何下载内容负责。
6. 下载文件中如有侵权或不适当内容,请与我们联系,我们立即纠正。
7. 本站不保证下载资源的准确性、安全性和完整性, 同时也不承担用户因使用这些下载资源对自己和他人造成任何形式的伤害或损失。
