 第3章-热氧化ppt课件
第3章-热氧化ppt课件
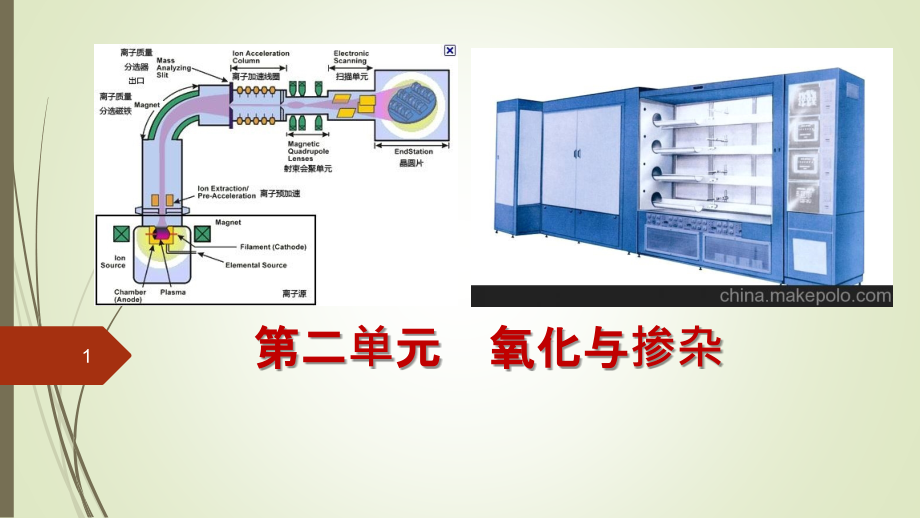


《第3章-热氧化ppt课件》由会员分享,可在线阅读,更多相关《第3章-热氧化ppt课件(46页珍藏版)》请在装配图网上搜索。
1、第二第二单元元氧化与氧化与掺杂1第二单元氧化与掺杂1第第3章章热氧化氧化3.1二氧化硅薄膜二氧化硅薄膜概述概述3.2 硅的硅的热氧化氧化3.3 初始氧化初始氧化阶段及薄氧化段及薄氧化层制制备3.4 热氧化氧化过程中程中杂质再分布再分布3.5 氧化氧化层的的质量及量及检测3.6 热氧化技氧化技术及其工及其工艺展望展望2第3章热氧化3.1二氧化硅薄膜概述23.1 3.1 二氧化硅二氧化硅薄膜概述薄膜概述33.1.1 二氧化硅二氧化硅结构构石英石英非晶非晶SiO2桥联氧非桥联氧3.1二氧化硅薄膜概述33.1.1二氧化硅结构石英非晶S硅表面硅表面热氧化氧化层TEM照片照片4SiSiO2硅表面热氧化层T
2、EM照片4SiSiO23.1.2 二氧化硅的性二氧化硅的性质及用途及用途5性性质石英晶体石英晶体非晶非晶SiO2薄膜薄膜注注密度(g/cm3)2.222.2致密程度的标志。密度大表示致密程度高熔点()17321500软化软化点与致密度、掺杂有关电阻率(cm)10161071015工艺温度越高电阻率越大介电常数3.93.9介电强度(V/m)10001001000与致密度折射率1.331.37腐蚀性与HF酸、强碱反应缓慢与致密度、掺杂有关二氧化硅主要性二氧化硅主要性质3.1.2二氧化硅的性质及用途5性质石英晶体非晶SiO2薄二氧化硅薄膜的二氧化硅薄膜的用途用途6掺杂掩蔽膜芯片的钝化与保护膜SiO2
3、电隔离膜元器件的组成部分二氧化硅薄膜的用途6掺杂掩蔽膜芯片的钝化与保护膜SiO2电隔3.1.3 二氧化硅薄膜中的二氧化硅薄膜中的杂质7Na2O+SiOSi2Na+SiO+OSiH2O+SiOSiSiOH+HOSiP2O5+SiOSiP+OP+2OSi磷硅玻璃(PSG)3.1.3二氧化硅薄膜中的杂质7Na2O+SiOS3.1.4 杂质在在SiO2中的中的扩散散指指单位位浓度的度的杂质,在,在单位位时间内内扩散通散通过单位面位面积的量的量 它的它的单位是位是m2/s钠离子等碱金属离子,即使在很离子等碱金属离子,即使在很低温度下,也能迅速低温度下,也能迅速扩散到整个散到整个SiO2层中。中。83.1
4、.4杂质在SiO2中的扩散指单位浓度的杂质,在单位时3.1.5 SiO2的掩蔽作用的掩蔽作用9硅表面的氧化层作为掩膜时:掩蔽条件:DSiDSiO2氧化层的最小厚度:XjXSiO2CsCI3.1.5SiO2的掩蔽作用9硅表面的氧化层作为掩膜时:掩3.2 硅的硅的热氧化氧化103.2.1 热氧化工氧化工艺卧式氧化炉立式氧化炉氧化示意图3.2硅的热氧化103.2.1热氧化工艺卧式氧化炉立式氧1、三种、三种热氧化工氧化工艺方法方法干氧氧化干氧氧化:Si+O2 SiO2氧化氧化层结构致密构致密,掩蔽能力,掩蔽能力强,表面干燥是表面干燥是SiO结构,适合光刻;但是,构,适合光刻;但是,生生长速率慢,速率慢
5、,不适合生不适合生长厚氧化厚氧化层水汽氧化水汽氧化:Si+(H2+O2)SiO2+H2氧化氧化层致密度致密度较低,低,结构疏松,表面是构疏松,表面是SiOH结构,易吸附水,光刻困构,易吸附水,光刻困难;但是,生但是,生长速率快,更适合生速率快,更适合生长厚氧化厚氧化层湿氧氧化湿氧氧化:Si+H2O(O2)SiO2+H2O氧化氧化层的生的生长速率和速率和质量介于干氧和水汽两种方式之量介于干氧和水汽两种方式之间。111、三种热氧化工艺方法干氧氧化:Si+O2SiO21三种三种热氧化方法的氧化方法的比比较12氧化氧化方式方式氧化氧化温度温度()生生长速率常速率常数数(m2/min)生生长0.5mSi
6、O2所所需需时间(min)SiO2的密的密度度(g/mm)介介电强度度(106V/cm)注注干氧干氧10001.4810418002.15912006.21043602.27湿氧湿氧100038.5104632.12水浴温度水浴温度951200117.5104222.21水汽水汽100043.5104582.056.89水汽水汽发生生器水温器水温1021200133104182.08三种热氧化方法的比较12氧化方式氧化生长速率常数生长0.52、工、工艺的的应用用掩膜氧化(厚氧化掩膜氧化(厚氧化层)干氧干氧湿氧湿氧干氧干氧薄薄层氧化(氧化(MOS栅氧化氧化层)干氧干氧 掺氯氧化氧化13SiSiO
7、22、工艺的应用掩膜氧化(厚氧化层)13SiSiO23、工、工艺举例例工工艺条件条件:3吋硅片,干氧吋硅片,干氧10min湿氧湿氧50min(水温(水温98)干氧干氧15min,温度:,温度:1180,氧气流量:,氧气流量:1L/min工工艺流程流程:洗片洗片升温升温生生长取片取片洗片:洗片:湿法清洗干湿法清洗干净、烘干烘干备用用升温:升温:设定氧化炉的工定氧化炉的工艺条件,硅片装炉,开机升温条件,硅片装炉,开机升温生生长:设定氧定氧化炉自化炉自动进行干氧湿氧切行干氧湿氧切换,完成氧化,完成氧化层生生长取片:取片:将氧化好的硅片取出,将氧化好的硅片取出,停停气、停气、停炉。炉。14制制备约0.
8、6m氧化氧化层作作为扩散散掺杂掩膜掩膜3、工艺举例工艺条件:14制备约0.6m氧化层作为扩散掺杂3.2.2 热氧化机理氧化机理硅常温下暴露在空气中的表面硅常温下暴露在空气中的表面:Si+O2 SiO2Si+H2O(O2)SiO2+H2O表面的氧化膜逐表面的氧化膜逐渐增厚到增厚到40左右就停止左右就停止了了高温下,氧化膜高温下,氧化膜继续增增厚厚153.2.2热氧化机理硅常温下暴露在空气中的表面:153.2.2 热氧化机理氧化机理16SiSiSiO2氧化氧化 dSidSiO2生生长1m厚二氧化硅厚二氧化硅约消耗消耗0.44m厚的硅厚的硅Si桥联O非桥联O3.2.2热氧化机理16SiSiSiO2氧
9、化dSidSiSiSiO2附面层3.2.3 DealGrove热氧化模型氧化模型O2或 H2O气流方向(1)氧化)氧化剂输运运(2)固相)固相扩散散(3)化学反)化学反应(4)反反应副副产物物离开界面离开界面 DG模型将模型将热氧化氧化简化化为:17SiO2附面层3.2.3DealGrove热氧化模型O2热氧化是在氧气氛下氧化是在氧气氛下进行,氧气流密度不行,氧气流密度不变,即准平衡即准平衡态稳定生定生长:一一维DG数学模型数学模型pgp0F1F2F3SiO2Si0 xCgCsCoCi主流气体粘滞层O2(H2O)x0(1)氧化)氧化剂输运运(2)固相固相扩散散(3)化学反)化学反应18F1=F
10、2=F3热氧化是在氧气氛下进行,氧气流密度不变,即准平衡态稳定生长:求解求解:c0、ci借助借助亨利定律亨利定律:由主气流区氧气分由主气流区氧气分压Pg,同理,同理可得氧化可得氧化层中氧气的平衡中氧气的平衡浓度度C*:气相气相质量量输运系数运系数 由由F1=F2=F3可得:可得:19pgp0F1F2F3SiO2Si0 xCoCi主流气体粘滞层O2(H2O)x0求解:c0、ci借助亨利定律:由主气流区氧气分压Pg,同理3.2.4 热氧化生氧化生长速率速率20 生生长一个一个SiO2,需要一个,需要一个O2水汽氧化:水汽氧化:Si+2H2O SiO2+2H2由:由:Si+O2 SiO2 生生长一一
11、个个SiO2,需要,需要二二个个H2O分子分子,N1=NSiO2=2.21022 分子分子/cm3N1=2NSiO23.2.4热氧化生长速率20生长一个SiO2,需要一个21(1)氧化)氧化时间很短(很短(t0),氧化速率方程氧化速率方程 线性性规律律 为线性速率常数性速率常数(2)氧化)氧化时间很很长(t),),抛物抛物线规律律B 为抛物抛物线速率常数速率常数ks 0SiO2SiC0CxD 0Ci扩散控制散控制化学反化学反应控制控制21(1)氧化时间很短(t0),氧化速率方程线在在两种极限情况下两种极限情况下:氧化氧化时间很很短短长或或时间很很长时,实测值和和计算算值吻合。吻合。实测值与模与
12、模拟计算算值的的对比比22(1 1)线性性氧化氧化速率:速率:氧化氧化速率方程:速率方程:(2 2)抛物线抛物线氧氧化化速率:速率:在两种极限情况下:氧化时间很短长或时间很长时,实测值和3.2.5 影响氧化速率的各种因素影响氧化速率的各种因素氧化速率比氧化速率比较:O2 O2(H2O)H2OO2、H2O在氧化在氧化层中的中的扩散散和和与硅的与硅的反反应均均较快快,而而且且O2略快于略快于H2O。溶解度相差很大:溶解度相差很大:c*O2 c*H2O231、氧化、氧化剂种种类对氧化氧化速率的影响速率的影响氧化氧化剂种种类、温度、温度、氧化氧化剂分分压、衬底晶向与底晶向与掺杂浓度度等因素都等因素都对
13、氧氧化速率有影响。化速率有影响。3.2.5影响氧化速率的各种因素氧化速率比较:O2O2、温度温度对氧化速率的影响氧化速率的影响ks、DSiO2、h等都等都与温度与温度有关有关24温度温度对氧化速率的影响氧化速率的影响很很大大2、温度对氧化速率的影响ks、DSiO2、h等都与温度有关23、氧化、氧化剂分分压对氧化速率的影响氧化速率的影响提高提高反反应器内氧气或水汽的分器内氧气或水汽的分压能提高能提高线性氧化速性氧化速率率有有高高压氧化和低氧化和低压氧化技氧化技术对线性氧化速率的影响更些大性氧化速率的影响更些大氧化氧化剂分分压Pg是通是通过C*对B产生生影响:影响:BPP253、氧化剂分压对氧化速
14、率的影响提高反应器内氧气或水汽的分压能4、硅片晶、硅片晶向向对氧化速率的影响氧化速率的影响 不同晶向的不同晶向的单晶硅由于表面原子密度晶硅由于表面原子密度不同,氧化速率也呈不同,氧化速率也呈现各向异性。各向异性。B/A依依赖晶向,而晶向,而B与晶向无关。与晶向无关。(111)晶向速率最快,()晶向速率最快,(100)晶向)晶向速率最慢。速率最慢。有空有空间位位阻阻(Steric Hindrance)现象:指氧化象:指氧化剂分子近分子近邻之之间遮蔽遮蔽作用作用和其它一些几何影响和其它一些几何影响264、硅片晶向对氧化速率的影响不同晶向的单晶硅由于表面原子密5、杂质对氧化速率的影响氧化速率的影响氧
15、化速率氧化速率对存在存在于于掺杂剂中的中的钠、氯化物化物、水汽水汽,以及在硅片中的,以及在硅片中的、族族杂质敏感敏感通常氧化通常氧化剂中有微量的中有微量的杂质存在就会明存在就会明显地提高氧化速率地提高氧化速率掺杂浓度越高氧化速率越快,度越高氧化速率越快,这种种现象称象称为增增强氧化氧化27氧化5、杂质对氧化速率的影响氧化速率对存在于掺杂剂中的钠、氯化3.3 初始氧化初始氧化阶段及薄氧化段及薄氧化层制制备DG模型模型对30nm以下以下的薄的薄层氧化氧化规律描述不准律描述不准。自然氧化物不是自然氧化物不是连续生生长而是而是阶段的生段的生长。轻掺杂0.8nm;重重掺杂1.3nm。初始氧化初始氧化阶段
16、的氧化机制段的氧化机制仍是仍是研究研究热点。点。700干氧氧化干氧氧化283.3初始氧化阶段及薄氧化层制备DG模型对30nm以下的MOS电路路对栅氧化氧化层的要求的要求低低缺陷缺陷密度密度好的抗好的抗杂质扩散的散的势垒持持性性低的界面低的界面态密度和固定密度和固定电荷荷,高高质量的量的SiO2/Si界面界面在在热载流子流子应力和力和辐射条件下射条件下的的稳定性定性好。好。栅氧化氧化层29MOS电路对栅氧化层的要求低缺陷密度栅氧化层29薄氧化薄氧化层制制备工工艺方法:方法:干氧氧化干氧氧化、或、或掺氯氧化氧化减减压氧化氧化低温高低温高压氧化等。氧化等。工工艺条件条件:生生长速率必速率必须足足够慢
17、;慢;氧化前的清洗必氧化前的清洗必须彻底;底;所用水、所用水、试剂、气体等必、气体等必须为超高超高纯度材料。度材料。30薄氧化层制备工艺方法:303.4 3.4 热氧化氧化过程中程中杂质的再分布的再分布杂质的分凝的分凝现象;象;杂质从从SiO2表面逸出;表面逸出;杂质在在SiO2、Si中的中的扩散速率;散速率;杂质在在SiO2/Si界面界面的的移移动速率。速率。逸出分凝扩散界面移动31再分布情况由四方面因素决定:再分布情况由四方面因素决定:3.4热氧化过程中杂质的再分布杂质的分凝现象;逸出分凝扩散3.4.1 杂质的分凝效的分凝效应分凝效分凝效应:指指杂质在两个在两个紧密接触的不同相中,密接触的
18、不同相中,由于溶解度不同,将在两相之由于溶解度不同,将在两相之间发生重新分配,生重新分配,直到两相界面两直到两相界面两边的化学的化学势相等相等为止的止的现象。象。分凝系数:分凝系数:是是衡量衡量分凝效分凝效应强弱的弱的参数参数硅片硅片热氧化氧化时,某,某杂质的分凝系数的分凝系数为:分凝系数与温度有关分凝系数与温度有关分凝系数分凝系数与与与与晶面取向晶面取向有关有关323.4.1杂质的分凝效应分凝效应:指杂质在两个紧密接触的不杂质在在SiO2/Si界面分布界面分布(a)图,杂质Kl,在,在SiO2中中是慢是慢扩散散杂质,如硼;如硼;(b)图,杂质K1,在,在SiO2中是快中是快扩散散杂质,如在如
19、在氢气气氛下氛下的硼;的硼;(c)图,杂质K1,在,在SiO2中慢中慢扩散的散的杂质,如磷如磷(d)图,杂质Kl,在,在SiO2中中是快是快扩散散杂质,如如镓;33分凝扩散逸出分凝扩散逸出分凝扩散逸出分凝扩散逸出杂质在SiO2/Si界面分布(a)图,杂质Kl,在SiO23.4.2 再分布再分布对硅表面硅表面杂质浓度的影响度的影响氧化速率与氧化速率与扩散速率之比散速率之比是是影响硅表面影响硅表面杂质浓度的度的主因,主因,这一一比比值可可通通过改改变热氧化工氧化工艺方法、条件方法、条件而而变化。化。343.4.2再分布对硅表面杂质浓度的影响氧化速率与扩散速率之再分布再分布对硅中硅中杂质浓度分布的影
20、响度分布的影响温度越高,硼温度越高,硼杂质发生再分布生再分布进入硅内的距离越深入硅内的距离越深氧化后高斯分布氧化后高斯分布杂质,最高,最高浓度的位置已度的位置已经不在硅的表面不在硅的表面35再分布对硅中杂质浓度分布的影响温度越高,硼杂质发生再分布进入3.5 氧化氧化层的的质量及量及检测热氧化氧化在在硅表面生硅表面生长氧化氧化层的的质量量及及性能性能指指标应满足使用要求,需要在氧化后足使用要求,需要在氧化后进行行检测氧化氧化层厚度厚度测量量比色法、比色法、干涉条干涉条纹法;法;椭偏法、台偏法、台阶仪成膜成膜质量量检测表面缺陷,表面缺陷,结构缺陷,氧化构缺陷,氧化层中的中的电荷,荷,热应力力36椭
21、偏偏仪台台阶仪3.5氧化层的质量及检测热氧化在硅表面生长氧化层的质量37在可在可见光波段氧化光波段氧化层透透明,而硅明,而硅为灰色,硅片灰色,硅片表面表面反射反射的的光光和穿透氧和穿透氧化化层在硅在硅界面反射界面反射光相光相互互干涉干涉,又因又因氧化氧化层厚厚度不同,光程就不同,度不同,光程就不同,某一波某一波长的光干涉增的光干涉增强,这就使得硅片就使得硅片呈呈现不同不同的的色色彩。彩。3.5.1 氧化氧化层厚度厚度测量量颜色色氧氧 化化 层 厚厚 度度(埃)(埃)第第 一一 周周 期期 第第 二二 周周 期期 第第 三三 周周 期期 第第 四四 周周 期期灰灰 色色100黄黄 褐褐 色色30
22、0棕棕 色色500蓝 色色800紫紫 色色1000275046506500深深 蓝 色色1500300049006800绿 色色1850330052007200黄黄 色色2100370056007500橙橙 色色225040006000红 色色2500435062501、比色法、比色法在在白光白光直视直视下下氧化氧化层层厚度与干涉色彩的关系厚度与干涉色彩的关系比色样片37在可见光波段氧化层透明,而硅为灰色,硅片表面反射的光和穿2、干涉条、干涉条纹法法从一从一个亮条个亮条到相到相邻的亮条就是一的亮条就是一个个干涉条干涉条纹。而。而从暗条从暗条到到相相邻亮条亮条则是是0.5个干涉条个干涉条纹。n二
23、氧化硅的折射率38斜面X干条纹的条数X=3,n=1.5,=530nm d=530nm2、干涉条纹法从一个亮条到相邻的亮条就是一个干涉条纹。而从暗3.5.2 氧化氧化层成成膜膜质量的量的测量量表面表面镜检:有无斑点有无斑点,裂,裂纹,白,白雾,发花和花和针孔等孔等毛病毛病针孔密度孔密度测量量:化学腐化学腐蚀法;法;电解解镀铜法等。法等。1、表面缺陷、表面缺陷39通孔盲孔产生原因生原因:硅片表面抛光不硅片表面抛光不够好、有好、有严重的位重的位错或表面或表面有沾有沾污3.5.2氧化层成膜质量的测量表面镜检:有无斑点,裂纹,白2、结构缺陷构缺陷主要是氧主要是氧化化诱生生层错(Oxidation Ind
24、uced Stacking Faults,CSF):界:界面面未氧化的硅未氧化的硅进入硅体内的填隙位置入硅体内的填隙位置,结团形成堆形成堆垛层错。检测方法方法:用稀用稀HF泡掉氧化泡掉氧化层,然后用,然后用Sirtl等腐等腐蚀液腐液腐蚀硅,再用硅,再用显微微镜进行行检测。402、结构缺陷主要是氧化诱生层错(OxidationIndu3、氧化、氧化层中的中的电荷荷可可动离子离子电荷荷:Na+、K+、H+等荷正等荷正电的碱金属离子的碱金属离子氧化氧化层固定固定电荷荷:位于氧化:位于氧化层距硅界距硅界面面3nm范范围内,荷正内,荷正电的氧空位的氧空位界面陷阱界面陷阱电荷荷:能量:能量处于硅禁于硅禁带
25、中,中,可与价可与价带或或导带交交换电荷的陷阱能荷的陷阱能级或或电荷状荷状态氧化氧化层陷阱陷阱电荷荷:由氧化:由氧化层内的内的杂质或不或不饱和和键俘俘获电子或空穴所引起子或空穴所引起413、氧化层中的电荷可动离子电荷:Na+、K+、H+等荷正3、氧化、氧化层中的中的电荷荷测量方法:量方法:通通过MOS结构高构高频C-V特性特性测量及量及偏温偏温实验,可得氧化可得氧化层电荷面密度和可荷面密度和可动电荷面密度荷面密度避免或降低避免或降低电荷面密度的方法:荷面密度的方法:加加强工工艺卫生生;采用超高采用超高纯度的水、气体与度的水、气体与试剂等;等;采用采用掺氯干氧氧化工干氧氧化工艺;热氧化后在高温惰
26、性气体中氧化后在高温惰性气体中进行退火。行退火。42PSiSiO2AlMOS结构+反型层3、氧化层中的电荷测量方法:42PSiSiO2AlMOS结4、热应力力 SiO2与与Si的的热膨膨胀系数系数不同:不同:Si:2.6106 K1,SiO2:5107 K1 在在结束束热氧化,退出氧化,退出高温高温过程后程后,两,两者界面会者界面会产生很大的生很大的热应力力热氧化氧化时,加,加热或冷却或冷却过程中要使硅程中要使硅片受片受热均匀,同均匀,同时,升温和降温速率,升温和降温速率不能太大。不能太大。43氧化氧化层受受压应力力,严重重时,氧化,氧化层会会产生生皲裂,裂,硅片硅片发生弯曲生弯曲,并并在界在
27、界面面产生缺陷生缺陷。4、热应力SiO2与Si的热膨胀系数不同:43氧化层受压3.6 其它其它热氧化方法氧化方法在氧化气氛中加入一定量的含在氧化气氛中加入一定量的含氯物物质,如,如HCl、C2HCl3(TCE)等,等,氯进入氧化入氧化层。可以可以改善氧化改善氧化层和和 SiO2/Si界面的性界面的性质:能能降低固定降低固定正正电荷密度和界面荷密度和界面态密度密度钝化可化可动离子,尤其是离子,尤其是钠离子离子减少减少SiO2中缺陷,提高了氧化中缺陷,提高了氧化层的抗的抗电击穿穿能力能力减少减少氧化氧化导致致的硅的的硅的层错,增加了氧化,增加了氧化层下面硅下面硅中少数中少数载流子的寿命流子的寿命。
28、3.6.1 掺氯氧化氧化ClClClClNa+Na+Na+4HCl+O24Cl2+H2OSiCl,SiOCl443.6其它热氧化方法在氧化气氛中加入一定量的含氯物质,如H3.6.2 高高压氧化氧化 氧化氧化剂的的压力在几个到几百个大气力在几个到几百个大气压之之间的的热氧化称氧化称高高压氧化。氧化。高高压氧化氧化温度多在温度多在650950之之间。也有。也有高高压干氧氧化干氧氧化和和高高压水汽氧化水汽氧化。主要特点主要特点:是一种低温是一种低温快速快速热氧氧化化方法方法减少减少了了氧化氧化层错杂质再分布和分凝效再分布和分凝效应减小减小45耐压容器式高压氧化设备结构图3.6.2高压氧化氧化剂的压力在几个到几百个大气压之间的3.6.3 热氧化氧化工工艺展望展望热氧化工氧化工艺的的发展展方向方向:主要主要集中在如何制造集中在如何制造电学性能学性能优良良,且且足足够薄的薄的栅氧化氧化层,而而对栅氧化氧化层的主要的主要要求要求:具有具有高高介介电常数常数;较低低氧化氧化层电荷荷;较高高击穿穿电压等特性等特性。氧化氧化工工艺发展:展:进一步降低工一步降低工艺温度、提高氧化速率温度、提高氧化速率如高如高压氧化氧化发展展其它工其它工艺方法。方法。463.6.3热氧化工艺展望热氧化工艺的发展方向:主要集中在如
- 温馨提示:
1: 本站所有资源如无特殊说明,都需要本地电脑安装OFFICE2007和PDF阅读器。图纸软件为CAD,CAXA,PROE,UG,SolidWorks等.压缩文件请下载最新的WinRAR软件解压。
2: 本站的文档不包含任何第三方提供的附件图纸等,如果需要附件,请联系上传者。文件的所有权益归上传用户所有。
3.本站RAR压缩包中若带图纸,网页内容里面会有图纸预览,若没有图纸预览就没有图纸。
4. 未经权益所有人同意不得将文件中的内容挪作商业或盈利用途。
5. 装配图网仅提供信息存储空间,仅对用户上传内容的表现方式做保护处理,对用户上传分享的文档内容本身不做任何修改或编辑,并不能对任何下载内容负责。
6. 下载文件中如有侵权或不适当内容,请与我们联系,我们立即纠正。
7. 本站不保证下载资源的准确性、安全性和完整性, 同时也不承担用户因使用这些下载资源对自己和他人造成任何形式的伤害或损失。
