 晶圆级封装 热机械失效模式和挑战及整改建议
晶圆级封装 热机械失效模式和挑战及整改建议
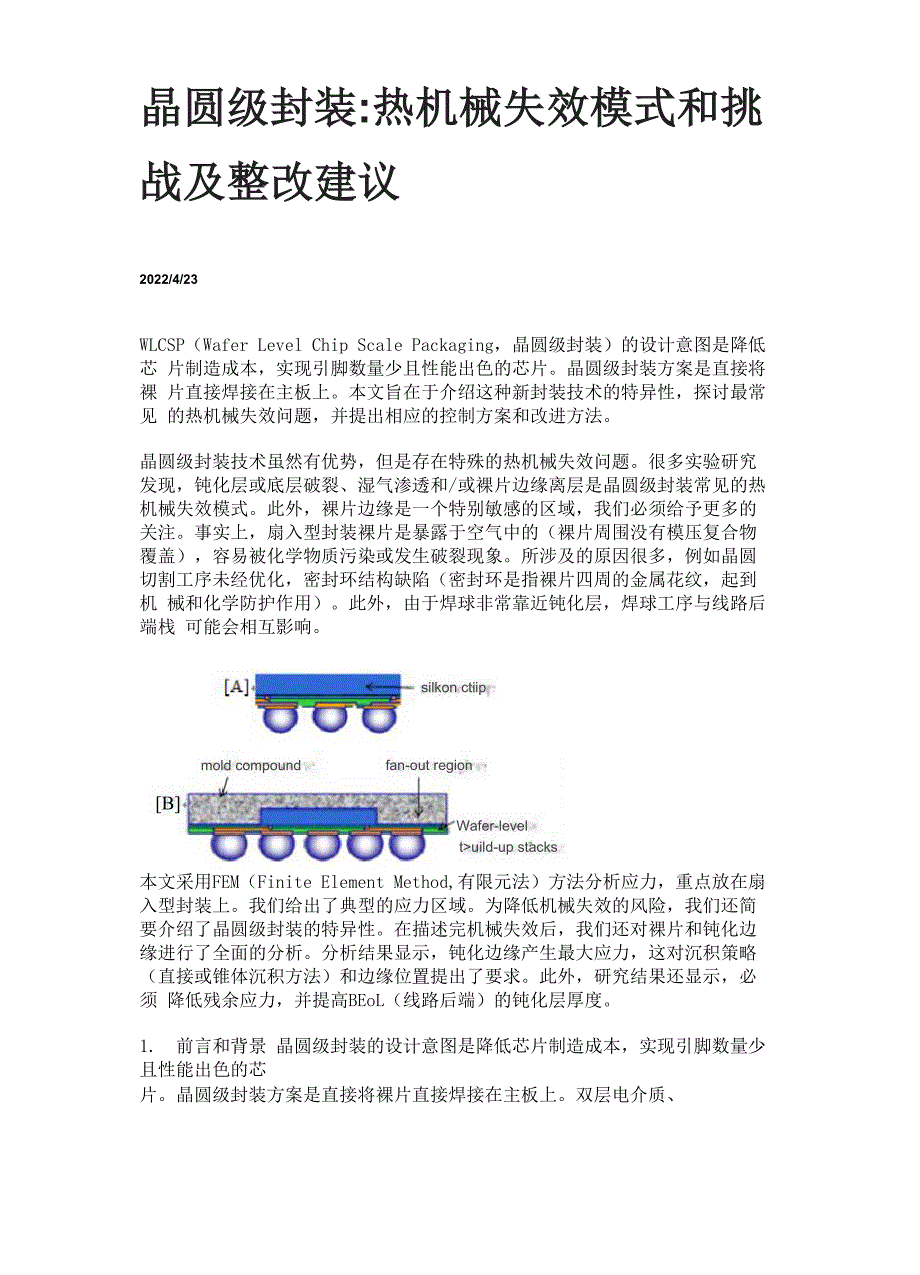


《晶圆级封装 热机械失效模式和挑战及整改建议》由会员分享,可在线阅读,更多相关《晶圆级封装 热机械失效模式和挑战及整改建议(12页珍藏版)》请在装配图网上搜索。
1、晶圆级封装:热机械失效模式和挑战及整改建议2022/4/23WLCSP(Wafer Level Chip Scale Packaging,晶圆级封装)的设计意图是降低芯 片制造成本,实现引脚数量少且性能出色的芯片。晶圆级封装方案是直接将裸 片直接焊接在主板上。本文旨在于介绍这种新封装技术的特异性,探讨最常见 的热机械失效问题,并提出相应的控制方案和改进方法。晶圆级封装技术虽然有优势,但是存在特殊的热机械失效问题。很多实验研究 发现,钝化层或底层破裂、湿气渗透和/或裸片边缘离层是晶圆级封装常见的热 机械失效模式。此外,裸片边缘是一个特别敏感的区域,我们必须给予更多的 关注。事实上,扇入型封装裸片
2、是暴露于空气中的(裸片周围没有模压复合物 覆盖),容易被化学物质污染或发生破裂现象。所涉及的原因很多,例如晶圆 切割工序未经优化,密封环结构缺陷(密封环是指裸片四周的金属花纹,起到机 械和化学防护作用)。此外,由于焊球非常靠近钝化层,焊球工序与线路后端栈 可能会相互影响。Bsilkon ctiipmold compoundfan-out regiontuild-up stacksWafer-level本文采用FEM(Finite Element Method,有限元法)方法分析应力,重点放在扇 入型封装上。我们给出了典型的应力区域。为降低机械失效的风险,我们还简 要介绍了晶圆级封装的特异性。在
3、描述完机械失效后,我们还对裸片和钝化边 缘进行了全面的分析。分析结果显示,钝化边缘产生最大应力,这对沉积策略 (直接或锥体沉积方法)和边缘位置提出了要求。此外,研究结果还显示,必须 降低残余应力,并提高BEoL(线路后端)的钝化层厚度。1. 前言和背景 晶圆级封装的设计意图是降低芯片制造成本,实现引脚数量少且性能出色的芯片。晶圆级封装方案是直接将裸片直接焊接在主板上。双层电介质、RDL(ReDistribution Layer,重新布线层)、UBM (可焊接薄层,用于焊球底部 金属化)和焊球都位于标准BEoL栈之上。因此,这些层级扩展了传统晶片制程 (多层沉积薄膜配合光刻工艺)范围。晶圆级封装
4、的焊球工艺与倒装片封装非常 相似。【氏JH -1silkon chipmold compoundfan-out regionbuild-up stacksWafer-leu el图1: ) A扇入型封装(晶圆级封装)和B扇出封装(封装大小取决于裸片边缘 与装配栈层的间隙)晶圆级封装主要分为扇入型封装和扇出型封装(图1)两种。扇入型封装是在晶 圆片未切割前完成封装工序,即先封装后切割。因此,裸片封装后与裸片本身 的尺寸相同(图2 A)。扇出型封装是先在人造模压晶圆片上重构每颗裸片, “新”晶圆片是加工RDL布线层的基板,然后按照普通扇入型晶圆级封装后工 序,完成最后的封装流程(图2 B) 1-2
5、-3-4-5。hDOvWF Boringsrnjg = =Wcf LBird-BEOl PflKiMa FftifudFan-O-i/r Optiond*owwii 6 Si卞 4j 5-: mcwi mdef 幅怕图2:扇入和扇出型封装流程 这里需要说明的是,为提高晶圆级封装的可靠性,目前存在多种焊球装配工艺, 其中包括氮化物层上焊球6、聚合物层上焊球7-8、铜柱晶圆级封装等等。 本文重点讨论在RDL层/聚合物层上用UBM层装配焊球的方法(图3)。图3:采用聚合物方案装配UBM焊球下一章重点介绍晶圆级封装特有的热机械失效现象。2. 晶圆级封装集成技术引起的热机械问题本文特别分析了发生在BEo
6、L层远端(Far-BEoL)和BEoL层的热失效问题。焊球疲劳等与裸片封装相关的失效模式不在本文讨论范围,想了解更信息,请查阅 相关资料,例如本文后面的文献9。我们先用BEoL层大面积离层实验图解释 裸片边缘敏感性问题,然后讨论焊球附近区域是BEoL远端层破裂的关键位置。-裸片边缘扇入型标准封装裸片是直接暴露于空气中(裸片周围无模压复合物),人们担心 这种封装非常容易受到外部风险的影响。优化晶片切割工艺是降低失效风险的 首要措施。为防止破裂在封装工序和/或可靠性测试过程中曼延,必须控制切割 工序在裸片边缘产生的裂缝(图4 A)。此外,这种封装技术的聚合物层末端 靠近裸片边缘,因为热膨胀系数(C
7、TE)失匹,这个区域会出现附加的残余应力。为预防这些问题发生,最新技术提出有侧壁的扇入型封装解决方案。具体做法 是,采用与扇出型封装相同的制程,给裸片加一保护层(几十微米厚),将其完 全封闭起来,封装大小不变,只是增加了一个机械保护罩。 BEoLSEoLJU囊含麹层據汁中心重掏晶片廉片边隊*-图4:在BEoL内部的裸片边缘离层;A扇入型封装B扇出型封装树脂、聚合物层和裸片边缘相互作用,致使扇出型封装的失效风险增加(图 4B)。在这种情况下,密封环结构是一个有效的压制应力的方法。作为BEoL层的一部 分,密封环是围绕在裸片四周的金属图案,具有防护作用,避免化学污染和裂 缝曼延,然而这个结构不足以
8、预防所有的失效问题,所以,必须从以下两方面 进行优化:-焊球和钝化层下面晶圆级封装的焊球可以装配在BEoL层上面。钝化层、UBM层和焊球组件具有不 同的热膨胀系数,这会在聚合物层上产生应力,在某些极端情况下,甚至还会 导致聚合物层破裂,并有可能最终曼延到BEoL栈。BEoL的最上层是钝化层, 是由氧化物层和氮化物层组成,前者是化学污染保护层,后者则用于预防机械 应力。如果钝化层受损,裸片就会受到各种形式的污染,导致电气失效。因此, 必须精心设计BEoL远端层(RDL、焊球和聚合物)。RDL层的密度及其布线需要 分布均匀。聚合物及其沉积方法的选择对于器件的可靠性也很重要。图 5 描述 了某些典型
9、缺陷。图5: A焊球靠近钝化层而引起聚合物层破裂的顶视图B在整个栈内出现破 裂的BEoL远端层和BEoL层的横截面 解决这些问题需要我们深入了解相关结构和专用的优化方法。3. 有限元法数值分析本文重点介绍扇入型封装配置。需要说明地是,某些分析结果同样适用于扇出 型封装解决方案(例如,焊球附近结构)。数值模型我们使用Ansys的商用软件进行了有限元法分析。第一步是创建一个3D封装模 型,以了解WLP封装的应力分布区域。我们探讨了焊球附近和裸片边缘附件的 应力分布情况。出于对称性考虑,只描述封装的四分之一(图 6)。图6:有限元法3D扇入型封装模型A独立封装B组装好的封装第二步是简化BEoL层和聚
10、合物层的建模,用一个20D模型进一步探讨各层之间 的相互作用(图7)。这个栈包括四个顶层共行覆膜的金属层和一个标准的密封 环结构。为避免数值错误,所有配置均保持网格不变,并根据结果分析材料性 质。图7:有限元法2D模型包括标准密封环和聚合物层末端我们对两个模型都施加了 225C至25C的热负载,模拟回流焊工序,并做了 一个线弹性分析。概述 我们可以考虑独立封装(图6 A)和安装在主板上的封装(图6 B)两种封装 工艺。本文主要讨论前者,让读者初步了解WLCSP封装的特异性。BEoL层应力如图8所示。在这样一个配置中,因为焊球和外围器件的热膨胀系 数失匹,每个焊接区都会发生类似的应力问题。此外,
11、在裸片外围可以看到聚 合物层边缘的影响(见图8中的箭头)。因此,我们已开始怀疑聚合物、焊球和 裸片边缘的相互作用。需要指出的是,在这个层面,应力的产生唯一原因是本 地的热膨胀失匹,而与封装尺寸大小无关。4 残余应力ABpB-b(-23 %表 1.探讨过的参数表AIllF 畫ITT-E- ftE -E-M图12:ASiN厚度的影响BSiN残余应力的影响应力是从聚合物层下面的SiN层提取的(图12)。测试结果显示,SiN越厚,应 力越小。还应记住,如果厚度较大,真层拓扑可能会更平滑,奇点更少,因此 可降低失效风险。关于残余应力影响,根据最初假定值,最终应力被迁移。因 此,通过降低残余应力,降低了最
12、终应力状态的数学值。不过,增加厚度方法 不能随意修改,还要记住对其它特性(例如,电气、可靠性和热变形)的影响。 因此,必须找到一个折衷的办法,考虑到所有的副作用。4. 结论 本文概述了 WLCSP晶圆级封装的特异性,先简要介绍了扇入和扇出型封装特异 性以及封装流程;然后,描述了在制程工序和/或可靠性测试期间发生的不同的 热机械失效。裸片边缘带和焊球四周是高度敏感区域,发生过很多失效问题。 为更深入地了解所涉及的结构,本文采用有限元法分析了 WLCSP 封装失效问题。首先,建立一个3D封装模型,初步了解扇入型封装的热机械特性。研究发现, 焊球和聚合物边缘是影响可靠性的重要位置。然后,用一个2D模型深入分析聚 合物边缘的影响,优化BEoL层。实验发现,终止在平坦区域的锥体沉积法可降 低在BEoL钝化层发生的应力。最后,我们研究了 SiN厚度及残余应力的影响, 并建议提高SiN层厚度,以降低残余应力。本文能够让读者朋友更好地了解WLCSP封装在机械性能方面的特异性。通过介 绍一组与有限元法结果相关的典型失效,我们概括了主要有效参数和可靠性改 进建议。
- 温馨提示:
1: 本站所有资源如无特殊说明,都需要本地电脑安装OFFICE2007和PDF阅读器。图纸软件为CAD,CAXA,PROE,UG,SolidWorks等.压缩文件请下载最新的WinRAR软件解压。
2: 本站的文档不包含任何第三方提供的附件图纸等,如果需要附件,请联系上传者。文件的所有权益归上传用户所有。
3.本站RAR压缩包中若带图纸,网页内容里面会有图纸预览,若没有图纸预览就没有图纸。
4. 未经权益所有人同意不得将文件中的内容挪作商业或盈利用途。
5. 装配图网仅提供信息存储空间,仅对用户上传内容的表现方式做保护处理,对用户上传分享的文档内容本身不做任何修改或编辑,并不能对任何下载内容负责。
6. 下载文件中如有侵权或不适当内容,请与我们联系,我们立即纠正。
7. 本站不保证下载资源的准确性、安全性和完整性, 同时也不承担用户因使用这些下载资源对自己和他人造成任何形式的伤害或损失。
