 半导体制造工艺_11刻蚀
半导体制造工艺_11刻蚀
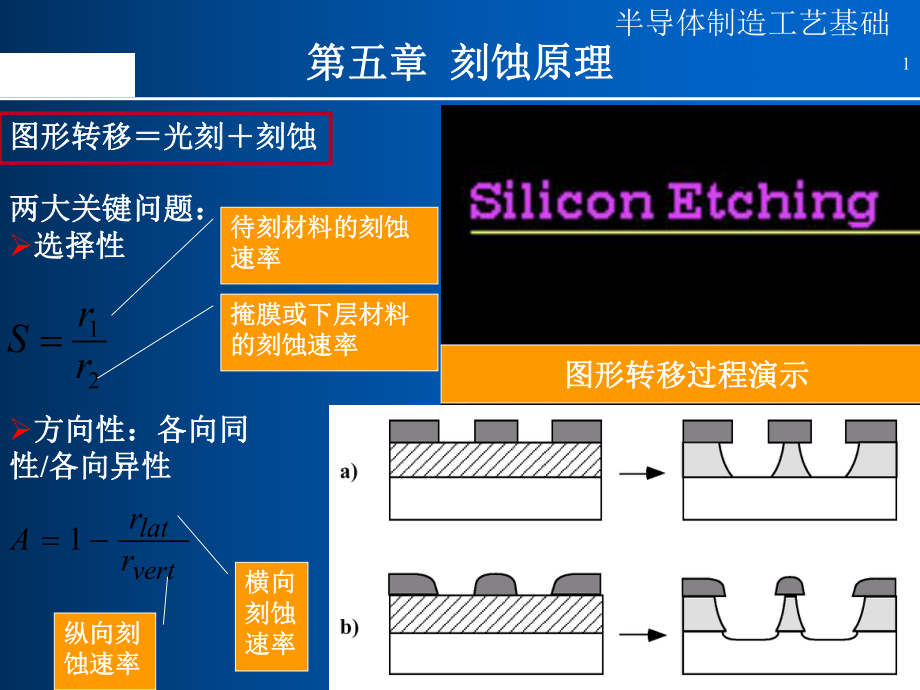


《半导体制造工艺_11刻蚀》由会员分享,可在线阅读,更多相关《半导体制造工艺_11刻蚀(47页珍藏版)》请在装配图网上搜索。
1、半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理两大关键问题:两大关键问题:选择性选择性方向性:各向同方向性:各向同性性/各向异性各向异性21rrS 待刻材料的刻蚀待刻材料的刻蚀速率速率掩膜或下层材料掩膜或下层材料的刻蚀速率的刻蚀速率vertlatrrA 1横向横向刻蚀刻蚀速率速率纵向刻纵向刻蚀速率蚀速率图形转移过程演示图形转移过程演示图形转移光刻刻蚀图形转移光刻刻蚀1半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理刻蚀速率刻蚀速率R(etch rate)单位时间刻蚀的薄膜厚度。对产单位时间刻蚀的薄膜厚度。对产率有较大影响率有较大影响刻蚀均匀性刻蚀均匀性(etch uniformity)一个硅
2、片或多个硅片或多批硅片一个硅片或多个硅片或多批硅片上刻蚀速率的变化上刻蚀速率的变化选择性选择性S(Selectivity)不同材料之间的刻蚀速率比不同材料之间的刻蚀速率比各项异性度各项异性度A(Anisotropy)刻蚀的方向性刻蚀的方向性A=0,各项同性;各项同性;A=1,各项异性各项异性掩膜层下刻蚀掩膜层下刻蚀(Undercut)横向单边的过腐蚀量横向单边的过腐蚀量刻蚀的性能参数刻蚀的性能参数2半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理A0 0A1 A=1Uniformity/non-uniformity均匀性均匀性/非均匀性非均匀性 lowhighlowhighRRRRU Rhig
3、h:最大刻蚀速率最大刻蚀速率Rlow:最小刻蚀速率最小刻蚀速率方向性:方向性:过腐蚀(钻蚀):过腐蚀(钻蚀):假定假定S 时时dbA 13半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理刻蚀要求刻蚀要求:1.得到想要的形状斜面还是垂直图形得到想要的形状斜面还是垂直图形2.过腐蚀最小一般要求过腐蚀过腐蚀最小一般要求过腐蚀10,以保证整片刻蚀完全,以保证整片刻蚀完全3.选择性好选择性好4.均匀性和重复性好均匀性和重复性好5.外表损伤小外表损伤小6.清洁、经济、平安清洁、经济、平安两类刻蚀方法:两类刻蚀方法:湿法刻蚀湿法刻蚀化学溶化学溶液中进行反响腐蚀,液中进行反响腐蚀,选择性好选择性好干法刻蚀干法
4、刻蚀气相化气相化学腐蚀选择性好学腐蚀选择性好或物理腐蚀方向性或物理腐蚀方向性好,或二者兼而有好,或二者兼而有之之4半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理刻蚀过程包括三个步骤:刻蚀过程包括三个步骤:反响物质量输运反响物质量输运Mass transport到要到要被刻蚀的外表被刻蚀的外表在反响物和要被刻蚀的膜外表之间的反在反响物和要被刻蚀的膜外表之间的反响响反响产物从外表向外扩散的过程反响产物从外表向外扩散的过程5半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理湿法刻蚀湿法刻蚀反响产物必反响产物必须溶于水或须溶于水或是气相是气相6半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理BOE:b
5、uffered oxide etching或或BHF:buffered HF加入加入NH4F缓冲液:弥补缓冲液:弥补F和降低对胶的刻蚀和降低对胶的刻蚀实际用实际用各各向向同同性性例例1:SiO2采用采用HF腐蚀腐蚀例例2:Si采用采用HNO3和和HF腐蚀(腐蚀(HNA)例例3:Si3N4采用热磷酸腐蚀采用热磷酸腐蚀7半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理例例4:Si采用采用KOH腐蚀腐蚀各向异性各向异性Si+2OH-+4H2O Si(OH)2+2H2+4OH-硅湿法腐蚀由于晶向而产生的各向异性腐蚀硅湿法腐蚀由于晶向而产生的各向异性腐蚀8半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理
6、原子密度:原子密度:腐蚀速度:腐蚀速度:R(100)100 R(111)9半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理HNA各向同性腐蚀各向同性腐蚀自终止自终止10半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理利用利用Si的各向异性湿法腐蚀制作的的各向异性湿法腐蚀制作的MEMS(MicroElectroMechanical Systems)结构)结构11半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理湿法腐蚀的缺点湿法腐蚀的缺点在大规模集成电路制造中,湿法腐蚀正被干法刻蚀在大规模集成电路制造中,湿法腐蚀正被干法刻蚀所替代:所替代:1湿法腐蚀是各向同性,干法可以是各向异性湿法腐蚀是各向同性
7、,干法可以是各向异性2干法腐蚀能到达高的分辨率,湿法腐蚀较差干法腐蚀能到达高的分辨率,湿法腐蚀较差3湿法腐蚀需大量的腐蚀性化学试剂,对人体湿法腐蚀需大量的腐蚀性化学试剂,对人体和环境有害和环境有害4湿法腐蚀需大量的化学试剂去冲洗腐蚀剂剩湿法腐蚀需大量的化学试剂去冲洗腐蚀剂剩余物,不经济余物,不经济12半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理干法刻蚀干法刻蚀化学刻蚀各项同性,选择性好化学刻蚀各项同性,选择性好等离子体激活的化学反响等离子体激活的化学反响(等离子体刻蚀等离子体刻蚀)物理刻蚀各向异性,选择性差物理刻蚀各向异性,选择性差高能离子的轰击高能离子的轰击(溅射刻蚀溅射刻蚀)离子增强刻
8、蚀各向异性,选择性较好离子增强刻蚀各向异性,选择性较好反响离子刻蚀反响离子刻蚀13半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理化学刻蚀化学刻蚀 物理刻蚀物理刻蚀14半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理离子增强刻蚀离子增强刻蚀-Ion Enhanced etching等离子体刻蚀的化学和物理过等离子体刻蚀的化学和物理过程并不是两个相互独立的过程,程并不是两个相互独立的过程,而且相互有增强作用而且相互有增强作用无离子,无离子,XeF2对对Si不刻蚀不刻蚀纯纯Ar离子,对离子,对Si不刻蚀不刻蚀Ar离子和离子和XeF2相互作用,相互作用,刻蚀速率很快刻蚀速率很快物理过程如离子轰物理过
9、程如离子轰击造成的断键击造成的断键/晶格晶格损伤、辅助挥发性反损伤、辅助挥发性反响产物的生成、外表响产物的生成、外表抑制物的去除等将抑制物的去除等将有助于外表化学过程有助于外表化学过程/化学反响的进行化学反响的进行15半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理典型的典型的RF等离子刻蚀系统和等离子刻蚀系统和PECVD或溅射系统类似或溅射系统类似16半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理等离子体等离子体等离子刻蚀根本原理等离子刻蚀根本原理等离子体等离子体PlasmaPlasma的含的含义义包含足包含足够够多的正多的正负电负电荷数目近于相等的荷数目近于相等的带电带电粒子粒子的物的物
10、质质聚集状聚集状态态。由于物由于物质质分子分子热热运运动动加加剧剧,相互,相互间间的碰撞就会使的碰撞就会使气体分子气体分子产产生生电电离,离,这样这样物物质质就就变变成由自由运成由自由运动动并相互作用的正离子和并相互作用的正离子和电电子子组组成的混合物成的混合物(蜡蜡烛烛的火的火焰就焰就处处于于这这种状种状态态)。我。我们们把物把物质质的的这这种存在状种存在状态态称称为为物物质质的第四的第四态态,即等,即等离子体离子体(plasma)(plasma)。因。因为电为电离离过过程中正离子和程中正离子和电电子子总总是成是成对对出出现现,所以等离,所以等离子体中正离子和子体中正离子和电电子的子的总总数
11、大致相等,数大致相等,总总体来看体来看为为准准电电中性。中性。液液态态固固态态气态气态等离子体等离子体17半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理刻蚀机制、等离子体探测与终点的控制刻蚀机制刻蚀工艺包括5个步骤:1、刻蚀过程开始与等离子体刻蚀反响物的产生;2、反响物通过扩散的方式穿过滞留气体层到达外表;3、反响物被外表吸收;4、通过化学反响产生挥发性化合物;5、化合物离开外表回到等离子体气流中,接着被抽气泵抽出。根本刻蚀方式为:物理方式:溅射刻蚀,正离子高速轰击外表;化学方式:等离子体产生的中性反响物与物质外表相互作用产生挥发性产物。化学方式有高腐蚀速率、高的选择比与低的离子轰击导致的缺
12、陷,但有各向同性的刻蚀轮廓。物理方式可以产生各向同性的轮廓,但伴随低的选择比与高的离子轰击导致的缺陷。将二者结合,如反响离子刻蚀RIE。18半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理19半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理等离子体探测 大多数的等离子体工艺中发出的射线范围在红外光到紫外光之间,一个简单的缝隙方法是利用光学发射光谱仪OES来测量这些发射光谱的强度与波长的关系。利用观测到的光谱波峰与的发射光谱比较,通过可以决定出中性或离子物质的存在。物质相对的密度,也可以通过观察等离子体参数改变时光强度的改变而得到。这些由主要刻蚀剂或副产物所引起的发射信号在刻蚀终点开始上升或下降
13、。干法刻蚀必须配备一个用来探测刻蚀工艺结束点的监视器,即终点探测系统。激光干预度量法用来持续控制晶片外表的刻蚀速率与终止点。在刻蚀过程中,从晶片外表反射的激光会来回振荡,这个振荡的发生是因为刻蚀层界面的上界面与下界面的反射光的相位干预。因此这一层材料必须透光或半透光才能观测到振荡现象。振荡周期与薄膜厚度的变化关系为:2dn终点控制20半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理刻蚀时间(任意单位)反射系数(任意单位)硅化物多晶硅硅化物/多晶硅刻蚀实验曲线21半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理Sputtering mode:硅:硅片置于右侧电极,该片置于右侧电极,该电极接地反响
14、腔体电极接地反响腔体通常也接地,那么增通常也接地,那么增大该电极有效面积;大该电极有效面积;右侧暗区电压差小,右侧暗区电压差小,通过离子轰击的物理通过离子轰击的物理刻蚀很弱刻蚀很弱RIE mode:硅片置于面积较小的左侧电极,右电硅片置于面积较小的左侧电极,右电极仍接地;左侧暗区电压差大,通过离子轰击的极仍接地;左侧暗区电压差大,通过离子轰击的物理刻蚀很强物理刻蚀很强22半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理SiCl4TiCl4反响离子刻蚀反响离子刻蚀RIE:常用刻蚀气体为含卤素:常用刻蚀气体为含卤素的物质,如的物质,如CF4,SiF6,Cl2,HBr等,参加添加等,参加添加气体如:
15、气体如:O2,H2,Ar等。等。O2 用于刻蚀光刻胶。用于刻蚀光刻胶。反响产物必须是气相或者易挥发反响产物必须是气相或者易挥发volatile23半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理刻蚀方程式刻蚀方程式等离子刻蚀根本原理等离子刻蚀根本原理为何处在等离子体环境下进行刻蚀为何处在等离子体环境下进行刻蚀在我们的工艺中,是用在我们的工艺中,是用CF4CF4和和O2O2来刻蚀扩散后的来刻蚀扩散后的硅片,其刻蚀原理如下:硅片,其刻蚀原理如下:CF4=CFx CF4=CFx*+(4-x)F +(4-x)F*(x3)(x3)Si+4 F Si+4 F*=SiF4 =SiF4 SiO2+4 F Si
16、O2+4 F*=SiF4+O2=SiF4+O2反响的实质,打破反响的实质,打破C-FC-F、Si-SiSi-Si键,形成挥发性的键,形成挥发性的Si-FSi-F硅卤化物。硅卤化物。CF+Si Si=Si-F+CF+Si Si=Si-F+17kcal/mol17kcal/mol反响需要一个净正能量,反响需要一个净正能量,CF4CF4本身不会直接刻蚀本身不会直接刻蚀硅。等离子体高能量硅。等离子体高能量的电子碰撞会使的电子碰撞会使CF4CF4分子分裂生产自由的氟原子分子分裂生产自由的氟原子和分子团,使得形成和分子团,使得形成SiFSiF是能量有利的。是能量有利的。24半导体制造工艺基础第五章第五章
17、刻蚀原理刻蚀原理氧气的作用氧气的作用等离子刻蚀根本原理等离子刻蚀根本原理 在在CF4CF4进气中参加少量氧气会提高硅和二氧化硅的刻蚀进气中参加少量氧气会提高硅和二氧化硅的刻蚀速率。人们认为氧气与碳原子反响生成速率。人们认为氧气与碳原子反响生成CO2CO2,这样从等离,这样从等离子体中去掉一些碳,从而增加子体中去掉一些碳,从而增加F F的浓度,这些成为富氟等离的浓度,这些成为富氟等离子体。往子体。往CF4CF4等离子体中每增加等离子体中每增加12%12%的氧气,的氧气,F F浓度会增加浓度会增加一个数量级,对硅的刻蚀速率增加一个数量级。一个数量级,对硅的刻蚀速率增加一个数量级。25半导体制造工艺
18、基础第五章第五章 刻蚀原理刻蚀原理CF4等离子体等离子体26半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理Si+4F*SiF4 SiO2+4F*SiF4 +O2 Si3N4+12F*3SiF4 +2N2 硅、硅、Si3N4和和SiO2刻蚀刻蚀CF4中添加少量中添加少量O2可增加对可增加对Si,SiO2和和Si3N4的腐蚀速率的腐蚀速率少量添加气体可增加选择性少量添加气体可增加选择性10%O2可获得最大的可获得最大的Si/SiO2刻蚀比刻蚀比27半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理在在CF4中参加少量中参加少量H2,可使可使CFx:F*的浓度比的浓度比增加。增加。从而使从而使SiO
19、2:Si及及Si3N4:Si的腐蚀速的腐蚀速率比增大率比增大28半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理增加增加F/C比加氧气,可以增加刻蚀速率比加氧气,可以增加刻蚀速率减少减少F/C比加氢气,刻蚀过程倾向于形成高分子膜比加氢气,刻蚀过程倾向于形成高分子膜29半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理刻蚀方向性的增加刻蚀方向性的增加增加离子轰击物理刻蚀分量增加离子轰击物理刻蚀分量侧壁增加抑制物侧壁增加抑制物inhibitorDRIE30半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理本节课主要内容本节课主要内容什么是图形转移技术?什么是图形转移技术?刻蚀的两个关键问题?刻蚀的两个
20、关键问题?21rrS 选择性选择性方向性方向性vertlatrrA 1光刻刻蚀光刻刻蚀干法刻蚀干法刻蚀纯物纯物理刻理刻蚀蚀纯化纯化学刻学刻蚀蚀反响离子刻蚀反响离子刻蚀RIE增加方向性、选择增加方向性、选择性的方法性的方法CF4/O2湿法腐蚀:湿法腐蚀:SiHNA各向同性各向同性 KOH各向异性各向异性SiO2HFMEMS31半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理反响等离子体刻蚀技术与设备一个反响等离子体刻蚀反响器包括一个真空腔、抽气泵系统、电源供给产生器、压力探测器、流量控制器与终点探测器等。32半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理 1 10 100 1000110100
21、1000低于高密度ECR,ICP低压整批RIE单片晶片RIE桶状等离子体刻机33半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理反响离子刻蚀RIE平行板系统RFRF34半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理电子盘旋共振ECR等离子体刻蚀机大多数的等离子体抗蚀机,除了三极RIE外,都无法提供独立控制等离子体参数的能力。导致轰击损伤的严重问题。ECR结合微波电源与静电场来驱使电子沿磁场线作一定角频率的盘旋。当此频率等于外加微波频率时,电子能量与外加磁场产生共振耦合,造成大量的分解与电离。35半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理其他高密度等离子体刻蚀机由于ULSI的线宽持续缩小
22、,逼近传统的RIE系统极限,除了ECR系统外,其他形式的高密度等离子体源HDP,如电感耦合等离子体源ICP、变压器耦合等离子体源TCP、外表波耦合等离子体源SWP也已开始开展。这些设备拥有高等离子体密度与低工艺压强。另外,HDP等离子体源对衬底的损伤较小因为衬底有独立的偏压源与侧电极电势,并有高的的各向异性因为在低压下工作但有高活性的等离子体密度。然而,由于其复杂且本钱较高,这些系统可能不会使用于非关键性的工艺,如侧壁间隔与平坦化工艺。36半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理等离子体RFRF介电板变压器耦合等离子体反响设备示意图变压器耦合等离子体反响设备示意图37半导体制造工艺基础
23、第五章第五章 刻蚀原理刻蚀原理集成等离子体工艺半导体晶片都是在洁净室里加工制作,以减少大气中的尘埃污染。当器件尺寸缩小,尘埃的污染成为一个严重的问题。为了减少尘粒的污染,集成等离子体设备利用晶片操作机将晶片置于高真空环境中从一个反响腔移到另一个反响腔。同时可以增加产率。38半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理TiW刻蚀腔AlCu刻蚀腔钝化层剥蚀腔真空装载锁住腔卡式装/卸载腔多层金属互联多层金属互联TiW/AlCu/TiW39半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理反响等离子体刻蚀的应用等离子体刻蚀系统已由应用于简单、整批的抗蚀剂剥蚀快速开展到大的单片晶片加工。下表列举了不同
24、刻蚀工艺所用到的一些化学剂。被刻蚀材料刻蚀用的化学药品深Si沟槽HBr/NF3/O2/SF6浅Si沟槽HBr/Cl2/O2多晶硅HBr/Cl2/O2,HBr/O2,BCl3/Cl2,SF6AlBCl3/Cl2,SiCl4/Cl2,HBr/Cl2AlSiCuBCl3/Cl2N2W只有SF6,NF3/Cl2TiW只有SF6WSi2,TiSi2,CoSi2CCl2F2/NF3,CF4/Cl2,Cl2/N2/C2F6SiO2CF4/CHF3/Ar,C2F6,C3F8/CO,C5F8,CH2F2Si3N4CHF3/O2,CH2F2,CH2CHF240半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理硅沟槽
25、刻蚀当器件尺寸缩小时,晶片外表用作隔离DRAM储存单元的储存电容与电路器件间的区域也会相对减少。这些外表隔离区域可以利用硅晶片的深沟槽刻蚀,再填入适当的介质或导体物质来减少其所占的面积。深沟槽深度通常超过5um,主要是用于形成存储电容,浅的沟槽其深度通常不会超过1um,一般用于器件间的隔离。氯基或溴基的化学剂对硅有高刻蚀速率,且对以二氧化硅为掩蔽层的硅刻蚀有高选择比。HBr+NF3+SF6+O2混合气可用于形成深度约7um的沟槽电容,此气体也用于浅沟槽的刻蚀。亚微米的深硅沟槽刻蚀时,常可观测到与高宽比有管的刻蚀,这是因深窄沟槽中的离子与中性原子的输运会受到限制。41半导体制造工艺基础第五章第五
26、章 刻蚀原理刻蚀原理多晶硅与多晶硅化物栅极刻蚀多晶硅与多晶硅化物即多晶硅上覆盖有低电阻金属硅化物常用作MOS器件的栅极材料。各向异性刻蚀及对栅极氧化层的高选择比是栅极刻蚀时最重要的需求。例如,对1G DRAM而言,其选择比需超过150即多晶硅化物与栅极氧化层的刻蚀速率比为150:1。另外,为符合各向异性刻蚀与高选择比的要求,等离子体技术的趋势是利用一相对低的功率产生低压与高密度的等离子体。大多数氯基与溴基化合物可用于栅极刻蚀而得到所需的各向异性与选择比。42半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理介质刻蚀定义介质层尤其是二氧化硅与氮化硅的图案是先进半导体制造技术中的关键工艺。因为具有较
27、高的键结合能量,介质的刻蚀必须利用氟基增强等离子体。垂直的图案轮廓可通过侧壁钝化来实现,通常将含碳的氟化物参加等离子体中CF4、CHF3、C4F8。必须使用轰击能量较高的离子才能将此聚合物形成的钝化层从氧化层上去除,以及将反响物质与氧化物外表混合形成的SiFx的产物。低压强操作与高等离子体密度有利于高宽比有关的刻蚀,然而HDP会产生高温电子并接着产生高比例的分解离子与自由基,它比RIE或是磁性增强RIE产生更多的活性自由基与离子。43半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理金属导线刻蚀AlIC制作中,金属层的刻蚀是一个相当重要的步骤。铝、铜与钨是金属导线常用的材料,它们通常需要各向异性
28、刻蚀。氟与铝反响产生非挥发性的AlF3,在1240时,其蒸汽压只有1Torr。氯基化学剂常用于铝的刻蚀。氯对铝有极高的化学刻蚀速率并且在刻蚀时会有横向钻蚀现象。将含碳气体或是氮气参加反响中,可在侧壁产生钝化层而得到各向异性刻蚀。暴露于大气环境中是铝刻蚀的另一个问题。Al侧壁上残留的氯与抗蚀剂容易与常压下的水气形成HCl腐蚀铝。在晶片暴露与大气前,先临场通入CF4等离子体,用F取代Cl;然后再通入氧等离子体去除抗蚀剂;紧接着立刻将晶片浸入去离子水中,如此可防止Al的腐蚀。44半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理CuCu是Al的后起之秀,低的电阻率与高的抗电迁移性能。然而,铜的卤化物挥
29、发性较低,室温下的等离子体刻蚀并不容易。刻蚀铜膜的温度需高于200。因此,铜的金属导线制作使用“嵌入式工艺而不用刻蚀。嵌入式工艺包括:1、平坦的介电层上刻蚀出沟槽或渠道;2、金属填入沟槽中来作为连线导线;3、化学机械抛光。在两层嵌入式工艺中,牵涉了一系列的洞接触孔或通孔的刻蚀出来并以金属填入,然后CMP。嵌入式工艺的优点是免掉了金属刻蚀的步骤,而铜刻蚀正是IC工业从铝改成铜导线时最担忧的问题。45半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理两层嵌入式工艺中不同的工艺步骤抗蚀剂刻蚀停止层抗蚀剂连线通孔46半导体制造工艺基础第五章第五章 刻蚀原理刻蚀原理LPCVD(低压化学汽相沉积)W已广泛用于接触孔填塞与第一层金属层,这是因为钨有完美的淀积均匀覆盖性。氟基与氯基化合物均可以刻蚀钨,且生成挥发性产物。利用钨全面回蚀得到钨插栓是钨刻蚀的一项重要应用。SiO2TiN阻挡层WAlCuWSiO2AlCu47
- 温馨提示:
1: 本站所有资源如无特殊说明,都需要本地电脑安装OFFICE2007和PDF阅读器。图纸软件为CAD,CAXA,PROE,UG,SolidWorks等.压缩文件请下载最新的WinRAR软件解压。
2: 本站的文档不包含任何第三方提供的附件图纸等,如果需要附件,请联系上传者。文件的所有权益归上传用户所有。
3.本站RAR压缩包中若带图纸,网页内容里面会有图纸预览,若没有图纸预览就没有图纸。
4. 未经权益所有人同意不得将文件中的内容挪作商业或盈利用途。
5. 装配图网仅提供信息存储空间,仅对用户上传内容的表现方式做保护处理,对用户上传分享的文档内容本身不做任何修改或编辑,并不能对任何下载内容负责。
6. 下载文件中如有侵权或不适当内容,请与我们联系,我们立即纠正。
7. 本站不保证下载资源的准确性、安全性和完整性, 同时也不承担用户因使用这些下载资源对自己和他人造成任何形式的伤害或损失。
