 微电子器件原理与设计1ppt课件
微电子器件原理与设计1ppt课件
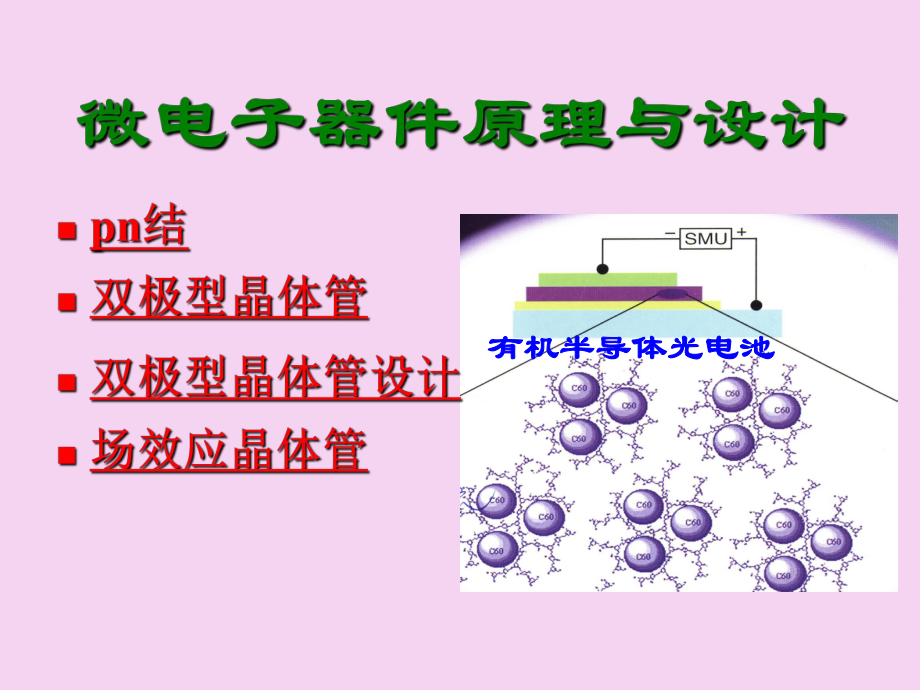


《微电子器件原理与设计1ppt课件》由会员分享,可在线阅读,更多相关《微电子器件原理与设计1ppt课件(209页珍藏版)》请在装配图网上搜索。
1、有机半导体光电池有机半导体光电池 本章的主要内容:本章的主要内容:平衡平衡pnpn结结pn结的电流特性结的电流特性pn结的电容特性结的电容特性pn结的击穿特性结的击穿特性pn结的开关特性结的开关特性 将一块将一块p型半导体和一块型半导体和一块n型半导体结合在一同,型半导体结合在一同,在二者的交界面处构成的结称为在二者的交界面处构成的结称为pn结。结。pn结是半导体器件,如绝大部分二极管、双极结是半导体器件,如绝大部分二极管、双极型晶体管、结型场效应晶体管的中心,在一个半导型晶体管、结型场效应晶体管的中心,在一个半导体集成电路中就包含了成千上万个体集成电路中就包含了成千上万个pn结。因此,了结。
2、因此,了解和掌握解和掌握 pn 结的性质具有重要的实践意义。结的性质具有重要的实践意义。本节首先引见本节首先引见 pn 结的构造和实现工艺,然后引结的构造和实现工艺,然后引见见pn结的能带和载流子分布规律。结的能带和载流子分布规律。在一块在一块 n n 型型(或或p p型型)半导体上,用适当工艺把半导体上,用适当工艺把 p p型型(或或n n型型)杂质掺入其中,使半导体的不同区域分杂质掺入其中,使半导体的不同区域分别具有别具有n n型和型和p p型导电类型,在二者的交界面处构成型导电类型,在二者的交界面处构成pnpn结。结。pn pn pn结的根本构造,如下图。结的根本构造,如下图。下面简单引
3、见构成下面简单引见构成pnpn结结的典型工艺和杂质分布。的典型工艺和杂质分布。n-Si 合金法制造合金法制造pnpn结的过程,如下图。结的过程,如下图。n-Sin-Si 将一粒将一粒AlAl放在一块放在一块 n n 型半导体片上,加热到一定温型半导体片上,加热到一定温度,构成铝硅的熔融体,然后降低温度,熔融体开度,构成铝硅的熔融体,然后降低温度,熔融体开场凝固,在场凝固,在n n型型Si Si片上构成一个含有高浓度片上构成一个含有高浓度AlAl的的p p型型Si Si薄层,它与薄层,它与n n型型Si Si衬底的交界面处即为衬底的交界面处即为pnpn结。结。用这种工艺方法构成的用这种工艺方法构
4、成的pnpn结,称为铝硅合金结。结,称为铝硅合金结。合金结的杂质分布如下图。合金结的杂质分布如下图。由图可知合金结的杂质分由图可知合金结的杂质分布具有以下特点布具有以下特点:在交界面处,杂质由在交界面处,杂质由NANA突变为突变为NDND。NANDN(x)xj x n n 型区中施主杂质浓度为型区中施主杂质浓度为NDND,并且均匀分布,并且均匀分布;p;p型区中型区中的受主杂质浓度为的受主杂质浓度为NANA,也均,也均匀分布。匀分布。通常,将这种杂质分布具有突变规律的通常,将这种杂质分布具有突变规律的p-np-n结,结,称为突变结称为突变结(Abrupt Junction)(Abrupt Ju
5、nction)。由图可知,突变结的杂质由图可知,突变结的杂质分布可以表示为分布可以表示为 在实践的突变结两边,杂质的浓度相差很多约在实践的突变结两边,杂质的浓度相差很多约10001000倍。倍。NANDN(x)xj x 通常,将这种突变结称为单边突变结。通常,将这种突变结称为单边突变结。)()(,)()(jjDAxxxxNxNNxNn-Si 分散法制造分散法制造pnpn结的过程,如下图。结的过程,如下图。n-Sin-Si 在一块在一块 n n 型半导体片上,经过氧化构成型半导体片上,经过氧化构成SiO2SiO2掩掩护膜;用紫外线暴光、并用氢氟酸腐蚀光刻,显露护膜;用紫外线暴光、并用氢氟酸腐蚀光
6、刻,显露n-Sin-Si;经过硼气氛在高温下分散,;经过硼气氛在高温下分散,在在n-Sin-Si衬底外衬底外表下构成深度为表下构成深度为xj xj 的的p-Sip-Si区,从而出现区,从而出现pnpn结。结。分散结的杂质分布由分散过程及杂质补偿决议。分散结的杂质分布由分散过程及杂质补偿决议。在分散结中,杂质浓度从在分散结中,杂质浓度从p p区到区到n n区是逐渐变化的,通常区是逐渐变化的,通常称为缓变结,如下图。称为缓变结,如下图。NANDN(x)xj x 由图可知,缓变结的杂质由图可知,缓变结的杂质分布可以表示为分布可以表示为)()(,)()(jjDADAxxxxNxNNxN 在分散结中,假
7、设杂质分布可以用结处的切线近在分散结中,假设杂质分布可以用结处的切线近似表示,那么称为线性缓变结似表示,那么称为线性缓变结(Linear graded(Linear graded Junction)Junction),其杂质分布如下图。,其杂质分布如下图。NA-NDxj x 线性缓变结的杂质分布可线性缓变结的杂质分布可表示为表示为()DAjjNNxx式中式中j j 是是 xj xj 处切线的斜率,称为杂质浓度梯度处切线的斜率,称为杂质浓度梯度,由分散杂质的实践分布确定。,由分散杂质的实践分布确定。假设采用高浓度分散源且分散时间较短,那么进假设采用高浓度分散源且分散时间较短,那么进入半导体的杂质
8、大多在其外表附近,如下图。入半导体的杂质大多在其外表附近,如下图。NANDN(x)xj x 这种由分散构成的高外这种由分散构成的高外表浓度浅表浓度浅pnpn结,由于结处结,由于结处的杂质浓度梯度很大,受的杂质浓度梯度很大,受主杂质浓度远高于施主杂主杂质浓度远高于施主杂质浓度,因此可以采用突质浓度,因此可以采用突变结近似。变结近似。显然,经过控制分散工艺参数既可以获得低外表显然,经过控制分散工艺参数既可以获得低外表浓度深分散结浓度深分散结线性缓变结,也可以获得高外表线性缓变结,也可以获得高外表浓度浅分散结浓度浅分散结单边突变结。单边突变结。n-Si 离子注入法制造离子注入法制造pnpn结的过程同
9、分散法类似,只是结的过程同分散法类似,只是在构成在构成p p型区时采用了新的掺杂手段。型区时采用了新的掺杂手段。n-Sin-Si 离子注入技术是将硼、磷、砷的原子经过离离子注入技术是将硼、磷、砷的原子经过离子化变成带电的杂质离子,并用强电场加速获得约子化变成带电的杂质离子,并用强电场加速获得约几万到几十万电子伏的高能量。然后,用高能离子几万到几十万电子伏的高能量。然后,用高能离子束直接轰击到半导体基片内部,经过退火激活,束直接轰击到半导体基片内部,经过退火激活,在在n-Sin-Si衬底外表下构成深度为衬底外表下构成深度为xj xj 的的pnpn结。结。离子注入离子注入pnpn结的杂质浓度分布如
10、下图。结的杂质浓度分布如下图。在掩蔽膜窗口附近的横在掩蔽膜窗口附近的横向方向杂质呈现余误差分向方向杂质呈现余误差分布,而纵向那么是以平均布,而纵向那么是以平均投影射程投影射程RpRp为中心的近似为中心的近似高斯分布。高斯分布。NSRpN(x)xj x 综上所述,采用不同的制造工艺可以得到不同的综上所述,采用不同的制造工艺可以得到不同的杂质分布。杂质分布。pnpn结的杂质分布普通可以归纳为两种结的杂质分布普通可以归纳为两种突变结和缓变结。突变结和缓变结。合金结和高外表浓度的浅分散结,普通可以以为合金结和高外表浓度的浅分散结,普通可以以为是突变结。是突变结。低外表浓度的深分散结,普通可以以为是线性
11、缓低外表浓度的深分散结,普通可以以为是线性缓变结。变结。pn pn 结的构造如下图。结的构造如下图。空间电荷区空间电荷区内建电场内建电场+在在n n 区电子为多区电子为多子,空穴为少子;子,空穴为少子;而在而在 p p区空穴为多区空穴为多子,电子为少子。子,电子为少子。当两块半导体结合当两块半导体结合构成构成pnpn结时,由于结时,由于存在载流子浓度梯存在载流子浓度梯 度,将导致空穴从度,将导致空穴从 p p 区到区到 n n 区、电子从区、电子从n n区到区到p p区区的分散运动。的分散运动。空间电荷区空间电荷区内建电场内建电场+对于对于p p区,空穴分开后留下了不可动的电离受主区,空穴分开
12、后留下了不可动的电离受主杂质,在杂质,在pnpn结附近结附近p p区一侧出现了一个负电荷区。区一侧出现了一个负电荷区。同理,在同理,在pnpn结附结附近近n n区一侧,也出区一侧,也出现了一个由电离施现了一个由电离施主杂质构成的正电主杂质构成的正电荷区。通常把在荷区。通常把在pnpn结附近的这些电离结附近的这些电离施主和电离受主所施主和电离受主所带的电荷,称为空带的电荷,称为空间电荷。间电荷。空间电荷所存在的区域,称为空间电荷区。由于空间电荷所存在的区域,称为空间电荷区。由于 在该区域没有载流子,因此,空间电荷区又称为载在该区域没有载流子,因此,空间电荷区又称为载流子耗尽层。流子耗尽层。空间电
13、荷区空间电荷区内建电场内建电场+在空间电荷区,由这些电荷产生了一个从在空间电荷区,由这些电荷产生了一个从n n 区指区指向向p p区,即从正电荷指向负电荷的电场,称为内建区,即从正电荷指向负电荷的电场,称为内建电场,如下图。电场,如下图。在内建电场作用在内建电场作用下,载流子构成与下,载流子构成与分散电流方向相反分散电流方向相反的漂移电流。的漂移电流。显然,内建电场显然,内建电场对载流子的分散起对载流子的分散起妨碍作用。妨碍作用。在没有外加电压情况下,载流子的分散和漂移最在没有外加电压情况下,载流子的分散和漂移最终将到达动态平衡。此时,没有电流流过终将到达动态平衡。此时,没有电流流过pnpn结
14、,空结,空间电荷区不再扩展,称为平衡间电荷区不再扩展,称为平衡pnpn结。结。P P 型型半半导导体体N N 型型半半导导体体+内电场内电场 由于由于 p p 区与区与 n n 区各自区各自有不同的费米能级,因此有不同的费米能级,因此两者相接触时处于非平衡两者相接触时处于非平衡形状,形状,n n 区的电子向区的电子向 p p 区分散,而区分散,而 p p 区空穴那区空穴那么向么向 n n 区分散。区分散。当分散电流与反向漂移当分散电流与反向漂移电流相等时,电流相等时,p p区与区与n n区的区的费米能级重合,费米能级重合,pnpn结具有结具有一致的费米能级,如下图。一致的费米能级,如下图。pn
15、 由于自建电场由由于自建电场由 n n区指向区指向 p p区,阐明区,阐明p p区电势低区电势低于于n n区,如下图。区,如下图。eVD 由于能带图反映的由于能带图反映的是电子能级,因此由是电子能级,因此由电势分布可知,电势分布可知,n n区区静电势能比静电势能比 p p区低,区低,从而使结两边的能带从而使结两边的能带产生相对挪动,直到产生相对挪动,直到费米能级处处相等为费米能级处处相等为止。止。所以,所以,pnpn结平衡时能结平衡时能带是弯曲的,带是弯曲的,n n区相对区相对于于p p区能带降低区能带降低 eVD eVD。其中,其中,n n区与区与 p p区的电势差区的电势差VD VD 称为
16、内建电势差。称为内建电势差。eVD 显然,空间电荷区显然,空间电荷区内能带的弯曲是电子内能带的弯曲是电子电势能变化的结果。电势能变化的结果。由于能带弯曲,电子由于能带弯曲,电子从势能低的从势能低的n n区向势区向势能高的能高的p p区运动时,区运动时,必需抑制这个势能差必需抑制这个势能差势垒,才干到达势垒,才干到达p p区;区;同理,同理,p p区空穴也必需抑制这个势垒才干从区空穴也必需抑制这个势垒才干从p p区到区到达达n n区,故通常称区,故通常称eVDeVD为为pnpn结的分散势垒,空间电荷结的分散势垒,空间电荷区也称为势垒区。区也称为势垒区。平衡时平衡时 pn 结的载流子浓度分布如下图
17、。结的载流子浓度分布如下图。+在空间电荷区在空间电荷区p p区势垒边处的电子区势垒边处的电子浓度等于浓度等于p p区平衡区平衡少子浓度,空穴浓少子浓度,空穴浓度等于度等于p p区平衡多区平衡多子浓度;而在子浓度;而在n n区区势垒边处,空穴浓势垒边处,空穴浓度等于度等于n n区少子浓区少子浓度,电子浓度等于度,电子浓度等于n n区多子浓度。区多子浓度。上述分析阐明,平衡时在上述分析阐明,平衡时在 pn 结处构成一个高阻区结处构成一个高阻区域域势垒区又称为耗尽区,其典型宽度在势垒区又称为耗尽区,其典型宽度在10 m量级。量级。()/0()/0FniBiFpBEEk TniEEk Tpinnepn
18、e 对于突变结,对于突变结,p p区和区和n n区都可视为均匀掺杂。设杂区都可视为均匀掺杂。设杂质浓度分别为质浓度分别为NaNa和和NdNd,那么由载流子数密度公式可,那么由载流子数密度公式可得得n n区电子浓度与区电子浓度与 p p区空穴浓度分别为区空穴浓度分别为 即得即得 ()/002FnFpBEEk Tnpin pn e 在室温附近,本征激发不明显,但杂质根本上已在室温附近,本征激发不明显,但杂质根本上已全部电离,近似有全部电离,近似有 apdnNpNn00 从平衡从平衡pnpn结的能带图可知,势垒高度正好补偿了结的能带图可知,势垒高度正好补偿了n n 区和区和p p 区费米能级之差,因
19、此有区费米能级之差,因此有 FpFnDEEeV所以所以 /2DBeVk TadiN Nn e因此得到内建电势差为因此得到内建电势差为 2lnidaBDnNNeTkV 上式阐明,接触电势差与上式阐明,接触电势差与pnpn结两测的掺杂浓度和结两测的掺杂浓度和温度,以及资料的禁带宽度有关。温度,以及资料的禁带宽度有关。对于突变结,在一定温度下,对于突变结,在一定温度下,pnpn结两测的掺杂浓结两测的掺杂浓度越高,接触电势差越大;禁带宽度越大,本征载度越高,接触电势差越大;禁带宽度越大,本征载流子浓度越小,接触电势差也越大。流子浓度越小,接触电势差也越大。由于硅的禁带宽度比锗的禁带宽度大,因此,硅由于
20、硅的禁带宽度比锗的禁带宽度大,因此,硅pnpn的接触电势差比硅的接触电势差比硅pnpn的接触电势差大。的接触电势差大。对于典型半导体,当对于典型半导体,当Na=1017cm-3、Nd=1015cm-3时,在室温下计算得时,在室温下计算得0.70Si-0.32Ge-DDVVVV()()pnpn 当当pn结无外加电压时,空间电荷区内的分散电流结无外加电压时,空间电荷区内的分散电流等于漂移电流,所以经过等于漂移电流,所以经过pn结的净电流为零。结的净电流为零。当在当在pn结上施加偏置电压时,空间电荷区的电势结上施加偏置电压时,空间电荷区的电势分布和能带将发生变化,从而导致分散和漂移的平分布和能带将发
21、生变化,从而导致分散和漂移的平衡被突破,衡被突破,pn 结处于非平衡形状,称为非平衡结处于非平衡形状,称为非平衡pn结。结。本节讨论非平衡本节讨论非平衡 pn 结物理特性的变化,如能带结物理特性的变化,如能带图、少子浓度分布、电流的传输和转换,以及电流图、少子浓度分布、电流的传输和转换,以及电流-电压特性伏安特性。电压特性伏安特性。在施加正向电压在施加正向电压V VDV VD条件下,外电压在势垒区条件下,外电压在势垒区中产生了与内建电场方向中产生了与内建电场方向相反的电场,因此减弱了相反的电场,因此减弱了内建电场,使空间电荷减内建电场,使空间电荷减少。故势垒区的宽度将减少。故势垒区的宽度将减小
22、,同时势垒高度由小,同时势垒高度由eVDeVD下降为下降为e(VD-V)e(VD-V),如下图,如下图。p neVD 势垒的降低减弱了漂移运动势垒的降低减弱了漂移运动,使分散流大于漂移,使分散流大于漂移流,产生了净分散流,构成了流,产生了净分散流,构成了pn结的正向电流。结的正向电流。电子经过势垒分散到电子经过势垒分散到p区,使区,使p区势垒边的电子数区势垒边的电子数密度比平衡值高,即构成了非平衡少数载流子。密度比平衡值高,即构成了非平衡少数载流子。同理,空穴经过势垒分散到同理,空穴经过势垒分散到n区,使区,使n区势垒边的区势垒边的空穴数密度比平衡值高,也构成了非平衡少数载流空穴数密度比平衡值
23、高,也构成了非平衡少数载流子。子。这种外加正向偏压作用使非平衡少子进入半导体这种外加正向偏压作用使非平衡少子进入半导体的过程,称为非平衡少子的电注入。的过程,称为非平衡少子的电注入。在施加反向电压在施加反向电压V 条件条件下,外电压在势垒区中产下,外电压在势垒区中产生了与内建电场方向一样生了与内建电场方向一样的电场,因此加强了内建的电场,因此加强了内建电场,使空间电荷增多。电场,使空间电荷增多。故势垒区的宽度将变宽,故势垒区的宽度将变宽,同时势垒高度增大,如下同时势垒高度增大,如下图。图。p neVD 势垒的增大加强了漂移势垒的增大加强了漂移运动,使分散流小于漂移运动,使分散流小于漂移流。流。
24、此时,此时,n区势垒边的空穴,被势垒区的强电场驱区势垒边的空穴,被势垒区的强电场驱向向p区,而区,而p区势垒边的电子被驱向区势垒边的电子被驱向n区。区。当这些少数载流子被电当这些少数载流子被电场驱走后,内部的少子前场驱走后,内部的少子前来补充,从而构成了反向来补充,从而构成了反向偏压下的电子分散电流和偏压下的电子分散电流和空穴分散电流。空穴分散电流。这种情况好像少数载流子不断地被抽出来,所以这种情况好像少数载流子不断地被抽出来,所以将这种反向偏压作用下非平衡少子的运动过程,称将这种反向偏压作用下非平衡少子的运动过程,称为非平衡少子的抽取或吸出。为非平衡少子的抽取或吸出。p neVD 在正向偏压
25、下,在正向偏压下,pnpn结的平结的平衡被破坏,衡被破坏,n n区能带相对区能带相对p p区区被抬高被抬高eVeV,此时,此时n n区和区和p p区的区的费米能级之差为费米能级之差为FNFPEEeV 由于在电注入下,由于在电注入下,p p区和区和n n区势垒边出现较高浓度的非区势垒边出现较高浓度的非平衡少子,并各自向体内分平衡少子,并各自向体内分散。因此,在势垒区和分散散。因此,在势垒区和分散区没有一致的费米能级,必区没有一致的费米能级,必需用准费米能级表示。需用准费米能级表示。在在p p区,由于空穴浓度很高,且势垒区很窄,费区,由于空穴浓度很高,且势垒区很窄,费米能级和变化可以忽略,因此空穴
26、的费米能级从米能级和变化可以忽略,因此空穴的费米能级从p p区到势垒区不断坚持区到势垒区不断坚持EFpEFpeVD 但在空穴分散区,由于空但在空穴分散区,由于空穴浓度远小于穴浓度远小于n n区电子浓度区电子浓度且变化显著,此时且变化显著,此时n n区中空区中空穴的费米能级用空穴准费米穴的费米能级用空穴准费米能级表示。能级表示。同理,在同理,在p p区电子的费米能区电子的费米能级用电子准费米能级表示,级用电子准费米能级表示,而在而在n n区和势垒区,电子的费区和势垒区,电子的费米能级坚持米能级坚持EFnEFn不变。不变。在在p p区势垒边处,电子准费米能级等于区势垒边处,电子准费米能级等于EFn
27、EFn,那么,那么电子和空穴的浓度分别为电子和空穴的浓度分别为eVD()/()/()()FniBiFpBEEk TppiEEk Tppinxnepxne即得即得 /2()()BeV k Tppppinxpxn e所以有所以有 2/()()BeV k Tippppnnxepx由于由于 0002()pppppipxppnn所以得所以得p p区势垒边的电子浓度区势垒边的电子浓度 /0()BeV k Tpppnxn e同理得同理得n n区势垒边的空穴浓度区势垒边的空穴浓度 /0()BeV k Tnnnpxp e 注入的非平衡少子向体内边分散边复合,构成一注入的非平衡少子向体内边分散边复合,构成一个稳态
28、分布,根据分散实际和边境条件,可得个稳态分布,根据分散实际和边境条件,可得 ()()()()npxlpppxlnnnnxnxepxpx e 式中非平衡少子的分散长度可写成式中非平衡少子的分散长度可写成 nnpplDlD 在反向偏压下,在反向偏压下,pnpn结的平结的平衡被破坏,衡被破坏,p p区能带相对区能带相对n n区区被抬高被抬高eVeV,此时,此时p p区和区和n n区的区的费米能级之差为费米能级之差为FPFNEEeV 在在p p区和区和n n区势垒边处的少子区势垒边处的少子浓度分别为浓度分别为/0/0()()BBeV k TnnneV k Tppppxp enxp e 在反向抽取下,在
29、反向抽取下,p p区和区和n n区势垒边的非平衡少子浓区势垒边的非平衡少子浓度远低于平衡少子浓度,因此,同平衡少子相比,度远低于平衡少子浓度,因此,同平衡少子相比,势垒边的少子浓度近似为零。反向偏压下少子分布势垒边的少子浓度近似为零。反向偏压下少子分布如下图。如下图。此时平衡少子向势垒边分此时平衡少子向势垒边分散,根据分散实际和边境条散,根据分散实际和边境条件可得件可得00()(1)()(1)npxlppxlnnnxnepxpe 在正向偏压下,注在正向偏压下,注入的非平衡少子在分入的非平衡少子在分散区内根本上被复合散区内根本上被复合掉,因此流过掉,因此流过n n区和区和p p区区(分散区以外分
30、散区以外)的少的少子分散电流为零,其子分散电流为零,其电流主要是多子的漂电流主要是多子的漂移电流。移电流。在分散区,注入的少子分散电流与多子漂移电流在分散区,注入的少子分散电流与多子漂移电流将相互转换:少子不断地与多子复合而转换成多子将相互转换:少子不断地与多子复合而转换成多子漂移电流,直到分散区边处的注入少子全部复合。漂移电流,直到分散区边处的注入少子全部复合。在反向抽取下,分在反向抽取下,分散区内的非平衡少子散区内的非平衡少子低于平衡少子浓度,低于平衡少子浓度,因此产生大于复合,因此产生大于复合,有电子空穴对产生。有电子空穴对产生。其中少子向势垒边分其中少子向势垒边分散并被电场扫过势垒散并
31、被电场扫过势垒区,构成反向漂移电区,构成反向漂移电流。流。分散区中产生的非平衡多子,在电场作用下作漂分散区中产生的非平衡多子,在电场作用下作漂移运动流出分散区,构成反向漂移电流。移运动流出分散区,构成反向漂移电流。符合以下假设条件的符合以下假设条件的 pn 结,称为理想结,称为理想pn结。结。在小注入条件下,注入的少子浓度远小于平衡多在小注入条件下,注入的少子浓度远小于平衡多子浓度,因此子浓度,因此p区的载流子浓度可写成区的载流子浓度可写成 00ppppnnnppn区的载流子浓度为区的载流子浓度为 00nnnnpppnn 在势垒区内自在载流子全部耗尽,空间电荷密度在势垒区内自在载流子全部耗尽,
32、空间电荷密度等于电离杂质的电荷密度,即等于电离杂质的电荷密度,即daeNeN 在势垒区以外的在势垒区以外的p区和区和n区没有空间电荷,呈现电区没有空间电荷,呈现电中性,其平衡多子浓度密度等于电离杂质浓度,即中性,其平衡多子浓度密度等于电离杂质浓度,即00pandpNnN 在耗尽近似和电中性近似情况下,外加电压和接在耗尽近似和电中性近似情况下,外加电压和接触电势差都作用在耗尽层上,耗尽层外的半导体为触电势差都作用在耗尽层上,耗尽层外的半导体为电中性,没有电压降。电中性,没有电压降。经过耗尽层的电子电流和空穴电流为常数,不思经过耗尽层的电子电流和空穴电流为常数,不思索耗尽层中载流子的产生及复协作用
33、。索耗尽层中载流子的产生及复协作用。非平衡少子的浓度远小于非平衡少子的浓度远小于-3-3,即非简并条件,即非简并条件,因此满足玻尔兹曼统计分布。因此满足玻尔兹曼统计分布。在在p-np-n结上加偏压结上加偏压V V,此时在,此时在p p区势垒边少子区势垒边少子电子的浓度为电子的浓度为 TkVVenpBDenn/)(0 由于非平衡少子的电注入,在势垒边处的非平衡由于非平衡少子的电注入,在势垒边处的非平衡少子浓度为少子浓度为)1(/00TkeVpppBennnn 同理同理,在,在n区势垒边少子区势垒边少子空穴的浓度为空穴的浓度为 TkVVepnBDepp/)(0在在n区势垒边注入的非平衡少子的浓度为
34、区势垒边注入的非平衡少子的浓度为)1(/00TkeVnnnBepppp 在势垒边积累的少子必各向在势垒边积累的少子必各向p p区与区与n n区内部分散,区内部分散,根据恒电流条件,其分散流分别为根据恒电流条件,其分散流分别为 )1()()1()(/0/0TkeVnnpnnTkeVppnppBBelDndxxndDjelDpdxxpdDj因此,流过因此,流过 pn 结的电流密度为结的电流密度为)(npjjej 上式就是理想上式就是理想pn pn 结模型的电流电压方程式,又称结模型的电流电压方程式,又称为肖克莱方程式。为肖克莱方程式。)1(/TkeVsBejj即即ppnnnpslDeplDenj0
35、0式中式中 pn结伏安特性曲结伏安特性曲线如下图。线如下图。VI 由图可知,由图可知,pn结结具有单导游电性:具有单导游电性:外加正向偏压时,外加正向偏压时,有正向电流流过;有正向电流流过;而在外加反向偏压而在外加反向偏压时,反向电流很小时,反向电流很小并迅速趋于饱和。并迅速趋于饱和。pn结伏安特性结伏安特性曲线具有以下特曲线具有以下特征:征:VI死区电压死区电压Si=0.6VGe=0.2V 在外加正向偏在外加正向偏压较小时,正向压较小时,正向电流很小,几乎电流很小,几乎为零。通常将这为零。通常将这个电压范围称为个电压范围称为死区电压,硅管死区电压,硅管是是00.6V,而锗,而锗管那么为管那么
36、为00.2V。VI死区电压死区电压Si=0.6VGe=0.2V导通电压导通电压Si=0.60.7VGe=0.20.3V 随着外加正向偏随着外加正向偏压的添加,正向电压的添加,正向电流缓慢增大,只需流缓慢增大,只需当大于某个值时,当大于某个值时,正向电流才明显添正向电流才明显添加。通常规定正向加。通常规定正向电流到达某一明显电流到达某一明显数值时所需求的外数值时所需求的外加正向电压,称为加正向电压,称为pn结的导通电压,结的导通电压,或门槛电压。或门槛电压。VI死区电压死区电压Si=0.6VGe=0.2V导通电压导通电压Si=0.60.7VGe=0.20.3V反向击穿反向击穿电压电压VB 在外加
37、反向偏压在外加反向偏压情况下,随着电压情况下,随着电压的添加,反向电流的添加,反向电流迅速到达饱和。此迅速到达饱和。此时,继续添加反向时,继续添加反向电压,反向电流几电压,反向电流几乎不变。但当电压乎不变。但当电压增大到某个值时,增大到某个值时,反向电流迅速地添反向电流迅速地添加。这个电压称为加。这个电压称为pn结的反向击穿电结的反向击穿电压。压。由肖克莱方程式,可知:由肖克莱方程式,可知:在室温下在室温下VeTkB026.0/普通外加正向电压约零点几伏,故普通外加正向电压约零点几伏,故1/TkeVBe所以正向电流密度可以写成所以正向电流密度可以写成 TkeVsBejj/即:在正向偏压下,正向
38、电流密度随正向偏压呈指即:在正向偏压下,正向电流密度随正向偏压呈指数关系迅速增大。数关系迅速增大。在反向偏压下,在反向偏压下,VkT 时时0/TkeVBe所以得反向电流密度所以得反向电流密度 即:在反向偏压下,反向电流密度为常数,与外加即:在反向偏压下,反向电流密度为常数,与外加电压无关。电压无关。当施加反向电压时,外加电压与内建电压极性一当施加反向电压时,外加电压与内建电压极性一样,从而添加了结区的漂移电流,使之超越分散电样,从而添加了结区的漂移电流,使之超越分散电流,其差值构成反向电流。流,其差值构成反向电流。ppnnnpslDplDnejj00 显然,随着反向电压由零开场添加显然,随着反
39、向电压由零开场添加 ,反向电流迅,反向电流迅速饱和,其数值为速饱和,其数值为 反向漂移电流由少子构成,因此数值很小。现实反向漂移电流由少子构成,因此数值很小。现实上,当施加反向电压时势垒增高,任何处于势垒边上,当施加反向电压时势垒增高,任何处于势垒边境的少子均被势垒区高电场扫入对方,从而使势垒境的少子均被势垒区高电场扫入对方,从而使势垒区边境少子数密度几乎为零。区边境少子数密度几乎为零。ppnnnpslDplDnej00式中,式中,都是平衡少子数密度,数值很低,因都是平衡少子数密度,数值很低,因此反向饱和电流数值极小。此反向饱和电流数值极小。00nppn 和和 pn结的这种正导游通、反向阻断特
40、性,称为单导结的这种正导游通、反向阻断特性,称为单导游电性,或称为整流效应。游电性,或称为整流效应。综上所述,除非极小的外加电压,在正、反向电综上所述,除非极小的外加电压,在正、反向电压下流过压下流过pnpn结二极管的电流数值差别悬殊:正向表结二极管的电流数值差别悬殊:正向表现为低阻导通态,而反向那么表现为高阻阻断态。现为低阻导通态,而反向那么表现为高阻阻断态。由于饱和电流数值极小,因此,反向由于饱和电流数值极小,因此,反向 pn pn 结可以结可以看作是一个高阻阻断层。看作是一个高阻阻断层。pn pn结的单导游电性是晶体管任务的根本原理,在结的单导游电性是晶体管任务的根本原理,在检波与整流方
41、面得到广泛运用。检波与整流方面得到广泛运用。VI 比较比较pn结伏安特性的实际结果与实验曲线,可以结伏安特性的实际结果与实验曲线,可以发现:发现:实际计算与实实际计算与实验丈量结果之间验丈量结果之间的偏向表现为:的偏向表现为:*在正向电压较小在正向电压较小时,实际计算值比时,实际计算值比实验值小。实验值小。*正向电流较大时,电流电压关系符合正向电流较大时,电流电压关系符合 *正向电流大时,电流电压呈现线性关系,而不是正向电流大时,电流电压呈现线性关系,而不是指数关系。指数关系。)2/(TkeVBej 而不是理想而不是理想pnpn结的电流电压关系。结的电流电压关系。在反向偏压时,实践丈量的反向电
42、流比实际计算在反向偏压时,实践丈量的反向电流比实际计算值大得多,而且反向电流不饱和,随反向偏压的增值大得多,而且反向电流不饱和,随反向偏压的增大而略有添加。大而略有添加。实验阐明,理想实验阐明,理想pnpn结的电流电压方程式同小注入结的电流电压方程式同小注入下下Ge-pnGe-pn结符合的很好,与结符合的很好,与Si-pnSi-pn结那么偏向较大。结那么偏向较大。影响影响pnpn结伏安特性的主要缘由:结伏安特性的主要缘由:*外表效应外表效应 *势垒区中的产生和复合势垒区中的产生和复合 *大注入条件大注入条件 *串联电阻效应串联电阻效应 在正向电压下,在正向电压下,p p区的空穴和区的空穴和n
43、n区的电子进入势垒区的电子进入势垒区,使载流子浓度高于平衡值,从而导致复合率大区,使载流子浓度高于平衡值,从而导致复合率大于产生率。因此,一部分电子于产生率。因此,一部分电子-空穴发生复合,构成空穴发生复合,构成复合电流,而不流过复合电流,而不流过pnpn结。结。设电子和空穴的寿命均为设电子和空穴的寿命均为,复合中心分布均匀,复合中心分布均匀且具有单一有效能级,那么由半导体复合实际可得且具有单一有效能级,那么由半导体复合实际可得势垒区的净复合率为势垒区的净复合率为/2(1)2(1)BBeV k TieVk TneRe思索到正向偏压下,思索到正向偏压下,V kBT/e,那么势垒区净复,那么势垒区
44、净复合率可简化为合率可简化为/22BeVk TinRe假设势垒区的宽度为假设势垒区的宽度为xd,那么势垒区的复合电流密,那么势垒区的复合电流密度为度为/22BeVk Tidrgen xje00/2()(1)2BBpnnpeV k TeVk Tidnpen Dep Den xjeell 思索势垒区复合电流后,思索势垒区复合电流后,pn结正向电流密度为结正向电流密度为*仅当正向偏压比较低、或电流比较小时,复合电仅当正向偏压比较低、或电流比较小时,复合电流才起重要作用。当外加电压大于流才起重要作用。当外加电压大于0.5V0.5V时,复合电时,复合电流的影响很小。流的影响很小。*本征载流子浓度越大,复
45、合电流的影响就越小。本征载流子浓度越大,复合电流的影响就越小。由于由于GeGe的本征载流子浓度大,因此复合电流的影响的本征载流子浓度大,因此复合电流的影响可以忽略;而可以忽略;而SiSi的本征载流子浓度较小,因此在校的本征载流子浓度较小,因此在校电流范围内复合电流的影响就必需思索。电流范围内复合电流的影响就必需思索。理想理想pn结的反向电流密度由结的反向电流密度由p区和区和n区势垒边产生区势垒边产生的少子构成,实践上它并不代表的少子构成,实践上它并不代表pn结反向电流的全结反向电流的全部,而只是反向电流的一部分,常称为体内分散电部,而只是反向电流的一部分,常称为体内分散电流。流。在反向电压下,
46、由于势垒区对载流子的抽取,空在反向电压下,由于势垒区对载流子的抽取,空间电荷区内载流子浓度低于平衡值,故电子间电荷区内载流子浓度低于平衡值,故电子-空穴对空穴对的产生率大于复合率,因此势垒区存在产生电流。的产生率大于复合率,因此势垒区存在产生电流。势垒区产生电流是反向分散电流之外的一个附加势垒区产生电流是反向分散电流之外的一个附加反向电流,因此实践反向电流,因此实践pnpn结反向电流还应该加上产生结反向电流还应该加上产生电流。电流。/2(1)2(1)2BBeV k TieVk TineRen 在反向偏压且在反向偏压且V kBT/e,势垒区复合率为,势垒区复合率为所以势垒区净产生率为所以势垒区净
47、产生率为2inGR 假设势垒区的宽度为假设势垒区的宽度为xd,那么势垒区的复合电流密,那么势垒区的复合电流密度为度为2idgen xj00/()(1)2BpnnpeV k Tidnpen Dep Den xjell 思索势垒区产生电流后,思索势垒区产生电流后,pn结反向电流密度为结反向电流密度为 在二氧化硅层中,普通都含有一定数量的正电荷在二氧化硅层中,普通都含有一定数量的正电荷如如NaNa离子等,它们将吸引或排斥半导体内的载离子等,它们将吸引或排斥半导体内的载流子,从而构成外表空间电荷区。流子,从而构成外表空间电荷区。+-+-如下图,在二氧化如下图,在二氧化硅层中正电荷作用下硅层中正电荷作用
48、下,在半导体外表将构,在半导体外表将构成负的空间电荷分布成负的空间电荷分布,对于,对于pnpn结而言,相结而言,相当于空间电荷区延展当于空间电荷区延展、扩展。、扩展。外表空间电荷区中的复合中心将引起附加的正向外表空间电荷区中的复合中心将引起附加的正向复合电流和反向产生电流。复合电流和反向产生电流。在这里,外表空间电荷区越大,所引进的附加电在这里,外表空间电荷区越大,所引进的附加电流也越大,并且在外表电荷足够多的情况下,外表流也越大,并且在外表电荷足够多的情况下,外表空间电荷区的宽度随反向偏压添加而增大,直到外空间电荷区的宽度随反向偏压添加而增大,直到外表空间电荷与氧化层中电荷相等时为止。表空间
49、电荷与氧化层中电荷相等时为止。+-+-在二氧化硅层与硅的交界面处,往往存在相等数在二氧化硅层与硅的交界面处,往往存在相等数量的、位于禁带的能级,称为界面态外表态,量的、位于禁带的能级,称为界面态外表态,它们与半导体内的杂质能级类似,可以起到复合中它们与半导体内的杂质能级类似,可以起到复合中心的作用。心的作用。外表态的复合中心也将引起附加的正向复合电流外表态的复合中心也将引起附加的正向复合电流和反向产生电流。和反向产生电流。当衬底杂质浓度较低且当衬底杂质浓度较低且SiO2膜中正电荷较多时,衬底外表膜中正电荷较多时,衬底外表将出现反型层,并与分散层相将出现反型层,并与分散层相连,使连,使pn结面积
50、增大,因此反结面积增大,因此反向电流增大。向电流增大。+-当当pnpn结外表由于资料缘由,或吸附水气、金属离结外表由于资料缘由,或吸附水气、金属离子等而引起外表污染时,好像在子等而引起外表污染时,好像在pnpn结外表并联了一结外表并联了一个附加电导,因此将引起外表漏电,使反向电流添个附加电导,因此将引起外表漏电,使反向电流添加,如下图。加,如下图。在制造工艺中,为了保证硅片的机械强度,对其在制造工艺中,为了保证硅片的机械强度,对其厚度有一定的要求。同时,为了满足厚度有一定的要求。同时,为了满足pn结击穿电压结击穿电压的要求,低掺杂区的电阻率又不能太低。所以,的要求,低掺杂区的电阻率又不能太低。
51、所以,pn结的串联电阻较大。结的串联电阻较大。当电流流过串联电阻时,当电流流过串联电阻时,pn结上的实践电压应为结上的实践电压应为jsVVIR即,串联电阻将导致即,串联电阻将导致pn结上实践电压降低,从而使结上实践电压降低,从而使电流随电压的上升的趋势变慢。电流随电压的上升的趋势变慢。由于结电压与电流成对数关系,在大电流下,电由于结电压与电流成对数关系,在大电流下,电压主要添加在串联电阻上,使电流电压近似为线性压主要添加在串联电阻上,使电流电压近似为线性关系。关系。在大注入情况下、由于自建场的作用,在大注入情况下、由于自建场的作用,pn结正向结正向电流密度应修正为电流密度应修正为2(2)BeV
52、k TnineD njel 同校注入情况下相比:同校注入情况下相比:*大注入时,空穴电流密度与大注入时,空穴电流密度与p p区的杂质浓度区的杂质浓度NaNa无无关。这是由于注入关。这是由于注入p p区的非平衡少子浓度比区的非平衡少子浓度比p p区杂质区杂质浓度高得多,从而减弱了杂质浓度对正向电流的影浓度高得多,从而减弱了杂质浓度对正向电流的影响。响。*大注入时,相当于少子分散系数大了一倍。这是大注入时,相当于少子分散系数大了一倍。这是由于小注入时忽略了由于小注入时忽略了p p区电场作用,但在大注入情区电场作用,但在大注入情况下,电场的漂移作用不能忽略。假设将漂移作用况下,电场的漂移作用不能忽略
53、。假设将漂移作用等效成分散作用,就相当于加速了电子分散,使等等效成分散作用,就相当于加速了电子分散,使等效分散系数增大了一倍。效分散系数增大了一倍。*大注入时,正向电流随外加电压添加上升缓慢。大注入时,正向电流随外加电压添加上升缓慢。这是由于小注入时以为外加电压全部降落在势垒区这是由于小注入时以为外加电压全部降落在势垒区上,但在大注入情况下,外加电压有一部分降落在上,但在大注入情况下,外加电压有一部分降落在p p区,以建立区,以建立p p区自建电场,从而维持多子的积累,区自建电场,从而维持多子的积累,保证电中性条件。保证电中性条件。对于正向电流密度,那么有对于正向电流密度,那么有TkEEBgF
54、eTj)23(即,正向电流密度随温度升高加强。即,正向电流密度随温度升高加强。对于反向电流密度,可以表示为对于反向电流密度,可以表示为TkEsBgeTj)23(式中,式中,)2/3(T 随温度变化较缓慢,故电流随温度的随温度变化较缓慢,故电流随温度的变化主要由指数项决议。变化主要由指数项决议。显然,饱和电流随温度升高而迅速增大,并且禁显然,饱和电流随温度升高而迅速增大,并且禁带越大的半导体,变化越快。带越大的半导体,变化越快。随着温度的升高,随着温度的升高,js 将迅速增大;随着外加中向将迅速增大;随着外加中向电压的添加,正向电流也会指数增大。因此,对于电压的添加,正向电流也会指数增大。因此,
55、对于某一个特定电流值,随着温度升高,外加电压将会某一个特定电流值,随着温度升高,外加电压将会减小,即减小,即pn结正导游通电压结正导游通电压VF随着温度的升高而随着温度的升高而下降。下降。在室温附近,普通地,温度每升高在室温附近,普通地,温度每升高1度,对于度,对于Ge-pn结,正导游通电压结,正导游通电压VF下降下降2mV;而对;而对Si-pn结,结,正导游通电压正导游通电压VF将下降将下降1mV。pn结空间电荷区的电荷量随着外加偏压变化,阐结空间电荷区的电荷量随着外加偏压变化,阐明明pn结具有电容效应。结具有电容效应。pn结的电容效应是结的电容效应是pn结的根本性质之一,它是结的根本性质之
56、一,它是研讨半导体器件频率特性的根底。利用研讨半导体器件频率特性的根底。利用pn结电容效结电容效应可制造变容二极管和集成电路中所需求的电容器。应可制造变容二极管和集成电路中所需求的电容器。本节首先引见本节首先引见pn结电容效应及其产生的缘由,然结电容效应及其产生的缘由,然后给出突变结和缓变结势垒电容的实际公式,最后后给出突变结和缓变结势垒电容的实际公式,最后给出分散电容的表达式。给出分散电容的表达式。pn pn结具有电容特性,它主要包括势垒电容和分散结具有电容特性,它主要包括势垒电容和分散电容两部分。电容两部分。当当pn结加正向偏压时,结加正向偏压时,势垒区宽度变窄,空间电势垒区宽度变窄,空间
57、电荷数量减少。此时,荷数量减少。此时,n区电区电子和子和p区空穴进入势垒区,区空穴进入势垒区,并中和了一部分电离施主并中和了一部分电离施主杂质和电离受主杂质。这杂质和电离受主杂质。这相当于有一定数量的电子和空穴相当于有一定数量的电子和空穴“存入势垒区。存入势垒区。当减小正向偏压时,势当减小正向偏压时,势垒区宽度变宽,空间电荷垒区宽度变宽,空间电荷数量添加。此时,势垒区数量添加。此时,势垒区中的部分电子和空穴被自中的部分电子和空穴被自建电场扫出势垒区,并分建电场扫出势垒区,并分别进入别进入n n区和区和p p区。这相当于有一定数量的电子和空区。这相当于有一定数量的电子和空穴从势垒区穴从势垒区“取
58、出。取出。在反向偏压下,随着电压的增大,势垒区宽度变在反向偏压下,随着电压的增大,势垒区宽度变窄,空间电荷数量减少,导致有一定数量的电子和窄,空间电荷数量减少,导致有一定数量的电子和空穴空穴“存入势垒区。存入势垒区。随着电压减小,势垒区厚度变宽,空间电荷数量随着电压减小,势垒区厚度变宽,空间电荷数量增多,导致一定数量的电子和空穴从势垒区释放。增多,导致一定数量的电子和空穴从势垒区释放。从上述分析可知:当从上述分析可知:当pnpn结上外加电压变化时,自结上外加电压变化时,自建电场的变化将引起势垒区宽度和空间电荷数量的建电场的变化将引起势垒区宽度和空间电荷数量的改动,从而导致载流子在势垒区的改动,
59、从而导致载流子在势垒区的“存入和存入和“取出取出作用,这种景象同电容器的作用,这种景象同电容器的“充电和充电和“放电作放电作用类似。这阐明用类似。这阐明pnpn结具有电容效应。结具有电容效应。通常,我们将通常,我们将pn结势垒区空间电荷量随外加电压结势垒区空间电荷量随外加电压变化的电容效应称为势垒电容,用变化的电容效应称为势垒电容,用CT 表示。表示。当当pn结加正向偏压时,有电子从结加正向偏压时,有电子从n区注入区注入p区并在区并在势垒边势垒边p区一个分散长度内,构成非平衡电子和空区一个分散长度内,构成非平衡电子和空穴的积累;穴的积累;随着正向偏压的添加,随着正向偏压的添加,在在n n区和区
60、和p p区内分散区积累区内分散区积累的非平衡少子添加;而随的非平衡少子添加;而随着正向偏压的减小,分散着正向偏压的减小,分散区积累的非平衡少子也减区积累的非平衡少子也减少。少。同样,在同样,在n区也存在非平衡空穴和电子的积累。区也存在非平衡空穴和电子的积累。当当pn结加反向偏压时,在结加反向偏压时,在“抽取作用,分散区抽取作用,分散区内非平衡载流子的积累也随电压变化;但由于少子内非平衡载流子的积累也随电压变化;但由于少子浓度低于平衡值,载流子电量随电压的变化很小。浓度低于平衡值,载流子电量随电压的变化很小。这种由于分散区电荷数量随外加电压变化所产生这种由于分散区电荷数量随外加电压变化所产生的电
61、容效应,称为的电容效应,称为pnpn结的分散电容,用结的分散电容,用CDCD表示。表示。当当pnpn结在一个固定直流偏压结在一个固定直流偏压V V作用下,叠加一个作用下,叠加一个微小的交流电压微小的交流电压dVdV时,由微小电压变化所引起的电时,由微小电压变化所引起的电荷变化荷变化dQdQ,称为这个直流偏压下的微分电容。即,称为这个直流偏压下的微分电容。即 微分电容有赖于微分电容有赖于pn结的直流偏压,因此在不同偏结的直流偏压,因此在不同偏压下,微分电容也不一样。压下,微分电容也不一样。dVdQC 实验发现:实验发现:pn结电容随外加电压而变化,即它们结电容随外加电压而变化,即它们是可变电容。
62、为此,引入微分电容。是可变电容。为此,引入微分电容。对于突变结,势垒区的电荷对于突变结,势垒区的电荷密度分布为密度分布为 根据高斯定理,势垒区电场满足根据高斯定理,势垒区电场满足)0()0(,)()(npdaxxxxeNxeNx()(0),()(0)apdneNdE xxxdxeNdE xxxdx -+-+xpxn-+NdNaN(x)(x)根据耗尽近似和电中性近似,势垒边处场强为零,根据耗尽近似和电中性近似,势垒边处场强为零,于是可得势垒区的电场分布于是可得势垒区的电场分布()()(0),(0)()()appdnneNE xxxxxeNxxE xxx xpxn-+NdNaN(x)(x)E(x)
63、势垒区电场分布如下图,电势垒区电场分布如下图,电场方向由场方向由n n区指向区指向p p区,在结处区,在结处电场最强,为电场最强,为 (0)danpeNeNExx 根据电中性条件,可得根据电中性条件,可得ndpaxNxN 上式也可以由最大电场强上式也可以由最大电场强度公式获得。这阐明,势垒度公式获得。这阐明,势垒区内正负空间电荷区的宽度区内正负空间电荷区的宽度与杂质浓度成反比。所以,与杂质浓度成反比。所以,当外加电压变化时,势垒区当外加电压变化时,势垒区主要向杂质浓度低的一侧扩主要向杂质浓度低的一侧扩展。展。xpxn-+NdNaN(x)(x)E(x)势垒区的泊松方程可写成势垒区的泊松方程可写成
64、 2222()(0),(0)()apndeNd V xxxdxxxeNd V xdx 由于两个势垒边的电势差为由于两个势垒边的电势差为VD,所以平衡,所以平衡pn结势结势垒区的电势分布可写成垒区的电势分布可写成)0()0(,/2/)(/2/)()(2222npnndDppaxxxxxxxxeNVxxxxeNxV 利用电势在利用电势在x=0处延续的条件,由上式可得处延续的条件,由上式可得 由于由于和和 222ndpaDxNxNeVndpaxNxNpnDxxx所以得所以得于是,得势垒宽度于是,得势垒宽度22DdadaDxNNNNeVdadaDDNNNNeVx2 当当pn结上加偏压结上加偏压V时,势
65、垒区上总电压为时,势垒区上总电压为VD-V,那么势垒宽度可推行为那么势垒宽度可推行为 上式阐明:突变结的势垒宽度随外加偏压的变化上式阐明:突变结的势垒宽度随外加偏压的变化而变化。在偏压一定时,随结两侧的杂质浓度的变而变化。在偏压一定时,随结两侧的杂质浓度的变化而变化。化而变化。dadaDDNNNNeVVx2 对单边突变结,势垒区主要向轻掺杂一侧扩展。对单边突变结,势垒区主要向轻掺杂一侧扩展。势垒区内单位面积上的总电量为势垒区内单位面积上的总电量为 利用利用即得即得 VVeNNNNQDdada2ndpaxNxNQpnDxxx假设假设pn结面积为结面积为S,那么,那么pn结的势垒电容为结的势垒电容
66、为 根据微分电容定义,得单位面积势垒电容为根据微分电容定义,得单位面积势垒电容为)(2VVNNNNeCDdadaT)(2VVNNNNeSCDdadaT 同突变结处置相类似,假设在同突变结处置相类似,假设在x=0 x=0处也采用耗处也采用耗尽近似,那么势垒区的空间电荷密度为尽近似,那么势垒区的空间电荷密度为式中式中j 为杂质浓度梯度。为杂质浓度梯度。耗尽区的泊松方程可写成耗尽区的泊松方程可写成xeNNexjad)()(22()()jed V xdE xxdxdx 采用耗尽近似和中性近似,电场只分布在势垒,采用耗尽近似和中性近似,电场只分布在势垒,因此势垒边的电场强度为零,即因此势垒边的电场强度为零,即那么势垒区的电场分布为那么势垒区的电场分布为()()022DDxxEE222()18jDDexxE xx 势垒区的电场呈现抛物线外形,如下图。其最大势垒区的电场呈现抛物线外形,如下图。其最大电场在结处,为电场在结处,为 2(0)8jDexE 根据电场分布,可得线性缓变结的电势根据电场分布,可得线性缓变结的电势 23()68jjDeexV xxxC 利用势垒区的接触电势差利用势垒区的接触电势差
- 温馨提示:
1: 本站所有资源如无特殊说明,都需要本地电脑安装OFFICE2007和PDF阅读器。图纸软件为CAD,CAXA,PROE,UG,SolidWorks等.压缩文件请下载最新的WinRAR软件解压。
2: 本站的文档不包含任何第三方提供的附件图纸等,如果需要附件,请联系上传者。文件的所有权益归上传用户所有。
3.本站RAR压缩包中若带图纸,网页内容里面会有图纸预览,若没有图纸预览就没有图纸。
4. 未经权益所有人同意不得将文件中的内容挪作商业或盈利用途。
5. 装配图网仅提供信息存储空间,仅对用户上传内容的表现方式做保护处理,对用户上传分享的文档内容本身不做任何修改或编辑,并不能对任何下载内容负责。
6. 下载文件中如有侵权或不适当内容,请与我们联系,我们立即纠正。
7. 本站不保证下载资源的准确性、安全性和完整性, 同时也不承担用户因使用这些下载资源对自己和他人造成任何形式的伤害或损失。
